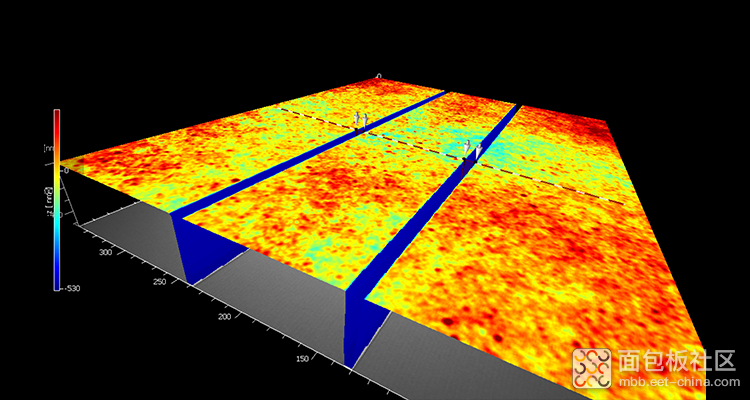
引言 在显示面板制造的 ARRAY 制程工艺中,光刻胶剥离是关键环节。铜布线在制程中广泛应用,但传统光刻胶剥离液易对铜产生腐蚀,影响器件性能。同时,光刻图形的精准测量对确保 ARRAY 制程工艺精度至关重要。本文将介绍用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液,并探讨白光干涉仪在光刻图形测量中的应用。 用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液 配方设计 低铜腐蚀光刻胶剥离液需兼顾光刻胶溶解能力与铜保护性能。其主要成分包括有机溶剂、碱性活性物质、铜缓蚀剂和表面活性剂。有机溶剂(如二甲基亚砜)可高效溶解光刻胶;碱性活性物质(如四甲基氢氧化铵)加速光刻胶分解;铜缓蚀剂(如苯并三氮唑及其衍生物)能在铜表面形成致密保护膜,抑制铜的腐蚀反应;表面活性剂可降低表面张力,增强剥离液对光刻胶的渗透能力 。 制备方法 在洁净的反应容器中,先加入定量的有机溶剂,开启搅拌装置。缓慢加入碱性活性物质,充分混合均匀。接着,依次添加铜缓蚀剂和表面活性剂,持续搅拌 40 - 60 分钟,确保各成分充分溶解且分散均匀。制备过程需严格控制温度在 25 - 35℃,防止因温度过高影响缓蚀剂等成分的性能。 低铜腐蚀光刻胶剥离液的应用 在 ARRAY 制程工艺中,该剥离液可有效去除光刻胶。以 TFT - LCD 面板制造为例,在铜布线光刻胶剥离过程中,低铜腐蚀光刻胶剥离液能快速溶解光刻胶,同时对铜布线的腐蚀速率极低,有效保障铜布线的完整性和导电性,避免因铜腐蚀导致的线路短路、断路等问题,提高显示面板的良品率和稳定性。 白光干涉仪在光刻图形测量中的应用 测量原理 白光干涉仪基于白光干涉原理,通过比较参考光束与样品表面反射光束的光程差,将光强分布转化为样品表面高度信息,实现对光刻图形形貌的高精度测量。其测量精度可达纳米级,能够满足 ARRAY 制程工艺中微小光刻图形结构的检测需求。 测量过程 将 ARRAY 制程工艺后的待测光刻样品放置于白光干涉仪载物台上,利用仪器自带显微镜初步定位测量区域。精确调节干涉仪的光路参数,获取清晰的干涉条纹图像。通过专业软件对干涉图像进行处理,运用相位解包裹等算法,精确计算出光刻图形的深度、宽度、侧壁角度等关键参数,为 ARRAY 制程工艺的优化提供数据支持。 优势 白光干涉仪采用非接触式测量,避免了对光刻图形的物理损伤,适合 ARRAY 制程工艺中脆弱光刻结构的检测;测量速度快,可实现对光刻图形的快速批量检测,满足生产线上高效检测需求;其三维表面形貌可视化功能,能直观呈现光刻图形的质量状况,便于工程师及时发现并解决工艺问题 。 TopMap Micro View白光干涉3D轮廓仪 一款可以“实时”动态/静态 微纳级3D轮廓测量的白光干涉仪 1)一改传统白光干涉操作复杂的问题,实现一键智能聚焦扫描,亚纳米精度下实现卓越的重复性表现。 2)系统集成CST连续扫描技术,Z向测量范围高达100mm,不受物镜放大倍率的影响的高精度垂直分辨率,为复杂形貌测量提供全面解决方案。 3)可搭载多普勒激光测振系统,实现实现“动态”3D轮廓测量。 实际案例 1,优于1nm分辨率,轻松测量硅片表面粗糙度测量,Ra=0.7nm 2,毫米级视野,实现5nm-有机油膜厚度扫描 3,卓越的“高深宽比”测量能力,实现光刻图形凹槽深度和开口宽度测量。



 标签: 干涉仪
标签: 干涉仪