


来自美国和日本的研究团队报告了一种击穿电压超过10kV增强型(E-mode)氧化镓(Ga₂O₃)横向结型场效应晶体管(JFETs),该器件采用了氧化镍(NiO)降低表面电场(RESURF)结构和混合漏极(hybrid-drain)的设计,工作温度可达250°C[Yuan Qin et al, IEDM, session 25-5, 2024]。
该团队由美国弗吉尼亚理工大学、美国海军研究实验室和日本Novel Crystal Technology组成,其研究成果于2024年12月IEEE国际电子器件会议(IEDM 2024)上发布。研究人员表示:"我们的器件展示了最高的平均电场强度,并首次报告了碳化硅(SiC)以外的高压晶体管在 250°C 下的工作温度和 3kV 的可靠性数据。"
Ga₂O₃具有4.8eV的超宽禁带(UWBG),而氮化镓(GaN)和碳化硅(SiC)的禁带宽度分别为3.4eV和3.3eV。10kV的击穿性能使这些JFETs进入中压(1-35kV)功率电子器件领域,有望在电网和可再生能源设施中得到广泛应用。
研究人员指出:"高压(HV)器件的出现可显著减少器件数量、简化电路拓扑,改善系统尺寸,提高可靠性。目前商用高压器件以6.5kV的硅IGBT为主;SiC MOSFET的工程样品可达10kV。"
与其他宽禁带半导体材料不同,Ga₂O₃可制备出直径达6英寸的衬底晶圆,其晶体材料可通过熔融法生长。增强型(常关型,即在零栅压下阻断电流)晶体管通常因其功耗更低且具有故障安全特性,而更受功率电子领域青睐。
器件设计(图1)主要针对E-mode操作、电荷平衡和导通电阻(Rₒₙ)进行优化。器件包含n型Ga₂O₃沟道、混合p-NiO/金属漏极、重掺杂p型NiO栅极以及p-NiO RESURF结构。
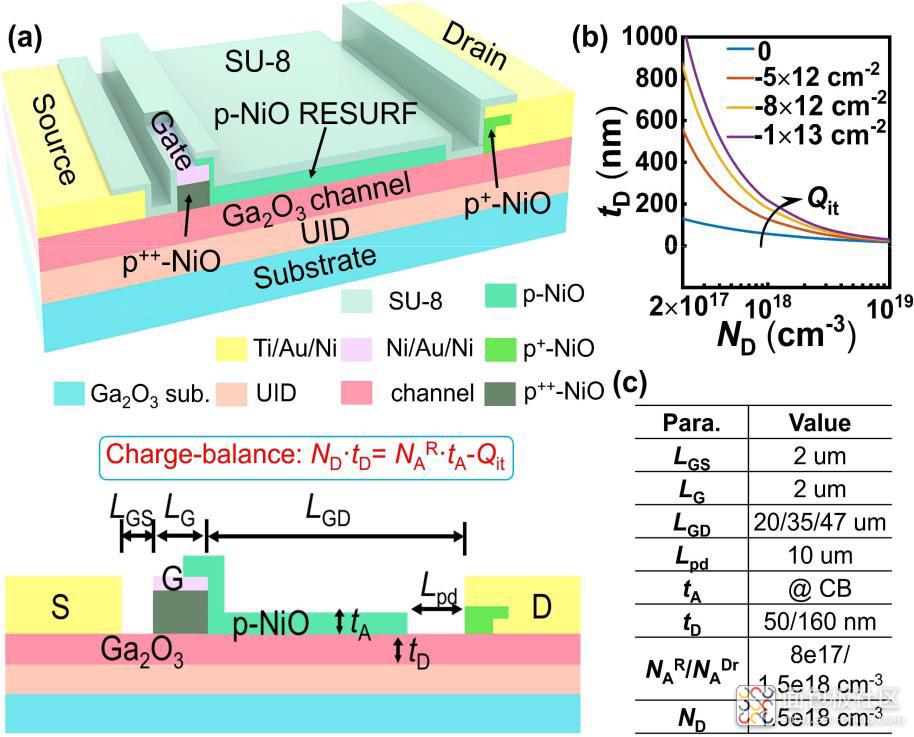
图1:(a) 采用p-NiO RESURF和混合漏极设计的Ga₂O₃ JFET示意图:三维结构图(上)与截面图(下)。(b) 为实现E-mode操作,计算的最大沟道厚度(tD)与施主掺杂浓度(ND)的关系曲线,界面电荷密度(Qit)范围为013/cm2至−1013/cm2。(c) 关键器件参数及数值表
NiO区域在栅极RESURF(R)和混合漏极(Dr)侧分离,以避免穿通。间隙两侧的p型掺杂浓度(NAR/NADr)可独立优化。RESURF结构设计与英飞凌商用GaN栅极注入晶体管(GITs)类似。
外延材料通过分子束外延(MBE)在半绝缘(010)Ga₂O₃衬底上生长,n型沟道位于非故意掺杂(UID)层上。制备了两个样品#A和#B,其n型沟道层厚度(td)分别为50nm和160nm。更厚的沟道有助于降低Rₒₙ。
器件制造始于硅注入与激活,随后沉积源/漏金属。通过氮离子注入实现电隔离。NiO材料采用溅射沉积,通过调节氧分压依次形成混合漏极、p++型栅极和RESURF区域的不同受主浓度。栅极掺杂浓度超过1019/cm³。
#A和#B的阈值电压(VTH)分别达到1.9V和1.5V,实现了E-mode操作。栅极电位因栅漏电流限制在3.5-4V范围。对应的比导通电阻(Rₒₙ,sp)分别为703mΩ·cm²和92mΩ·cm²。
研究人员指出:"尽管#A器件的td薄3.2倍,但其Rₒₙ高7倍,表明栅极沟道对Rₒₙ的显著贡献——#A器件栅下未耗尽Ga₂O₃导电沟道更窄。" 当器件温度升至250°C时,#A器件的VTH降至0.7V,Rₒₙ较25°C时增加1.6倍。团队写道:"Rₒₙ的温度系数小于10kV SiC MOSFET的报道值,表明高温下传导损耗更低。”#B JFET的VTH在约100°C时变为负值,150°C时降至-3.3V。超过175°C后,栅极失去有效控制能力。
当栅极电位为0V时,两个样品的击穿电压(BV)均超过10kV。通过调节器件参数至近电荷平衡状态实现最大BV。最大BV对应的栅漏间距(LGD)为47μm。团队报告:"BV时的平均横向电场为1.75-2.45MV/cm。" #A器件在250°C高温下仍保持高BV,而#B材料在高温下性能下降,150°C时BV在-10V栅压下低于10kV。
研究人员还进行了150°C高温栅偏压/反向偏压(HTGB/HTRB)可靠性测试。在HTGB测试中,#A和#B器件的阈值电压偏移和导通电阻偏移分别在0.32V和35%范围内,且完全可恢复。#B器件的HTRB研究显示存在漏致势垒降低(DIBL)效应,VTH偏移-3V(基本可恢复)。
研究人员解释:"#B器件的厚沟道导致势垒降低和高压VD下的穿通。这种DIBL可能因Qit及其高温加速去俘获而恶化。" #A器件的阈值偏移在0.2V内,导通电阻增加了34%,所有参数偏移均可完全恢复,但#A器件的缺点是由于沟道较窄导致导通电阻较高。
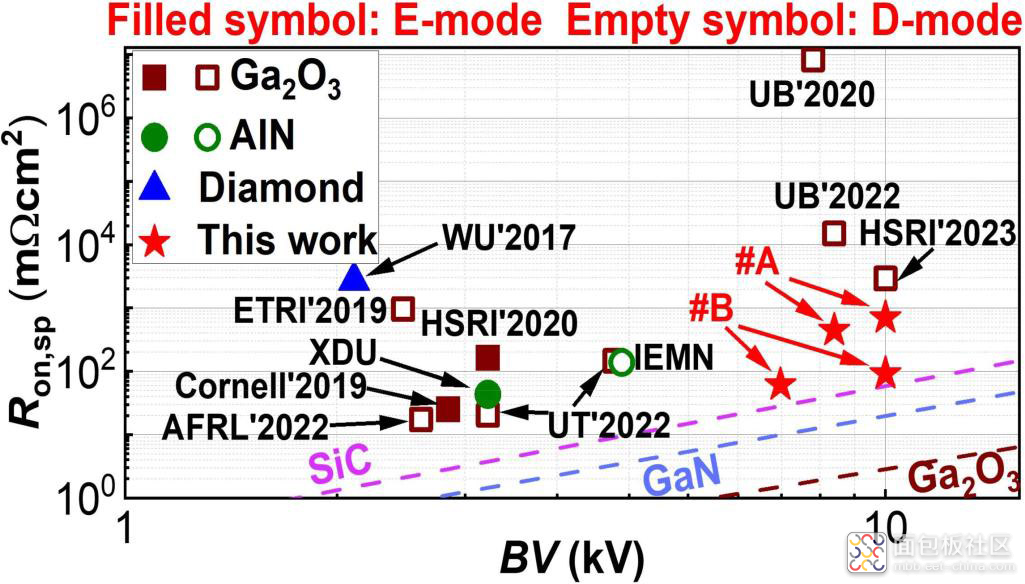
图2:比导通电阻(Rₒₙ,sp)与击穿电压(BV)的基准对比,针对击穿电压>2kV的超宽禁带(UWBG)功率晶体管。彩色虚线表示不同半导体材料(SiC/GaN/Ga₂O₃)的理论极限
通过对比文献中的Rₒₙ,sp和BV性能(图2),研究人员报告#A和#B器件的品质因数(FOMs,BV²/Rₒₙ,sp)分别至少为142MW/cm²和1086MW/cm²(BV>10kV)。这些数值被宣称是"所有BV>3kV的UWBG晶体管中的新纪录"。团队补充:"#A器件也是所有>3kV UWBG晶体管中首个报道的E-mode器件。
文章链接:https://www.semiconductor-today.com/news_items/2025/feb/virginia-130225.shtml
周子吉编译整理

 /5
/5 
文章评论(0条评论)
登录后参与讨论