原创
双向GaN突破3000V!
2025-4-8 10:17
468 7 7
分类:
电源/新能源
近日,《应用物理快报》刊登了一篇名为《蓝宝石基3kV单芯片双向GaN HEMT》的文章,其作者及研究团队来自于威斯康星大学麦迪逊分校,透露了单片双向GaN晶体管的最新研究进展。 该研究团队表示,他们通过优化欧姆接触、场板结构等工 艺, 开发了基于蓝宝石衬底的3kV单片双向GaN HEMT,在提升击穿电压的同时保持低导通电阻: 击穿电压:≥3 kV(受限于测试设备上限),漏极/栅极漏电流分别稳定在90 μA mm−1 及2 μA mm−1 。 导通电阻:20 Ω·mm(对应比导通电阻11mΩ·cm²),与TLM测试结果一致。 阈值电压:-3.25 V(定义于1mA/mm),亚阈值摆幅为92 mV/dec,开关比>10⁵。 研发背景
过去,传统双向开关方案通过两个单向晶体管反串联(anti-series)或反并联(anti-parallel)来实现双向功能,其不足较为明显: 一是高导通电阻:串联结构的总电阻为单个器件的两倍。 二是低可靠性:四颗器件结构(含内部连接)复杂度高,接触点增加会导致失效风险上升。 三是体积与成本问题:多颗器件的占用面积较大,难以小型化。 与之相比,单芯片GaN双向开关可有效解决以上问题,但是,其受限于制造工艺,击穿电压等级一般难以提升,不足以支持1200V/1700V的功率转换器应用。为此,业界主要选择蓝宝石作为衬底材料,以提高GaN器件的耐压能力。 威斯康星大学研究团队也是采用蓝宝石衬底方案,他们此前成功研制出击穿电压达1360 V的单芯片双向 GaN HEMT ,这一次,他们继续优化相关工艺,将击穿电压提升至3kV。 器件制备步骤:
在器件结构与设计中,该研究团队通过蓝宝石衬底、双场板优化和精密工艺控制,最终实现3kV GaN双向开关的突破性性能: 外延结构设计:采用MOCVD工艺,自下而上生长缓冲层、沟道层、插入层、势垒层及 帽层。
单片双向 GaN HEMT 的结构:(a)横截面(b)顶视图
欧姆接触形成: 通过光刻定义欧姆区域,沉积Ti/Al/Ni/Au金属堆叠(20/120/30/50nm),随后在N₂环境中900°C退火45秒,形成低阻欧姆接触(接触电阻Rc≈0.9 Ω·mm),确保源/漏极与2DEG的高效载流子注入。台面隔离:采用干法刻蚀工艺(如ICP-RIE)刻蚀750 nm深至Fe掺杂GaN层,实现器件间电隔离,防止相邻器件漏电。刻蚀后表面需清洁处理,避免残留物影响后续工艺。 栅极制备:通过两次30°倾斜沉积工艺,在刻蚀后的台面区域沉积200 nm厚Ni栅极金属,确保侧壁完全覆盖。 钝化层沉积:使用等离子体增强化学气相沉积(PECVD)在表面生长320 nm厚Si₃N₄层,作为钝化层降低表面态密度,抑制电流崩塌效应,同时为场板结构提供介质支撑。 第一场板(FP1)集成 :刻蚀Si₃N₄至剩余100 nm厚度,沉积Ni/Au(200/200 nm)金属,长度LFP1=1~3 μm(优化值≤2 μm),连接至源极(S1),用于分散栅边缘电场。第二场板(FP2)集成 实验结果:
器件成功研制后,该研究团队对其进行了相关测试,发现其基本满足实验目标: 击穿电压: ≥3 kV(受限于测试设备上限),漏极/栅极漏电流分别稳定在 90 μA mm − 1 及2 μA mm − 1 。
单片双向 GaN HEMT在 3 kV条件下的击穿响应
导通电阻: 当 L GG = 40 μm 时,导通电阻为 ∼20 Ω · mm,从而导致特定电阻率为∼11mΩ· cm 2 。
单片双向 GaN HEMT的双向IV特性
阈值电压: 阈值 电压在多次测量中稳定在 −3.25 V, 稳定 的 V TH、 低 SS 以 及高开/关比使该器件适合高频操作,具有低传导和开关损耗。 单片双向 GaN HEMT的传输特性
值得关注的是,该器件的击穿场强(∼75 V μm − 1 )仍然远低于 GaN 的理论临界场(330 V μm − 1 )。通过优化场板数量和几何形状,可以进一步提高GaN晶体管的临界场或击穿电压。该研究团队目前正在进行这方面的优化,预计未来将继续发表相关研究。
来源:行家说三代半
*声明:本文由作者原创。文章内容系作者个人观点,宽禁带半导体技术创新联盟转载仅为了传达一种不同的观点,不代表本联盟对该观点赞同或支持,如果有任何异议,欢迎联系我们。



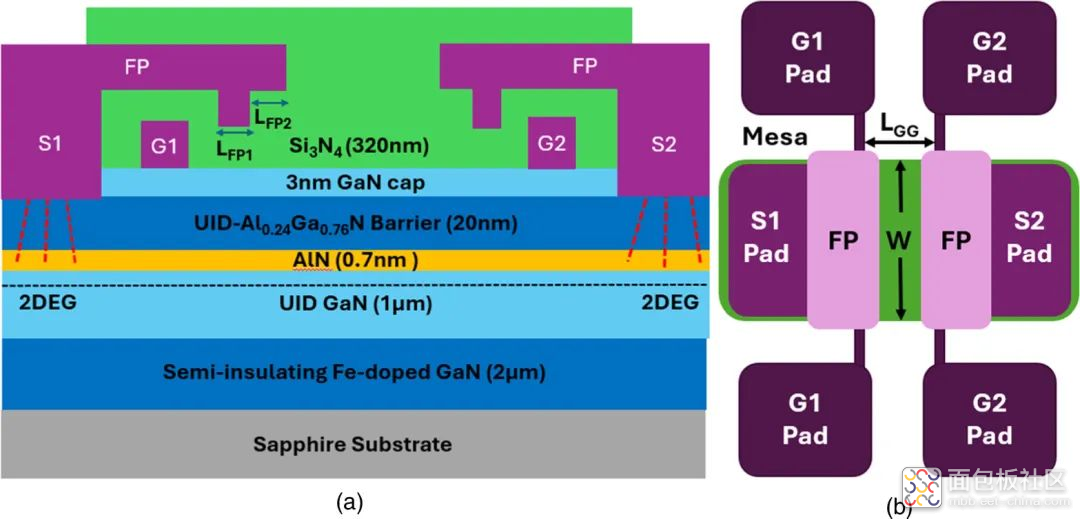
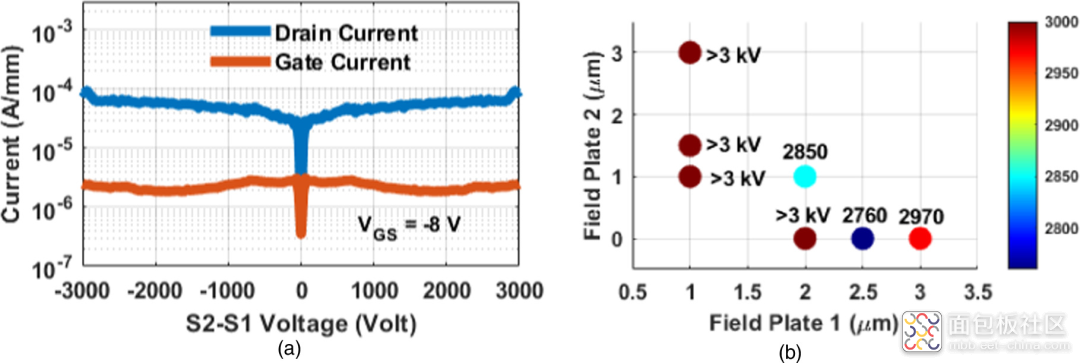
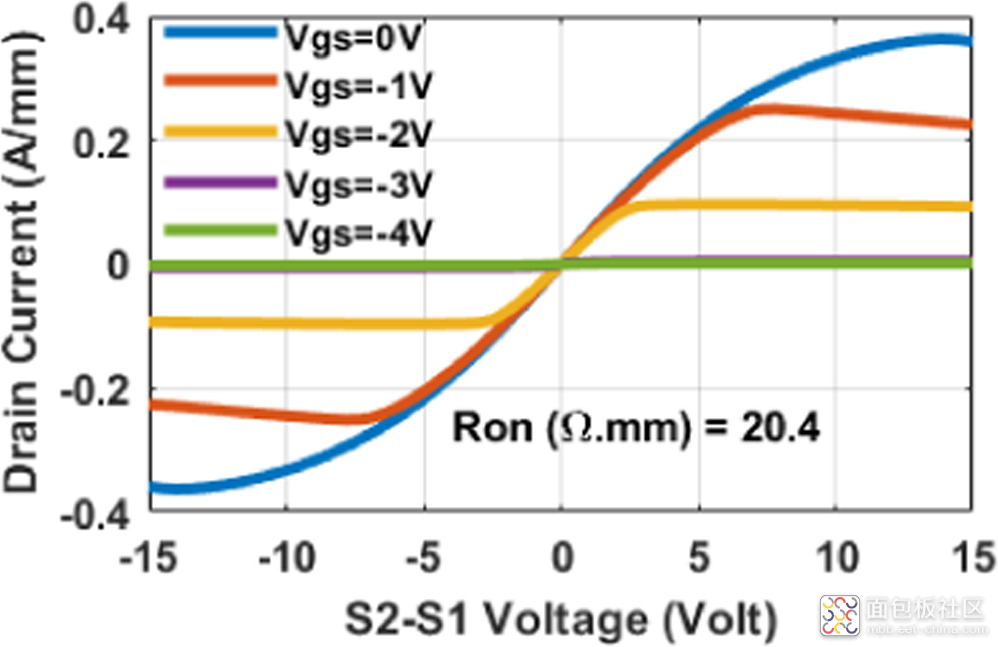
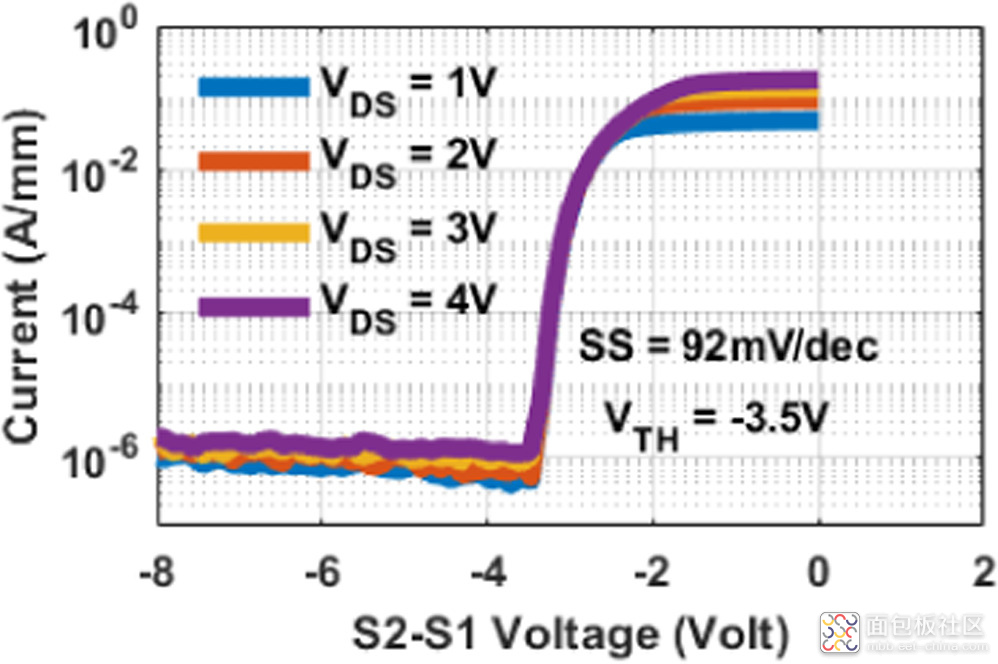

 /1
/1 
文章评论(0条评论)
登录后参与讨论