


摘要:本文聚焦于降低晶圆 TTV(总厚度偏差)的磨片加工方法,通过对磨片设备、工艺参数的优化以及研磨抛光流程的改进,有效控制晶圆 TTV 值,提升晶圆质量,为半导体制造提供实用技术参考。
关键词:晶圆;TTV;磨片加工;研磨;抛光
一、引言
在半导体制造领域,晶圆的总厚度偏差(TTV)对芯片性能、良品率有着直接影响。高精度的 TTV 控制是实现高性能芯片制造的关键前提。随着半导体技术不断向更高精度发展,传统磨片加工方法在 TTV 控制上的局限性日益凸显,研究新的磨片加工方法以降低晶圆 TTV 具有重要的现实意义。
二、磨片加工方法
2.1 设备与材料准备
选择高精度磨片设备,该设备需具备稳定的机械结构和精确的运动控制系统,以确保研磨过程的稳定性。研磨垫选用具有均匀硬度和良好耐磨性的材质,研磨浆料的成分和粒度根据晶圆材质和加工要求进行合理调配。例如,对于硅晶圆,可选用二氧化硅基研磨浆料,粒度控制在合适范围,保证研磨效率与表面质量 。
2.2 工艺参数设定
在研磨加工前,精确设定磨片设备的工艺参数。研磨压力根据晶圆尺寸和材质进行调整,避免压力过大导致晶圆损伤或压力过小影响研磨效率;研磨转速需与压力相匹配,确保研磨过程的均匀性。同时,合理规划研磨时间,通过试验确定不同阶段的最佳研磨时长,实现对晶圆厚度和 TTV 的有效控制 。
2.3 研磨过程
将晶圆固定在磨片设备的工作台上,启动设备,使研磨垫与晶圆表面接触并进行研磨。在研磨过程中,实时监测晶圆的厚度变化和 TTV 值。可采用在线测量技术,如激光测厚仪,及时反馈数据并调整研磨参数。分阶段进行研磨,粗磨阶段快速去除大部分余量,精磨阶段进一步细化表面,减小 TTV 。
2.4 抛光处理
研磨完成后,对晶圆进行抛光处理。采用化学机械抛光(CMP)技术,利用抛光液中的化学物质与晶圆表面发生化学反应,结合抛光垫的机械摩擦作用,进一步降低晶圆表面粗糙度和 TTV 值。严格控制抛光液的流量、抛光压力和抛光时间等参数,确保抛光效果的一致性和稳定性 。
高通量晶圆测厚系统
高通量晶圆测厚系统以光学相干层析成像原理,可解决晶圆/晶片厚度TTV(Total Thickness Variation,总厚度偏差)、BOW(弯曲度)、WARP(翘曲度),TIR(Total Indicated Reading 总指示读数,STIR(Site Total Indicated Reading 局部总指示读数),LTV(Local Thickness Variation 局部厚度偏差)等这类技术指标。



高通量晶圆测厚系统,全新采用的第三代可调谐扫频激光技术,相比传统上下双探头对射扫描方式;可一次性测量所有平面度及厚度参数。
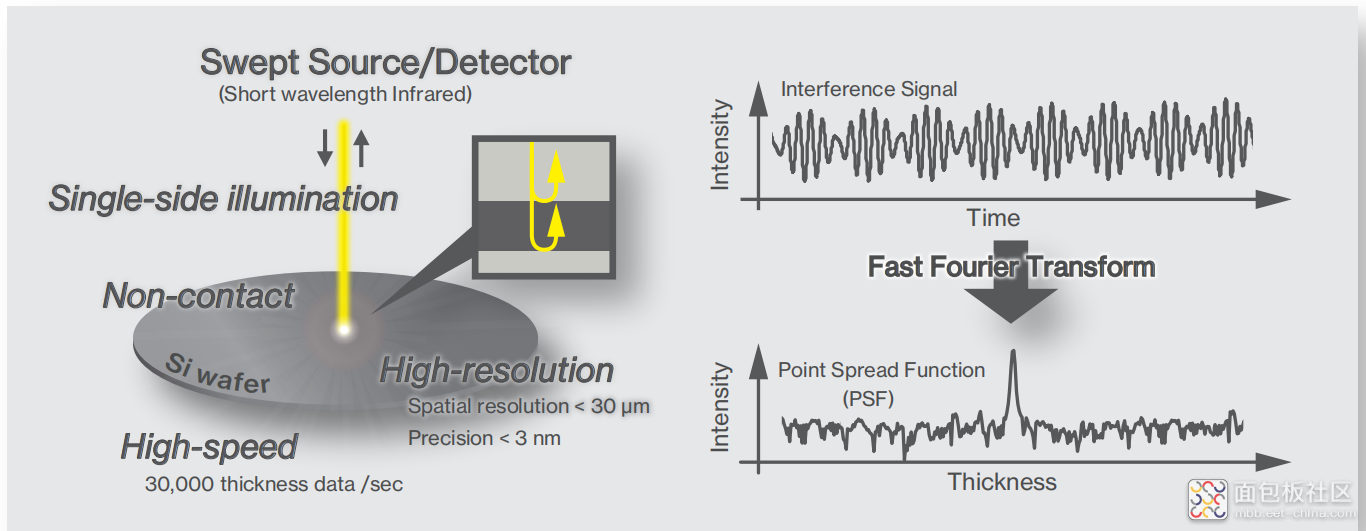
1,灵活适用更复杂的材料,从轻掺到重掺 P 型硅 (P++),碳化硅,蓝宝石,玻璃,铌酸锂等晶圆材料。

重掺型硅(强吸收晶圆的前后表面探测)

粗糙的晶圆表面,(点扫描的第三代扫频激光,相比靠光谱探测方案,不易受到光谱中相邻单位的串扰噪声影响,因而对测量粗糙表面晶圆)

低反射的碳化硅(SiC)和铌酸锂(LiNbO3);(通过对偏振效应的补偿,加强对低反射晶圆表面测量的信噪比)

绝缘体上硅(SOI)和MEMS,可同时测量多 层 结 构,厚 度 可 从μm级到数百μm 级不等。

可用于测量各类薄膜厚度,厚度最薄可低至 4 μm ,精度可达1nm。
可调谐扫频激光的“温漂”处理能力,体现在极端工作环境中抗干扰能力强,充分提高重复性测量能力。
4,采用第三代高速扫频可调谐激光器,一改过去传统SLD宽频低相干光源的干涉模式,解决了由于相干长度短,而重度依赖“主动式减震平台”的情况。卓越的抗干扰,实现小型化设计,同时也可兼容匹配EFEM系统实现产线自动化集成测量。


5,灵活的运动控制方式,可兼容2英寸到12英寸方片和圆片测量。
 /5
/5 
文章评论(0条评论)
登录后参与讨论