


宽禁带科技论
Theory of Wide Bandgap Semiconductor
"宽禁带科技论"将介绍宽禁带半导体行业内的最新科技论文,为读者提供行业内前沿科技信息。
氮化镓(gallium nitride, GaN)作为第三代半导体的材料,因优异的物理和化学性能,在高温、高压、高功率电子器件以及光电子器件中具有广泛的应用前景。然而,GaN单晶衬底的制备一直是技术难点,尤其是在大尺寸、高质量衬底的生长方面。氢化物气相外延(HVPE)技术因具有高生长速率和高晶体质量,成为制备GaN单晶衬底的主流方法之一。然而,随着衬底尺寸的增大,如何在大尺寸衬底上实现高均匀性和高速率的GaN厚膜生长,成为了当前研究的重点和难点。
《人工晶体学报》2025年54卷第1期发表了来自南京大学修向前教授团队的题为《高均匀性6英寸GaN厚膜的高速率HVPE生长研究》的研究论文(第一作者:许万里;通信作者:修向前)。论文在前期研究基础上,通过进一步数值模拟及实验对比分析和优化,研究气体流量、源气体出口与衬底距离等工艺参数对高速率生长GaN厚度均匀性的影响。
论文题录
许万里, 甘云海, 李悦文, 李彬, 郑有炓, 张荣, 修向前. 高均匀性6英寸GaN厚膜的高速率HVPE生长研究[J]. 人工晶体学报, 2025, 54(1): 11-16.
XU Wanli, GAN Yunhai, LI Yuewen, LI Bin, ZHENG Youdou, ZHANG Rong, XIU Xiangqian. High Rate HVPE Growth of High Uniformity 6-Inch GaN Thick Film[J]. Journal of Synthetic Crystals, 2025, 54(1): 11-16.
文章导读
图1为6英寸立式HVPE反应腔室结构示意图,进气端口由HCl气路(01路)、分隔气体气路(02路)、NH3气路(03路)和总氮气气路(04路)组成。
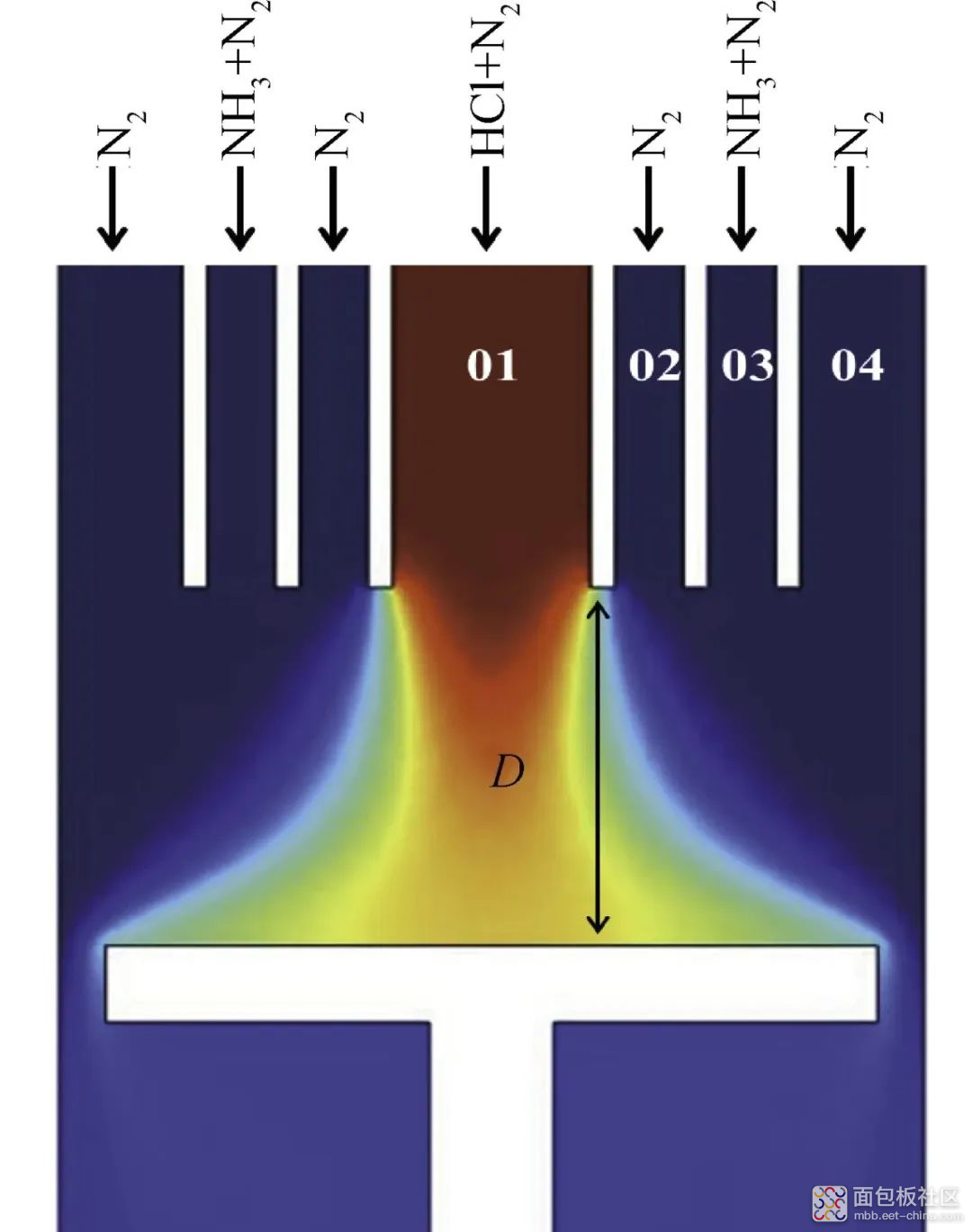
图1 6英寸HVPE系统反应腔室结构示意图
通过数值模拟和实际生长实验,本文系统研究了不同HCl气体流量、源气体与衬底之间的距离(D)、分隔气体和NH3载气流量等工艺参数对6英寸GaN薄膜厚度均匀性和生长速率的影响。图2展示了不同条件下数值模拟(实线)与实际生长实验结果(虚线)中GaN薄膜厚度(生长速率)沿直径方向的变化图谱。可以看出,GaCl气体的浓度分布直接决定了GaN的生长速率和均匀性。当HCl流量从200sccm增加到500sccm时,薄膜的生长速率从90μm/h提升至150μm/h,但厚度不均匀性从23%升高至38%(见图2(a))。当D值从4.5cm增加到7.0 cm时,薄膜的生长速率从90μm/h降低至50μm/h,厚度不均匀性从39%降至15%(见图2(b))。为了改善大尺寸GaN薄膜的均匀性,本文引入了分隔气体,并研究了分隔气体流量对薄膜生长的影响。发现分隔气体的引入可以有效促进GaCl气体向衬底边缘扩散,从而改善薄膜的均匀性。当分隔气体流量为3.3slm时,薄膜的不均匀性最低为8%,生长速率为80μm/h(见图2(c))。而不同NH3载气流量对薄膜厚度及均匀性的影响较小(见图2(d))。
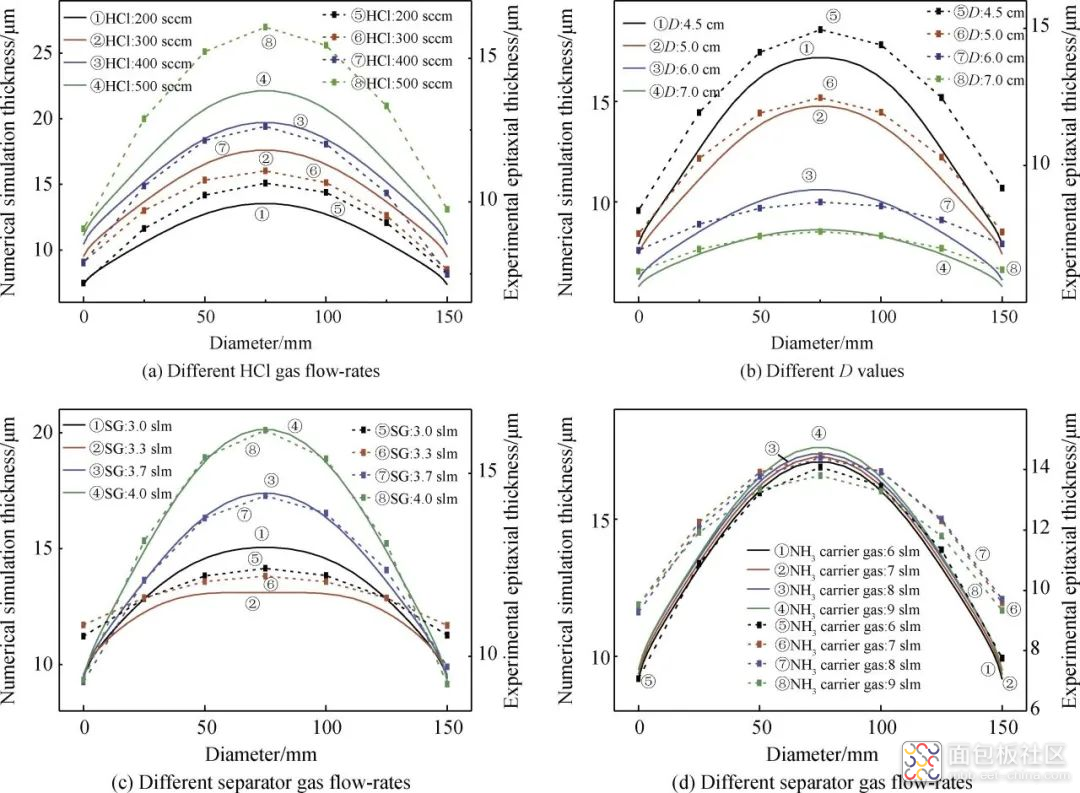
图2 不同条件下数值模拟(实线)与外延实验(虚线)中GaN膜厚度(生长速率)沿直径方向上的变化图谱
对不同条件下生长的6英寸GaN薄膜进行晶体质量表征,其摇摆曲线半峰全宽变化趋势如图3所示。当分隔气体流量在3~3.5slm、HCl气体流量在300~400 sccm、D值在5.0cm左右时,薄膜具有较高的晶体质量,同时生长速率为90 μm/h。外延时间3h时,6英寸GaN薄膜的平均生长速率达200μm/h。

图3 不同条件下获得的6英寸GaN膜摇摆曲线半峰全宽数值变化图谱
进一步优化生长条件,在6英寸蓝宝石衬底上成功制备了高均匀性GaN薄膜,外延层厚度~11 μm时厚度不均匀性为±1.5%,如图4(a)、(b)所示。研究还发现,生长时间增加至3h时,6英寸GaN厚膜的厚度不均匀性仍在±5%以内(见图4(c))。随着生长时间的增加,薄膜的生长速率逐渐提高(见图4(d))。

图4 HVPE外延6英寸GaN单晶厚膜光学照片、厚度不均匀性及生长速率变化曲线。10 min下获得GaN厚膜的光学照片(a)及厚度分布mapping图(b);不同生长时间下GaN厚度沿直径方向分布图(c)及生长速率随生长时间变化曲线(d)
结 论
本文结合数值模拟与生长实验详细研究了不同工艺参数对6英寸GaN单晶膜厚度(生长速率)及厚度不均匀性的影响。结果表明,引入分隔气体及适当改变源气体与衬底之间距离可以实现GaCl气体流量向6英寸衬底边缘的有效扩散,进而改善外延GaN厚膜均匀性。当分隔气体流量为3.0~3.5slm、HCl气体流量在300~400sccm、源气体与衬底距离D在5cm左右时,可以获得高生长速率、高厚度均匀性和较高晶体质量的GaN单晶薄膜。研究结果对大尺寸HVPE生长系统设计及大尺寸高质量GaN单晶衬底制备具有重要借鉴意义。
来源:人工晶体学报
*声明:本文由作者原创。文章内容系作者个人观点,宽禁带半导体技术创新联盟转载仅为了传达一种不同的观点,不代表本联盟对该观点赞同或支持,如果有任何异议,欢迎联系我们。
 /3
/3 
文章评论(0条评论)
登录后参与讨论