



凭借硅衬底的低成本和优异的散热性能,硅基氮化镓(GaN-on-Si)外延已经成为高功率密度电子器件的关键技术方案。然而,GaN-on-Si外延层因晶格失配和热膨胀系数差异存在高密度缺陷/位错(较蓝宝石衬底高1~2个数量级),加剧了器件的漏电流,并影响器件雪崩击穿过程,使其载流子输运与碰撞电离过程显著区别于蓝宝石基GaN器件。因而,尽管蓝宝石基GaN器件已建立较完善的物理模型,但现有仿真模型在Si基GaN功率器件应用中存在明显不足:未充分考虑与缺陷相关的载流子输运机制,且沿用蓝宝石基GaN的碰撞电离系数,导致对Si基GaN器件漏电流和击穿行为的预测严重偏离实验值。
针对这一瓶颈,近期广东工业大学、河北工业大学、中国科学院长春光学精密机械与物理研究所和南方科技大学联合研制了Si基AlGaN/GaN凹槽阳极肖特基势垒二极管(SBD),研究团队对与缺陷相关的载流子输运及碰撞电离的物理模型进行了修正。基于修正后的物理模型,设计并制备具有MIS(金属-绝缘体-半导体)阳极结构的AlGaN/GaN SBD。如图1所示,通过数值模拟和实验对比验证,在相同反向偏压下,MIS SBD的漏电流较传统金属-半导体(MS)结构降低了3个数量级,击穿电压(BV)提升至~1100V,同时保持3.98 mΩ·cm²的低比导通电阻(Ron,sp),功率优值(BFOM)达0.3GW·cm⁻²。图2的实验测试结果证实MIS结构可有效抑制因缺陷激活导致的动态特性退化。相较于同类Si基GaN SBD,本研究得到的BFOM指标在正反向电学性能上取得较好的权衡,为高压功率电子器件的可靠设计与性能突破奠定了理论与技术基础。该研究以《Physical Model Development for Fabricating MIS-Anode-Based 1100 V AlGaN/GaN-Based Lateral Schottky Barrier Diodes Grown on Silicon Substrate with Low Leakage Current》为题发表在Advanced Electronic Materials期刊上。
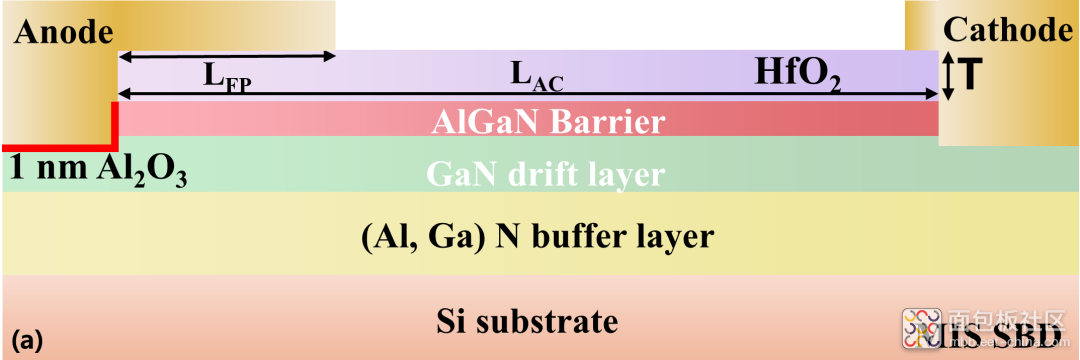

图1 (a) MIS SBD截面示意图;(b) 参考器件和MIS SBD仿真与实验反向I-V特性对比;关断应力状态下参考器件 (c) 和MIS SBD (d) 的电子输运过程示意图。

图2 (a) 正向电流1778 A/cm2应力下阳极电压随应力时间的变化;(b) 负偏置 200 V应力下阳极电流随应力时间的变化;(c) 本研究中制备的MIS SBD和其他已报道的横向AlGaN/GaN SBD的BV与Ron, sp的对比图。
广东工业大学集成电路学院博士生何婧婷为论文第一作者,张紫辉教授为通讯作者,孙晓娟研究员、黎大兵研究员、孙小卫教授为合作教授。该项目得到了国家自然科学基金区域创新发展联合基金重点项目(U23A20361)和广东省重点研发计划(2022B0701180001)的支持。
文章来源:广东工业大学张紫辉课题组投稿
论文链接:https://advanced.onlinelibrary.wiley.com/doi/10.1002/aelm.202500111

 /1
/1 
文章评论(0条评论)
登录后参与讨论