


导言: Si基IGBT在电力电子应用行业占据主导地位,比如 不间断电源、工业电机驱动、有轨电车以及电动汽车( EV) 等 ; 市场对更小型化产品的需求,使得碳化硅( SiC) MOSFET, GaN HEMT等将会 成为这些应用中受欢迎的替代品;同时,由于短时间内SiC MOSFET的成本还比IGBT要高出不少,因此行业内有在开发基于Si IGBT和SiC Mosfet的混碳产品,虽然GaN HEMT的大规模应用还需要时间,但是行业内也已经逐步出现基于GaN的车载电源产品出现;本文试图从原理角度解释不同晶体管的分类,并对Si基MOSFET,SIC,GaN,IGBT等不同晶体管在半导体组成原理层面做了一定的解释。

引用:YOLE
目录
1. 晶体管种类和特征;
2. BJT:双极型晶体管
3. FET:场效应管
4. IGBT:绝缘栅双极型晶体管
5. 总结
01 晶体管种类和特征
晶体管是一种半导体器件, 用于放大和开关电信号;其可以通过参与导电载流子及制造工艺,内部电路和外形进行分类。
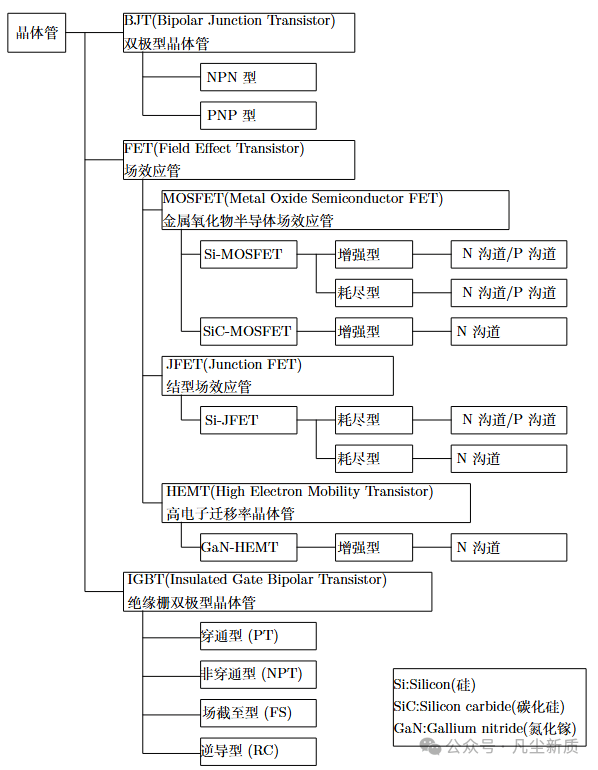
引用:Rohm
1.1 根据参与导电截流子及制造工艺
根据器件内部电子和空穴两种载流子参与导电情况及制造工艺,晶体管可以分为三类:
• BJT: 双极型晶体管 (Biploar Junction Transistor) 或者双极型器件, 指由电子和空穴两种载流子参与导电的器件;
两个 N 型半导体之间夹着一个非常薄的 P 型半导体的双极型晶体管称为 NPN 晶体管,而在两个 P 型半导体之间夹着一个 N 型半导体的双极型晶体管称为 PNP 晶体管,如图1所示。“晶体管”一词通常指这种晶体管,但由于当前出现了许多场效应晶体管产品,因此在这里使用双极型晶体管一词来与场效应晶体管区分。
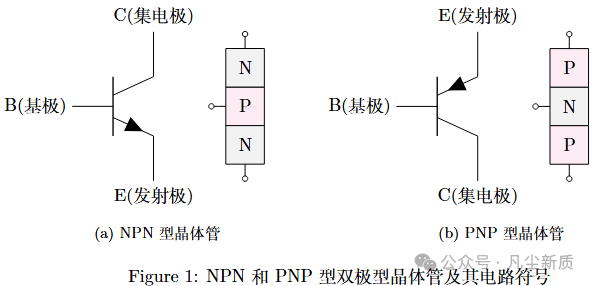
• FET:场效应晶体管 (Field Effect Transistor) 或者单极型器件:指由一种载流子参与导电的器件;通过向栅极施加电压,在半导体内部产生电场,从而控制源极和漏极之间电流的晶体管。
根据栅极结构的不同,FET 可以分为 MOS 型 (MOSFET, Metal Oxide Semiconductor FET) 和结型 (JFET, Junction FET);两种 MOS 都可以分为使用传统的硅 (Si) 作为半导体材料和使用碳化硅 (SiC) 作为半导体材料,使用硅的 MOSFET 和 JFET 分别称为 Si-MOSFET和 Si-JFET,使用 SiC 的 MOSFET 和 JFET 分别称为 SiC-MOSFET 和 SiC-JFET,Si-MOSFET中的 Super Junction MOSFET 通过改进制造工艺实现了更高的功率和速度。
根据是否在栅极上施加电压,FET 可以分为增强型 (除非在栅极上施加电压,否则不会有电流流过) 和耗尽型 (无电压时有电流流过) 两种;当前大多数 MOSFET 都是增强型,如图2所示为增强型 MOSEFT 的电路图符号,而所有 JFET 都是耗尽型。
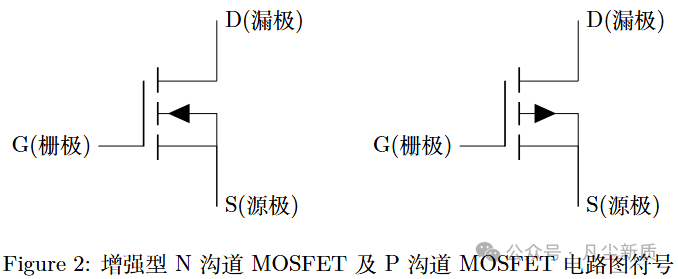
另外一种可以实现高速开关的场效应晶体管是 HEMT:高电子迁移率晶体管 (High ElectronMobility Transistor),其电流路径采用横向结构,并采用掺杂极少的化合物半导体如氮化镓(GaN), 称为 GaN-HEMT,这些器件能够实现应用中的节能和小型化。
• IGBT:绝缘栅双极型晶体管 (Insulated Gate Biploar Transistor) 或者复合型器件:指由单极性和双极型器件集成混合而成的器件;
NPN 和 PNP 型双极结型晶体管在导通时,少数载流子和多数载流子都参与导电;而 MOSFET只有多数载流子参与导电,因此在同等电压和电流下,MOSFET 的导通压降要低于场效应晶体管的导通压降; 而 MOSFET 需要栅极驱动能量小,而 BJT 需要相对高的基极电流来维持整个导通周期;结合 MOSFET 的驱动优势 (栅极电压控制晶体管,高输入阻抗) 及 BJT 导通优势 (双载流子达到大电流,低导通压降) 就产生了 IGBT。IGBT 是 MOSFET 和 BJT 的结合体,是兼具各自优秀特性 (驱动功率小,饱和压降低) 的功率晶体管,如图3a所示为 N 沟道 IGBT 电路符号,如图3b所示为 IGBT 结合了 MOSFET 和 BJT 的等效电路。
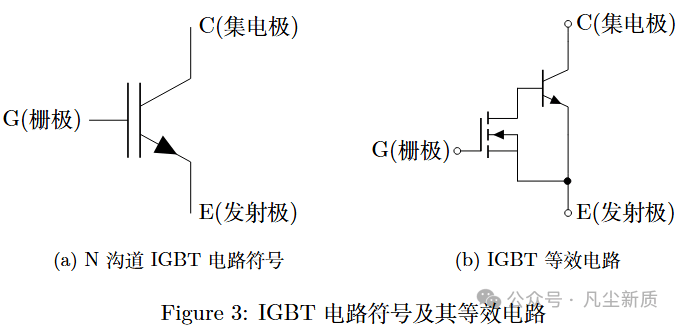
1.2 根据封装功率分类
根据封装功率分类法,封装功率小于 1W 的晶体管被归类为" 小信号晶体管",大于等于 1W 的晶体管被归类为“功率晶体管”;其中小信号晶体管包括双极性小信号晶体管,场效应晶体管,射频和微波小信号晶体管;功率晶体管包括通用功率双极型晶体管,通用功率场效应晶体管,IGBT,达林顿功率晶体管,射频和微波功率晶体管;根据电压范围,通用功率场效应晶体管可以分为五类:≤ 40V, ≤ 100V,≤ 200V,≤ 400V,> 400V。
1.3 根据内部电路分类
按照内部电路分类,封装内只有一个晶体管的称为单管,内置多个晶体管并集成了电阻和二极管的封装成为复合型。
02 BJT:双极型晶体管
双极型晶体管 (Bipolar Junction Transistor,BJT),简称晶体三极管/三极管,是指由电子和空穴两种载流子都参与导电的半导体器件,因此称为双极型。
如图1a所示,晶体管由两个 PN 结共用一个基区组成,两个 PN 结中一个为集电结,一个为发射结,中间区域叫做基区,另外两个区称为发射区与集电区,从三个区引出个电极端子,分别称为发射极(Emitter), 基极 (Base), 集电极 (Collector);发射区与基区之间的 PN 结称为发射结,基区与集电区之间的 PN 结称为集电结。
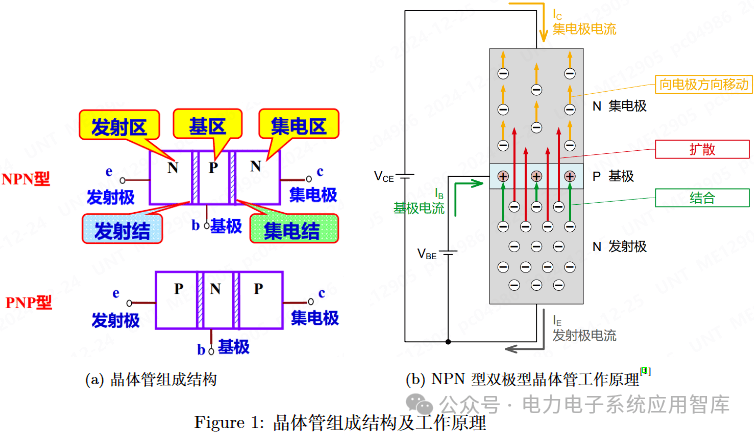
引用:网络
当基极通电时, 电流会在集电极和发射极之间流动。以如图1b所示的 PNP 型晶体管为例,当在基极和发射极之间施加正向电压 VBE 时,发射区的电子 (负电荷) 流入基区,部分电子与基区中的空穴(正电荷) 结合,这就是基极电流 IB 。由于基区是 P 型半导体,结构较薄,因此从发射区流入基区的大部分电子都扩散到集电区中。而集电极发射极电压 VCE 会诱导电子 (负电荷) 向集电极移动,这就是集电极电流 IC ,这些电流的流动方向与电子的运动方向相反。双极型晶体管是电流控制型器件,通过基极电流控制集电极和发射极之间的电流。
如图2所示,晶体管可以分为 NPN 和 PNP 两种类型,两种管子电路符号的发射极箭头方向不同,箭头方向表示发射结正偏时发射极电路的实际方向,也就是说根据电路中集电极端是流入电流还是流出电流而区分使用。
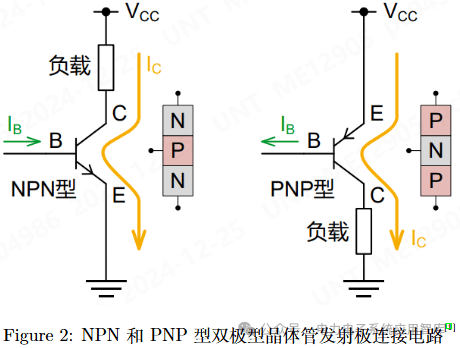
引用:Rohm
晶体管是一种把输入电流进行放大的半导体元器件,其实现放大的外部条件为: 发射结正偏,集电结反偏。即对于 NPN 型晶体管,其方法的条件为:发射结正偏 (VB > VE ), 集电结反偏 (VC > VB );对于 PNP 型晶体管,其放大的条件为:发射结正偏 (VB < VE ), 集电结反偏 (VC < VB )。
如图3所示为采用普通外延平面型结构的双极型晶体管,其制造工艺是在在具有高 n 型掺杂浓度的n+ 硅衬底上外延形成低掺杂浓度的 n-层。因此,集电极饱和电压低,击穿电压高。此外,由于在集电极到基极间使用了掺杂浓度较低的 n-层,集电极、基极间的结电容也会降低。接着,从 n-层上扩散 p型掺杂形成基极。此外,n+ 型掺杂扩散到部分基极,形成发射极。最后,在顶部形成保护膜,在顶部和底部形成电极,从而完成 NPN 型双极型晶体管。
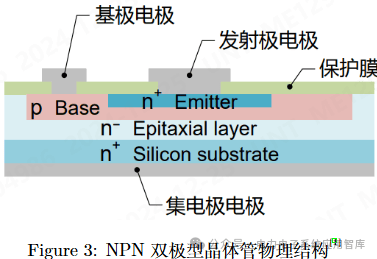
引用:Rohm
03 FET:场效应管
3.1 Si MOSFET:硅金属氧化物半导体场效应管
N 沟道 MOSFET 在漏极和源极之间采用 NPN 结构,因此当栅极电压为零时,没有电流从漏极流向源极,如图4所示; 当施加栅极电压时,P 型半导体中的电子(负电荷)会被吸引到栅极绝缘膜的正下方,形成 N 沟道区;因此,漏极和源极之间的形成了 N 型半导体,漏极电流开始流动,如图5所示;在P 沟道 MOSFET 的情况下,图中的 N 和 P 是相反的结构,空穴(正电荷)被吸引到栅极绝缘膜的正下方。同时,MOSFET 的栅极通过氧化膜与漏极和源极绝缘,因此不会像双极型晶体管的基极那样流过稳定的电流。因此,MOSFET 由电压驱动,所需的驱动功率较低。
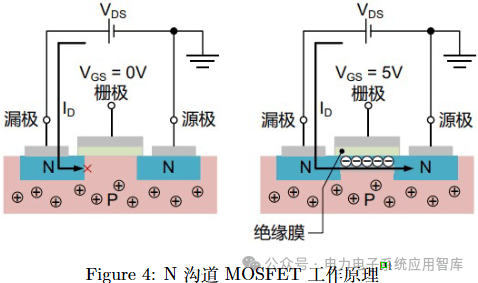
引用:Rohm
MOSFET 有 N 沟道型和 P 沟道型两种,如图5所示,根据电路中漏极侧是流入电流还是流出电流来分开使用。N 沟道型 MOS 栅源间施加正电压,漏极电流流动;P 沟道型 MOS 栅源间施加负电压,漏极电流流动。
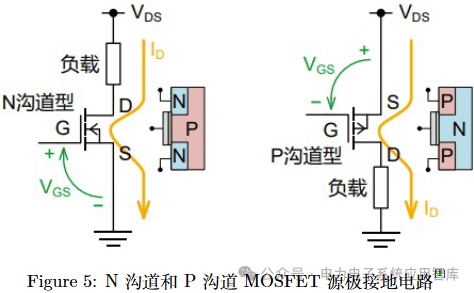
引用:Rohm
Si MOSFET 根据栅源间电压相等时漏极电流的流动方式,可以分为增强型和耗尽型。当栅源间的电压相等时,增强型漏极电流不会流动,而耗尽型漏极电流则会流动;要关断耗尽型的漏极电流,对于 N 沟道型,必须在栅极和源极之间施加负电压,而对于 P 沟道型,则必须施加正电压;此外,电路图符号也有区别:增强型在漏极, 后栅极和源极之间的垂线上有间隙,而耗尽型则绘制为一条直线,如图6所示。
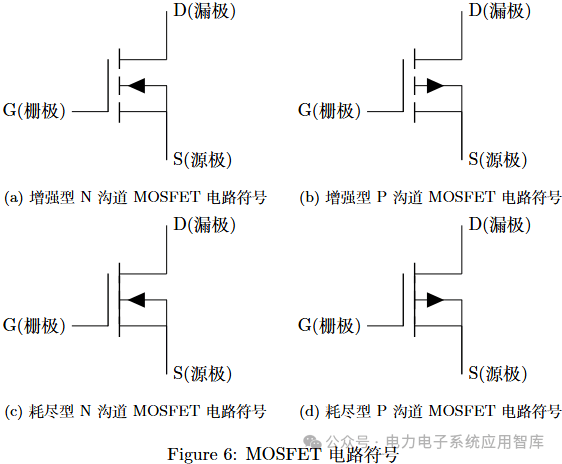
为了降低导通内阻,提高开关速度和实现更高的耐压,根据 Si MOSFET 的结构,MOSFET 可以分为:沟槽栅结构 (Trench)MOSFET,屏蔽性沟槽栅结构 (Shielded Gate Trench) MOSFET, 平面栅结构 MOSFET,超结结构 MOSFET;其中沟槽栅结构和屏蔽性沟槽栅结构 Si MOSFET 主要用于中低压领域,平面栅结构和超结结构 Si MOSFET 主要用于高压领域。
如图7a所示为典型的平面栅结构 Si MOSFET。制造工艺包括在具有高浓度 n 型掺杂的 n+ 硅衬底上外延形成低掺杂浓度的 n-层;在此基础上,p 型掺杂扩散到芯片外围,形成一个保护环,从而缓和电荷集中,提高耐压;接着,硅通过热氧化形成栅极绝缘膜,在绝缘膜上使用多晶硅形成栅极电极;通过电离 n 型掺杂并以高压加速将其注入晶片,形成源区。最后,在源极和漏极形成电极,完成平面型MOSFET。
如图7b所示为典型的沟槽栅结构 Si MOSFET。通过在垂直方向上形成较深的栅极,沟道也在垂直方向上形成;这缩短了漏极和源极之间外延层(漂移层)的距离,从而降低了导通电阻;然而,由于外延层距离缩短,其耐压低于平面结构。
如图7c所示为超结结构 Si MOSFET,其中在 n 型区形成了柱状 p 型层,p 型和 n 型交替排列,由于 n 型区的场强均匀,因此耐压比上述传统结构高,此外,高浓度 n 区的形成还同时实现了低导通电阻。
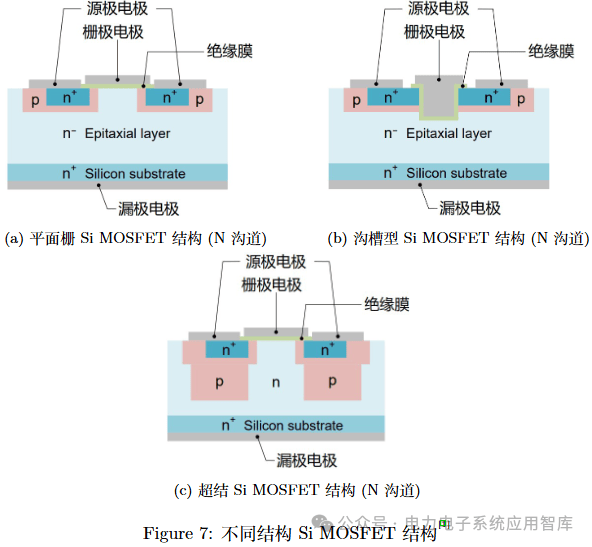
引用:Rohm
屏蔽性沟槽栅结构 MOSFET(SGT: Shielded-Gate Trench MOSFET) 工艺比普通沟槽工艺挖掘深度深 3-5 倍,在栅极下方增加了一块多晶硅电极,即屏蔽电极或者耦合电极。
3.2 SiC MOSFET: 碳化硅金属氧化物半导体场效应管
SiC MOSFET 被认为可以在耐压从 600V 开始,尤其是 1kV 以上的电压领域发挥作用。就优势而言,SiC MOSFET 的导通电阻低于同等耐压的超结 MOSFET,这意味着导通电阻相同的情况下可以减少芯片面积,并显著降低恢复损耗;与目前电压为 1kV 及以上 Si IGBT 主流产品相比,SiC MOSFET在关断时的损耗更低,因此可以实现高频开关,进而实现小型化应用。
与 Si MOSFET 相比,SiC MOSFET 的外延层 (漂移层) 电阻较低,但沟道电阻较高,使其栅极驱动电压 (VGS ) 越高,导通电阻越低的特性。要获得足够低的导通电阻,建议使用 18V 左右的 VGS ,因此,简单地更换适合用 Si MOSFET 电路中的 MOSFET 元件将导致电路无法工作,需要重新设计栅极驱动电路。
与 Si IGBT 相比,除了可以工作在高功率环境下,SiC MOSFET 还可以工作在高频环境下,这些特性可以转化为系统应用层面的优势,比如高功率密度,高效率和低散热。
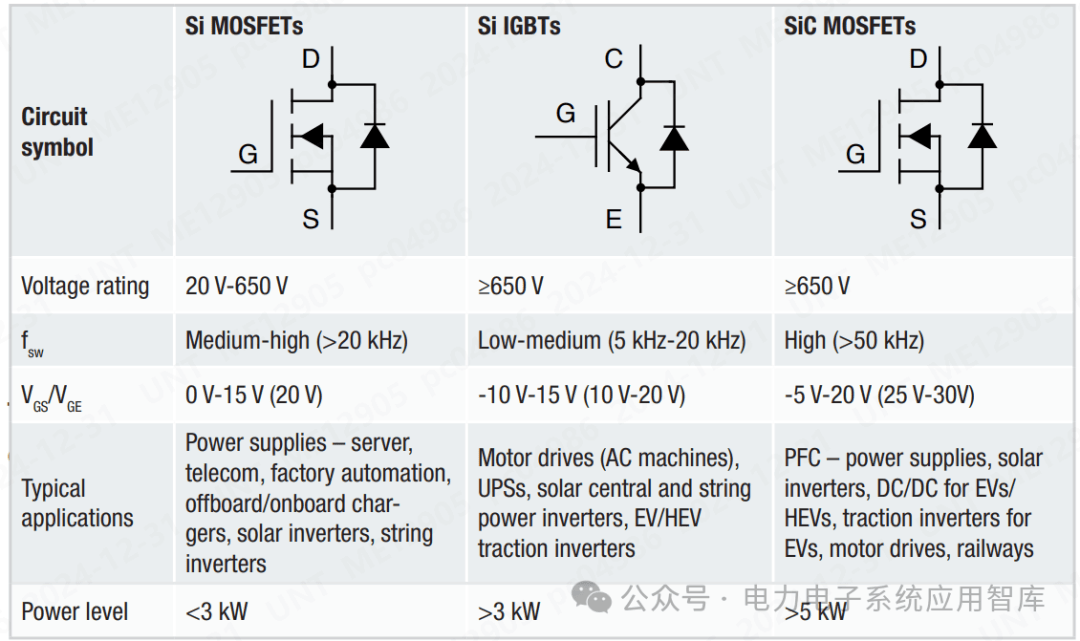
引用:TI
与 Si MOSFET 相比,SiC MOSFET 更适合于更高功率的应用,包括电动汽车和数据中心,一些太阳能设计、铁路牵引、风力涡轮机、网格分布与工业和医疗成像,需要在很高的电压下运行,并拥有优良的散热性能,但不总是需要进行高频开关的场景。
SiC MOSFET 的结构如图13所示,其基本结构与 Si MOSFET 相同,但衬底和外延层 (漂移层) 的半导体材料从硅 (Si) 改为碳化硅 (SiC);SiC 可以比 Si 更薄,因为即使外延层很薄,其物理特性也能实现高耐压特性。因此,源极和漏极之间的纵向距离缩短,导通电阻显著降低。图13a为平面结构的 SiCMOSFET, 图13b为沟槽式结构,其导通电阻比平面结构更低,常被用于第三代和第四代 SiC MOSFET中。
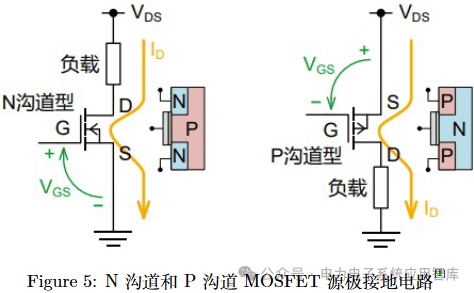
引用:Rohm
3.3 GaN HEMT:氮化镓高电子迁移率晶体管
GaN HEMT 与 SiC MOSFET 一样是宽禁带半导体,可以通过薄漂移层实现高耐压和低导通电阻;此外,漏极和源极之间的电流以高速横向流过高迁移率的二维电子气沟道,从而实现出色的开关特性。其耐压为 650V,而 SiC MOSFET 的耐压为几 kV。
因此,GaN HEMT 适合中功率,中电压和高频应用。如:数据中心服务器,移动电话基站电源,消费类 AC 适配器,汽车车载充电器和 DCDC 转换器等,所有这些应用都需要较高的功率转化效率,以及比 SiC MOSFET 更高频率 (>200kHz) 的开关操作,因为高频工作可以使得电能转换的外围元件尺寸变小,有助于实现最终产品的小型化。
如图14所示为使用 p-GaN 栅极的典型增强型(常闭型)GaN-HEMT 的结构。在硅衬底上生长出一个 AlN(氮化铝)成核层。然后建立一个由 GaN 或 AlGaN(氮化铝镓)组成的缓冲层,以减小 Si和 GaN 之间的晶格常数差异,在此基础上,再叠加氮化镓通道层(有源层)和铝镓氮电子阻挡层,在两层之间的界面上产生一层二维电子气(Two dimensional electron gas),作为电子高速流动的通道。
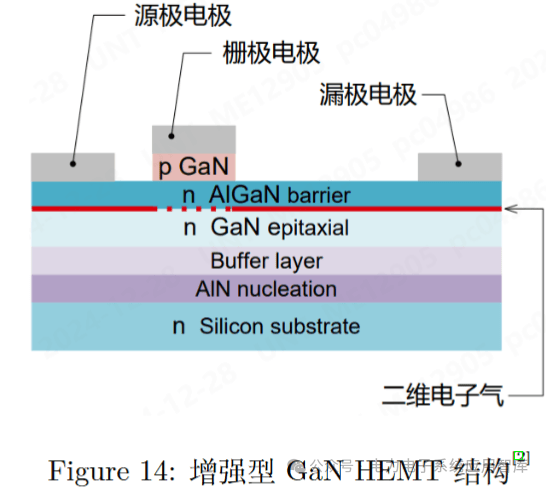
引用:Rohm
04 IGBT:绝缘栅双极型晶体管
IGBT 是 MOSFET 和 BJT 的结合体,是兼具各自优秀特性 (驱动功率小,饱和压降低) 的功率晶体管,如图3a所示为 N 沟道 IGBT 电路符号,如图3b所示为 IGBT 结合了 MOSFET 和 BJT 的等效电路。
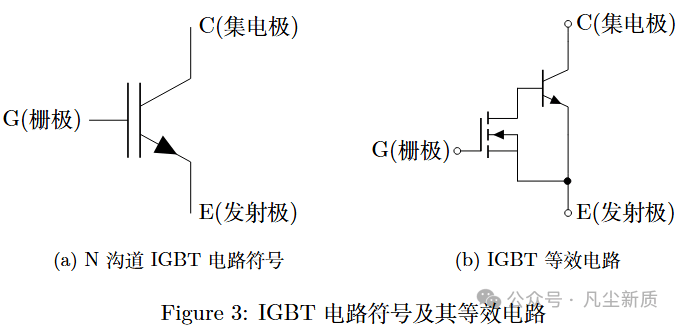
IGBT 有三个端子:栅极,集电极和发射极,栅极与 MOSFET 的栅极相同,而集电极和发射极可以视为与双极型晶体管相同。作为电压控制器件,IGBT 的工作方式与 MOSFET 相似:对于 N 沟道 IGBT,向发射极施加正栅极电压 VGE , 从而使集电极和发射极之间导通,并流过集电极电流 IC 。
如图15所示为 IGBT 的等效电路及工作原理,该结构由 N 沟道 MOSFET 漏极端的 p+ 集电极层和从集电极到发射极的 p-n-p-n 排列组成。等效电路中 N 沟道 MOSFET 的漏极和 PNP 晶体管的基极是共用的,作为 IGBT 的 n-漂移层。栅极是绝缘膜上的薄膜接线,N 沟道 MOSFET 的栅极就是IGBT 的栅极;IGBT 的发射极是 n+ 层,与 N 沟道 MOSFET 的源极相对应;PNP 晶体管的集电极是 p+,与 IGBT 的发射极 N+ 层相接;PNP 晶体管的集电极是 p+,与 IGBT 的发射极 N+ 层相接。

PNP 晶体管的发射极为 p+ 层,就是 IGBT 的集电极。对发射极施加正的集电极电压 VCE,同时对发射极施加正的栅极电压 VGE 时,IGBT 即开启。在这种状态下,集电极和发射极之间发生导通,集电极电流 IC 流过。将此操作应用到等效电路中, 当施加正 VGE 时,N 沟道 MOSFET 进入导通状态。这会导致 PNP 晶体管中流过基极电流 IB , 从而使 IC在 PNP 晶体管导通时从集电极流向 IGBT 的发射极。
结构图显示了电子(-)和空穴(+)在内部的运动。当对栅极施加正 VGE 时,电子(-)会聚集在紧靠栅极下方的 p+ 层,形成沟道。这与 MOSFET 导通的原理基本相同。从 IGBT 发射极提供的电子依次移动到 n+ 层、沟道、n-漂移层和 p+ 集电极层。另一方面,p+ 集电极层向 n-漂移层提供空穴(+)。漂移层一词的由来是由于电子和空穴载流子都在这一层中移动。因此,电子从发射极转移到集电极会导致电流 IC 从集电极流向发射极。
IGBT 分立器件一般应用在家用电器和小型工业设备中,工作频率一般在 1kHz 至 60kHz 之间,输出功率低于 1kVA;与其他组件组合而成的 IGBT 模块功率范围超过 100MVA,可用于有轨电车,电动汽车等。
05 总结
功率半导体式新能源汽车动力总成的核心器件,扮演者动力总成"心脏起搏器"的重要作用,其应用可以在不同零部件中出现,比如DCDC转换器,OBC电源,电机控制器,升压模块等,随着车载多合一技术,高功率密度和低成本需求的不断提升,要求功率半导体本身也要不断地优化以提升其性能以适应新的需求。在选择何种功率半导体匹配对应应用时,如果能够从机理上能够对各种半导体进行理解,会对最终选型提供很大的帮助,本文对各种功率半导体从机理上做了一定解释,后续本公众号会持续对功率半导体的具体应用持续展开解析, 感谢各位持续关注。
来源:电力电子系统应用智库
*声明:本文由作者原创。文章内容系作者个人观点,宽禁带半导体技术创新联盟转载仅为了传达一种不同的观点,不代表本联盟对该观点赞同或支持,如果有任何异议,欢迎联系我们。
 /4
/4 
文章评论(0条评论)
登录后参与讨论