白光干涉仪的膜厚测量模式原理主要基于光的干涉原理,通过测量反射光波的相位差或干涉条纹的变化来精确计算薄膜的厚度。以下是该原理的详细解释:
一、基本原理
当光线照射到薄膜表面时,部分光线会在薄膜表面反射,形成表面反射光;另一部分光线会穿透薄膜,在薄膜与基底的界面上反射,然后再次穿过薄膜返回,形成内部反射光。这两束反射光在空间中相遇时,如果它们的相位差是2π的整数倍,则会发生光的增强,即干涉现象。通过测量干涉光的强度分布或干涉条纹的变化,可以推算出薄膜的厚度。
二、测量模式
白光干涉仪通常采用以下几种测量模式来测量薄膜的厚度:
垂直扫描干涉测量模式(VSI):
在此模式下,干涉仪通过垂直扫描被测样品,记录不同位置处的干涉条纹变化。
通过分析干涉条纹的亮度分布和间距,可以计算出薄膜的厚度。
VSI模式适用于测量从光滑到适度粗糙的薄膜表面,提供纳米的垂直分辨率。
相移干涉测量模式(PSI):
PSI模式通过引入相移器来改变干涉光的相位,从而测量不同相位下的干涉光强度。
通过分析多个相移干涉图的光强值,可以求解出薄膜的厚度。
PSI模式具有极高的测量精度,通常可以达到纳米级别,适用于测量连续高度变化较小的微纳结构薄膜。
光谱干涉测量模式:
在此模式下,白光干涉仪利用白光作为光源,通过光谱仪分析干涉光的光谱分布。
不同波长的光在薄膜上形成的干涉条纹具有不同的间距和亮度分布。
通过分析光谱信息,可以计算出薄膜的厚度和折射率等参数。
三、测量步骤
准备样品:将待测薄膜样品放置在干涉仪的夹具中,确保样品表面平整且清洁。
设置测量参数:根据样品的特性和测量要求,设置干涉仪的测量参数,如扫描范围、相移步长、光谱分辨率等。
开始测量:启动干涉仪进行测量,记录干涉条纹或光谱信息。
数据分析:对测量数据进行处理和分析,根据干涉原理计算出薄膜的厚度。
四、应用与优势
白光干涉仪的膜厚测量模式具有广泛的应用领域,如半导体制造、光学元件加工、涂层厚度测量等。与其他测量方法相比,白光干涉仪具有非接触式测量、高精度、宽测量范围、快速测量等优点。此外,它还可以同时测量薄膜的厚度和折射率等参数,为材料研究和应用提供了有力的支持。
综上所述,白光干涉仪的膜厚测量模式原理是基于光的干涉原理,通过测量反射光波的相位差或干涉条纹的变化来精确计算薄膜的厚度。该原理具有广泛的应用前景和优势,在材料科学、工程技术等领域发挥着重要作用。
TopMap Micro View白光干涉3D轮廓仪
一款可以“实时”动态/静态 微纳级3D轮廓测量的白光干涉仪
1)一改传统白光干涉操作复杂的问题,实现一键智能聚焦扫描,亚纳米精度下实现卓越的重复性表现。
2)系统集成CST连续扫描技术,Z向测量范围高达100mm,不受物镜放大倍率的影响的高精度垂直分辨率,为复杂形貌测量提供全面解决方案。
3)可搭载多普勒激光测振系统,实现实现“动态”3D轮廓测量。
实际案例
1,优于1nm分辨率,轻松测量硅片表面粗糙度测量,Ra=0.7nm
2,毫米级视野,实现5nm-有机油膜厚度扫描
3,卓越的“高深宽比”测量能力,实现光刻图形凹槽深度和开口宽度测量。




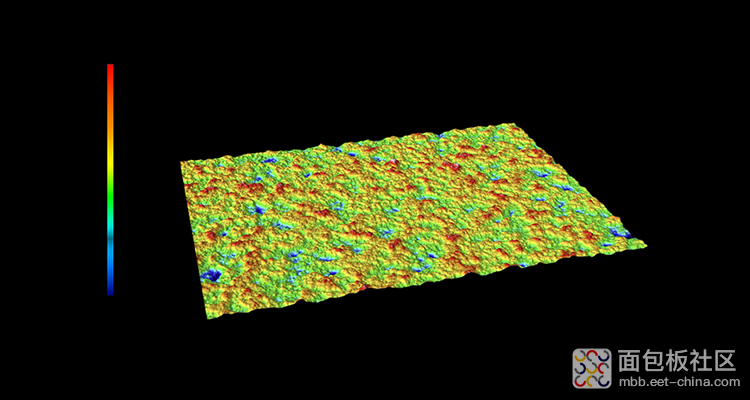

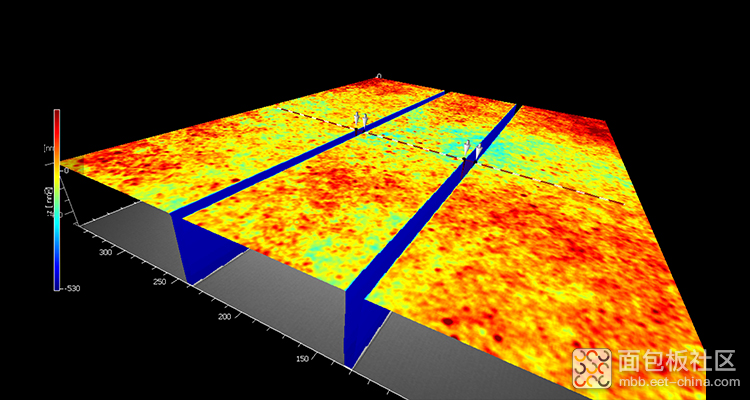
 /3
/3 
文章评论(0条评论)
登录后参与讨论