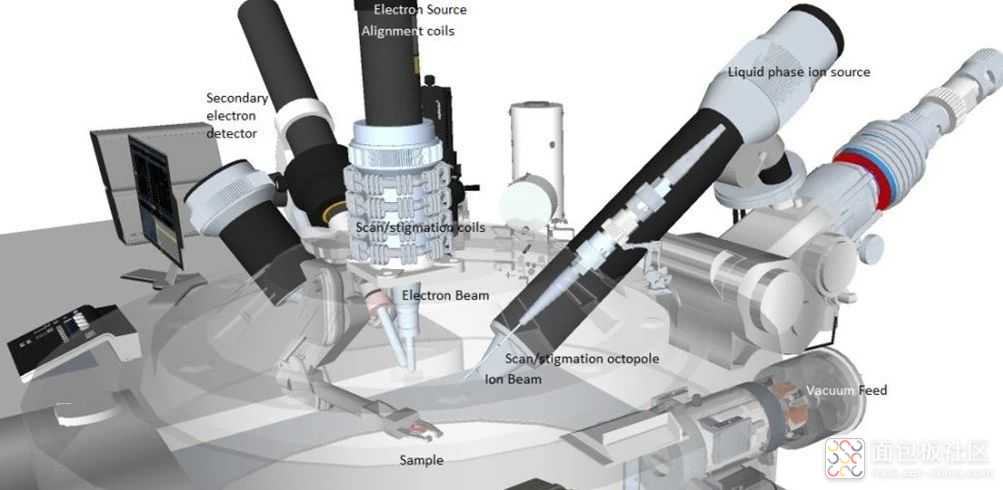
FIB系统基本组成
FIB系统由多个关键部分组成,如图1所示。离子源是系统的核心,通常采用液态金属离子源,如镓离子源。针型液态金属离子源的尖端是一个直径约几微米的钨针,针尖正对着孔径。在外加电场的作用下,加热金属使其液态化并浸润针尖,从而形成离子流。
离子源发射的离子经过光阑限束后,由聚焦系统聚焦,再通过不同孔径的可变光阑,得到束流可控的离子束。离子束在偏转系统的控制下,按照特定路径进行扫描,最终通过物镜入射到样品表面。
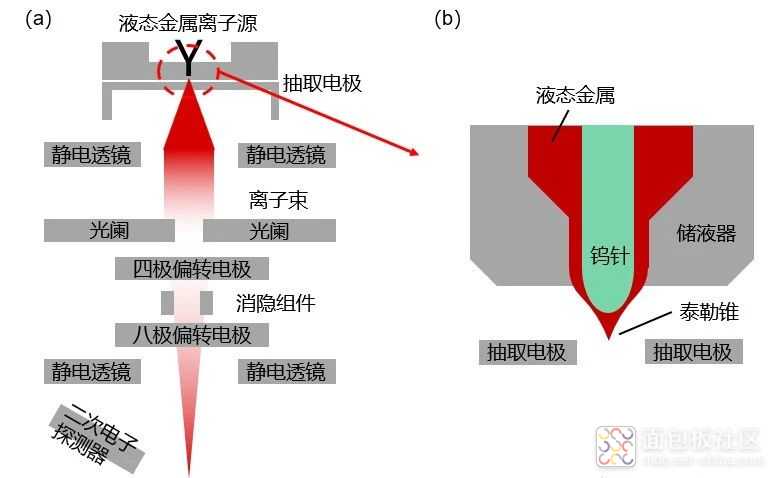
由于离子轰击衬底会产生二次电子,通过扫描电子显微镜(Scanning Electron Microscope, SEM)可以监测二次电子,从而获得样品表面的形貌图。这种同时具备FIB加工和观测功能的系统通常被称为双束系统,例如FIB-SEM双束系统和FIB-TEM双束系统。
FIB与电子束/光学光刻的对比
1.加工过程
FIB、电子束光刻(Electron Beam Lithography, EBL)和光学光刻(Photolithography)三种加工方式的本质都是将图形转移到特定衬底上,但由于工艺不同,其步骤和复杂程度也有所不同。
光刻和EBL需要通过光或电子束使光刻胶变性,再通过显影将变性的光刻胶洗掉,从而将图案转移到光刻胶上。随后,通过刻蚀工艺将图案转移到衬底上。
而FIB则可以直接利用离子束对样品表面进行定点轰击,完成微纳结构加工,无需光刻胶和掩模版。
2.从刻蚀角度分析三者
虽然三者都需要通过离子将特定位置的原子剥离以完成图案转移,但具体使用的离子和刻蚀方式有所不同。
FIB需要离子源对环境条件要求低,并且能提供大束流。其刻蚀过程为物理过程,溅射逸出的颗粒大部分被真空泵抽走,但部分颗粒会掉落在刻蚀区域附近,尤其在刻蚀大深宽比器件时,这种现象更为严重,可能会对光学器件的性能产生较大影响。
相比之下,光刻和电子束光刻大多采用电感耦合等离子体反应离子刻蚀(Induction Coupling Plasma-Reactive Ion Etching, ICP-RIE)。这种刻蚀方法结合了物理和化学过程,在离子对衬底的溅射基础上,增加了离子与衬底的化学反应并生成气体。通过抽气装置和调节气体流速,可以及时将衬底表面的气体抽运走,从而不影响加工精度。
3.从加工速度分析
在加工速度方面,光刻是最快的,且吞吐量最大,能够批量生产大量芯片。而EBL和FIB需要使用位移系统对刻蚀区域进行扫描。电子束只需诱导电子抗刻蚀剂变性,时间相对较短;而FIB需要对辐照区域进行剥离,对于面积大、深度深、精度高的刻蚀任务,所需时间较长。此外,光刻和EBL在刻蚀过程中由于有光刻胶保护,可以采用整体刻蚀,时间大大减少。
4.对比总结
与光刻和电子束光刻相比,FIB的加工步骤明显减少,能够实现“即刻加工,所见即所得”,并且可以沉积微小结构。其载物台可以实现多轴移动,结合离子注入可以控制结构的内部应力,从而加工复杂的三维结构。
FIB应用
1.微纳结构制备
FIB在微纳结构制备方面具有独特优势。与电子束光刻相比,FIB省去了繁琐的步骤,大大减少了加工参数的摸索时间,同时可以加工特征尺寸特别小的结构(几十纳米)。然而,其加工面积较小,加工的侧壁可能不够陡直。
2.芯片修补与线路编辑
FIB的离子束加工功能使其不仅可以刻蚀,还可以利用高能离子辐照诱导特定区域发生化学气相沉积反应。结合离子束轰击产生的二次电子,可以观察样品表面形貌图像。FIB的“看”、“刻”、“生长”功能使其非常适用于芯片或掩模(Mask)的缺陷修复,例如切断短路、对断路进行沉积等。
3.透射电镜(TEM)制样
透射电镜(TEM)样品需要非常薄,以便电子能够穿透并形成衍射图像。FIB的灵活多轴载物台可以对样品进行复杂操作,从而轻松完成TEM样品的制备。






 /1
/1 

