技术概述
聚焦离子束与扫描电镜联用系统(FIB-SEM)是一种融合高分辨率成像与微纳加工能力的前沿设备,主要由扫描电镜(SEM)、聚焦离子束(FIB)和气体注入系统(GIS)构成。聚焦离子束系统利用静电透镜将离子束聚焦至极小尺寸,最小束斑直径可小于10纳米,是一种高精度的显微加工工具。当前商用系统中,离子源种类丰富,涵盖镓(Ga)、氙(Xe)、氦(He)等。

在系统设计上,电子束镜筒与离子束镜筒之间存在固定夹角,不同厂商设备角度略有不同,FIB加工时,需将样品倾转至相应角度,使加工面正对离子束。
扫描电镜主要负责高分辨率成像,结合能谱仪可进行元素分析,还能用于特定材料的电子束曝光;而FIB的核心功能是微纳加工,可用于透射电镜(TEM)、三维原子探针(APT)等样品的制备,也可用于离子束成像,因其具有更明显的离子通道衬度,可用于飞行时间二次离子质谱(TOFSIMS)分析等。GIS系统则主要用于FIB加工前沉积保护层,以及半导体刻蚀和线路修复等。
离子源的分类与特点
1.液态金属离子源
液态金属离子源如镓(Ga)、铍(Be)、钯(Pd)等,发射温度低,寿命较长,应用最为广泛。其原理是利用液态金属在强电场作用下产生场致离子发射形成离子源。镓(Ga)作为目前使用最普遍的液态金属离子源,具有诸多显著优点。其熔点低,容易成为液态,高温下不易发生相互扩散;表面自由能低,容易浸润钨针尖端;加工精度较高,对样品的损伤相对较小;液态下不易挥发,有较长的使用寿命。
因此,目前大多数FIB设备采用Ga作为离子源。金鉴实验室在FIB领域提供专业的技术咨询和测试服务,帮助客户优化其FIB工艺,确保离子束的稳定性和精确性。
2.气体场发射离子源
气体场发射离子源如氦(He)、氖(Ne)等,亮度更高、束斑更小,但发射稳定性略差,寿命较短。
3.等离子体离子源
等离子体离子源如氙(Xe)、氩(Ar)、氧(O)等,电流更大,可进行高通量切割,适合大体积表征,尤其适合加工对离子束辐照敏感的材料,但价格较昂贵。
FIB的核心功能

1.切割功能
切割功能源于聚焦离子束的高能量,可通过轰击改变样品表面形状,结合扫描电镜可实现定点、定位取样,适用于微纳图案加工以及TEM和APT样品的制备。
2.沉积或增强刻蚀功能
沉积或增强刻蚀功能利用FIB将GIS中的气体分子沉积或作用在样品表面,可用于表面Pt保护、半导体线路修复及故障诊断剖析等。金鉴实验室提供的Dual Beam FIB-SEM服务,包括透射电镜(TEM)样品制备、材料微观截面的截取与观察、样品微观刻蚀与沉积以及材料三维成像和分析等。
3.成像功能
成像功能借助扫描电镜的探测器,离子束可用于观察表面形貌,尤其对于金属,二次离子的通道效应更明显,晶粒取向更易区分,同时二次离子还能进行微区元素分析,适用于表征同位素的分布。
FIB-TEM样品制备难点与解决方案
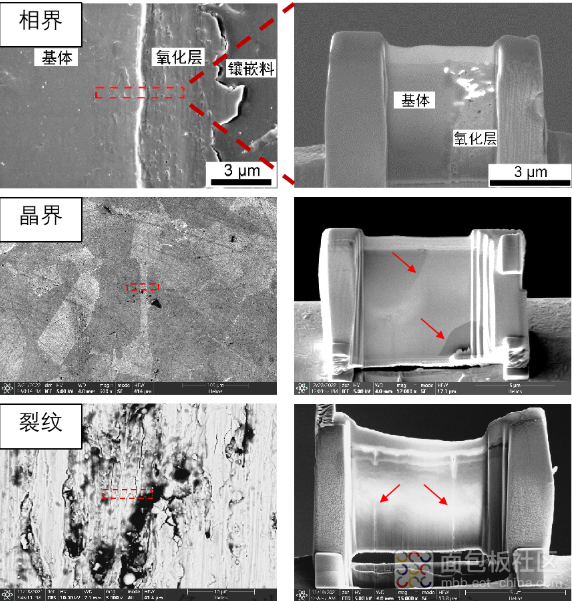
1.相界样品
相界样品由于相界两边材料及成分差异大,Ga离子减薄时速率有差别,需调控减薄方式,如分区域减薄,对难减薄的相增加减薄次数,使样品整体厚度趋于均匀一致。
2.晶界样品
晶界样品需将晶界留在减薄区域,要预挖坑确认晶界走向,才能减薄得到含有晶界的TEM样品。
3.裂纹样品
裂纹样品与晶界样品类似,需将裂纹留在减薄区域,选择裂纹时要初步筛选,减薄时必须控制角度、电压电流等,因为裂纹是缺陷,控制不当会迅速扩大,难以得到质量较好的TEM样品。
4.粉末样品
对于粉末样品,获得全截面的TEM样品较为困难。需选择合适的支撑物,表面平整且有一定静电吸附能力;解决粉末颗粒的固定问题,采用Pt沉积固定,从多角度、多位置沉积,形成Pt包裹层,后续根据需要适时补焊Pt,保证固定牢固性,提高减薄成功率。
FIB在工业领域的应用案例
1.金属材料工业
在金属材料工业中,企业常面临表面异物、缺陷等问题。例如,某金属表面出现大量凸起异物,需查明原因。利用FIB深度剖析,从表层到基体得到显微组织,发现基材层表面平整无缺陷,但第一层镀层存在向外凸起、向内少量嵌入基材且有明显缺陷等问题,外凸导致第二次涂镀表面形态异常。实验准确指出了异物产生的位置,为客户改进工艺提供了很大帮助。
2.有机材料领域
在有机材料领域,对于非表面的缺陷鉴定,FIB也能提供解决方案。如某有机半透明膜在光学显微镜下隐约发现异常点,但表面肉眼不可见,深度未知。先利用微分干涉功能初步确定异常点在二维平面的相对位置,再结合FIB进行深度方向剖析。实验难点在于异常点唯一,FIB切割不可逆,需严格计算开槽位置、控制加工速度和深度,边切边看,切到异常点立即停止。通过合理方案,成功确定了异常点的位置和异物成分。
3.半导体行业
在半导体行业,FIB应用频繁,是物理表征和失效分析的重要手段。例如,用FIB判别激光切割对晶圆芯片的损伤层影响。这种实验目的性强,时效性要求高,需设置合适参数快速得到可观测面,进行特定位置的尺寸测量。
聚焦离子束与扫描电镜联用系统凭借其独特的组成与功能,在材料科学、半导体工业等多个领域发挥着重要作用。






 /1
/1 

