
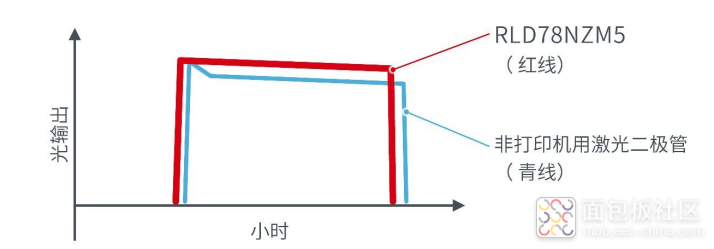
到目前为止,我们已经介绍过使用热阻和热特性参数来估 算TJ的方法。本文将介绍在表面贴装应用中,如何估算散 热面积以确保符合TJ max,以及与热相关的元器件布局 注意事项。元器件配置与热干扰 随着近年来对小型化的需求日益高涨,对电路板也提出了 要尽可能小的要求,使元器件的安装密度趋于增高。但是, 对于发热的元器件来说(在这里是指IC),需要将电路板当 作散热器,因此也就需要一定的面积来散热。如果不能确 保相应的面积,就会导致热阻升高,发热量增加。此外,如 果发热的IC彼此靠近安装,它们产生的热量会相互于扰并 导致温度升高。 下图就是表面贴装IC的散热路径和发热IC密集安装时的散 热情况示意图。 IC产生的热量沿水平方向(面积)和垂真方向(电路板厚 度)传导并消散。但是如果将IC安装得很密集,特别是水 平方向的热量会互相干扰,热量很难散发出来,因此最终 会导致温度升高。
散热所需的电路板面积估算 在表面贴装应用中,为了获得IC能够确保符合TJ max的 热阻,就需要有与其相应的散热面积。此外,避免热干扰也 很重要。下图是防止热干扰所需的间距示意图。至少在满 足这一点后,再根据θJA与铜箔面积的关系图估算所需的 散热面积。
如图所示,至少需要IC端面到板面的45°直线不干涉的间 距。接下来,求使用条件下所需的θJA。 条件示例:IC功耗=1W,最高环境温度TA(HT)=85℃, 最大容许TJ值=140℃。
从右图中可以看出,要想使θJA为55℃/W,需 要500mm2以上的铜箔面积。 就是这样通过确保避免热于扰的间隔和所需的散热面积, 来考虑最终的IC布局。





 /4
/4 

