TSV(Through - Silicon Via,硅通孔)是先进封装技术中的一种关键垂直互连技术。它通过在芯片内部打通通道,实现电气信号的垂直传输,可显著提高芯片之间的数据传输效率,减少信号延迟,降低功耗,并提升封装的集成密度。

一、工作原理
基于硅片中的深孔刻蚀技术,先在硅片中打孔,再填充铜等导电材料形成电气连接。这些通孔贯穿整个芯片厚度,可将不同芯片层或同一芯片内的不同电路相互连接,作为芯片与芯片、芯片与封装基板、以及芯片内部不同电路层之间的高效电气通道。
二、分类
2.5D封装中的TSV:通常用于中介层(Interposer)。中介层是带有 TSV 的载体,可承载多个芯片,如处理器和内存等,芯片通过 TSV 在中介层上互连,而非直接堆叠,主要应用于高性能计算和数据中心芯片等需要高度互连和高带宽的系统。
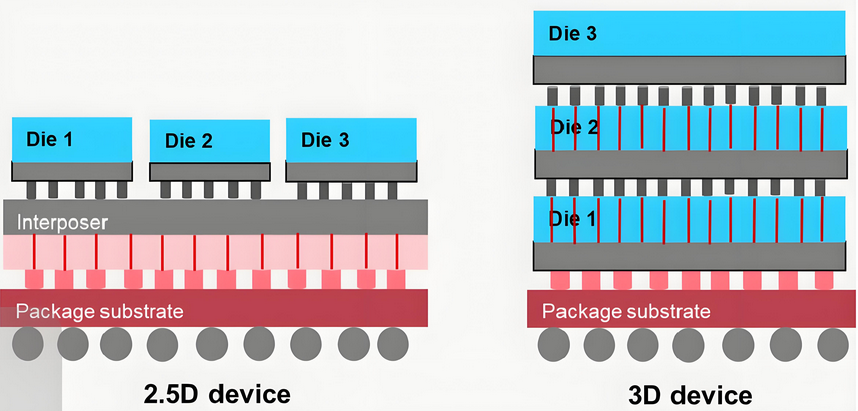
3D 封装中的 TSV:实现了芯片的垂直堆叠,每个芯片层通过 TSV 直接相互连接,形成一个整体,能让不同功能模块,如处理器和内存高度集成在同一个封装中,提高芯片集成密度和性能,同时减小封装尺寸。
Via-last TSV:TSV制作可以集成到生产工艺的不同阶段,通常放在晶圆制造阶段为Via-first,封装阶段为Via-last(该方案可以不改变现有集成电路流程和设计,目前业界已开始在高端的Flash和DRAM领域采用Via-last技术,即在芯片周末进行硅通孔的TSV制作,然后进行芯片或晶圆层叠。
Via-middle(中通孔)封装工艺:首先在晶圆制造过程中形成通孔,随后在封装过程中,于晶圆正面形成焊接凸点。之后将晶圆贴附在晶圆载片上并进行背面研磨,在晶圆背面形成凸点后,将晶圆切割成独立芯片单元,并进行堆叠。
三、工艺流程
中通孔基本工序:首先在晶圆上制作晶体管,随后使用硬掩模在硅通孔形成区域绘制电路图案,之后利用干刻蚀工艺去除未覆盖硬掩膜的区域,形成深槽;再利用CVD工艺制备绝缘膜(用于隔绝填入槽中的铜等金属物质,防止硅片被金属物质污染);此外绝缘层上还将制备一层金属薄层(将被用于电镀铜层)作为屏障;电镀完成后,采用CMP技术使晶圆表面保持平滑,同时清除其表面铜基材,确保铜基材只留在沟槽中。
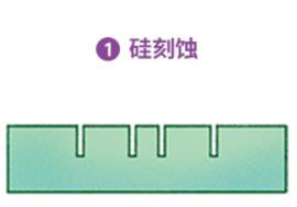
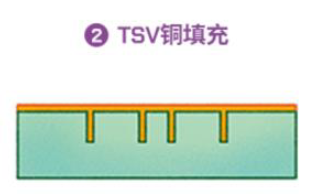
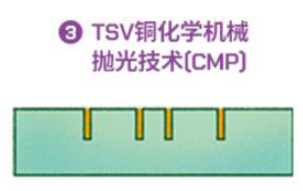
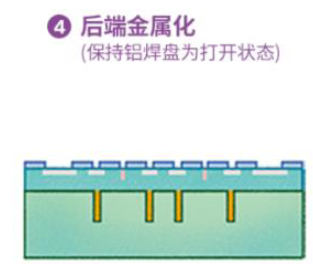
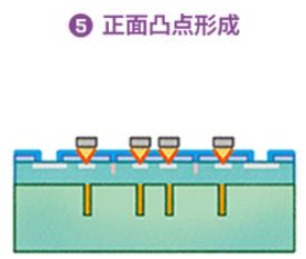
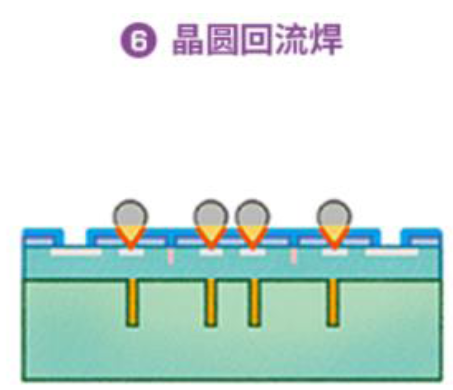
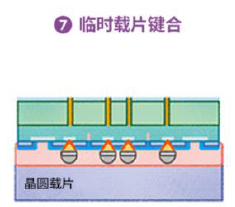
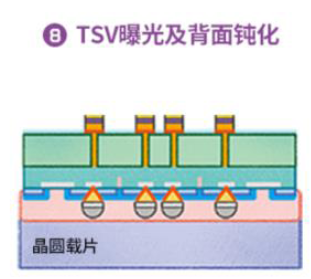
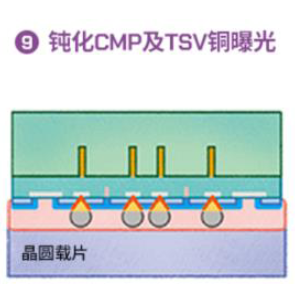
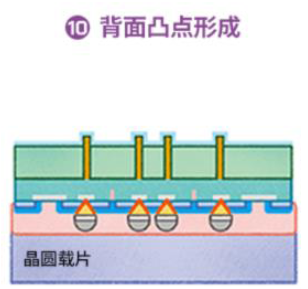
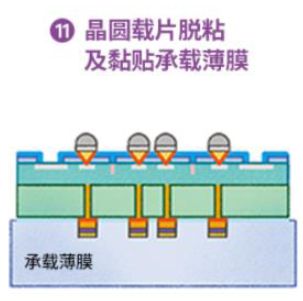





 /5
/5 


