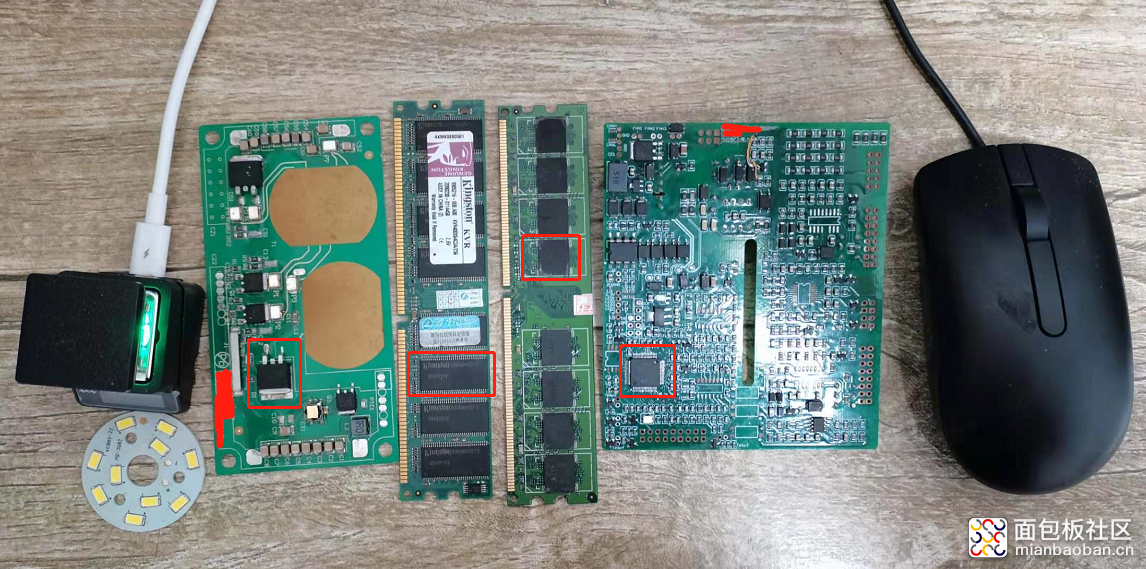
1.拆除LED铝基板上的灯珠,由于LED底部也是有焊盘的,烙铁是无能为力,只能用热风枪或者焊台,此处焊台更为合适,室温20℃左右,设置为M1曲线,最高220℃,放上LED铝基板,用时大概1分50S,从室温到220℃,此时灯珠已经可以取下了。

2.放上1.0mm厚的4层目标板,拆除上面的STM32F105主控芯片,该芯片为LQFP64封装,由于四周都有引脚,无法用烙铁,且周围0603封装电容电阻较多,也不便用热风枪,焊台设置M1曲线220℃的状态下,放上板子,大概过了2分钟,还没融化的迹象,怀疑可能是板子弯曲,加上PCB内部有大面积铜片,上下层导热不良,IC温度不够,遂把曲线调为M2,温度从220℃上升到240℃,用时20S,此时芯片已经可以拆下。


3.拆解一块服务器DDR2内存条上TSOP-66封装的内存颗粒,同样在M1曲线220℃的状态下,发现无法拆下,于是把曲线设置到M2,用时50S,上升到250℃,此时芯片可以轻松取下。
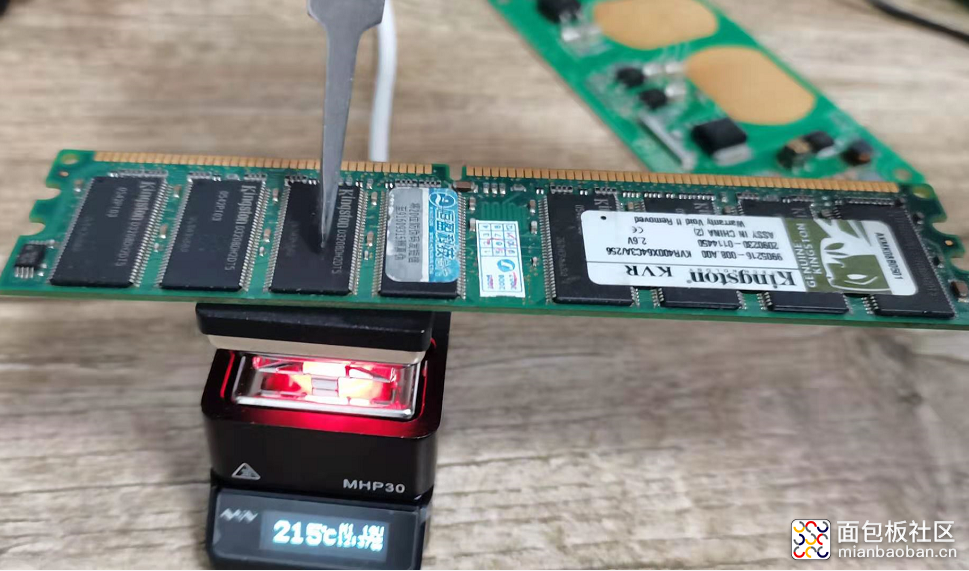

4.拆另一块DDR2普通内存条上BGA封装的内存颗粒,维持M2曲线250℃的状态,放上内存条,用时将近3分钟,此时芯片可以取下。(由于双面都贴有内存颗粒,因此拆解顶部内存颗粒会比较慢,这是因为热量从底部内存颗粒→PCB→顶部内存颗粒,导热路径太长,接触面又小,故导热能力不太好,实际可以调高到280-300℃可能会更快更轻松)


5.最后尝试拆解上次焊接的300W电源铝基板,直接调到M3温度曲线,待温度到300℃的时候,再放上铝基板,此时温度迅速下降到195℃,大概又经过4分钟,温度缓慢上升到240℃,可以看到锡已经融化,器件可以拿掉了。


经过上述几种不同类型的封装及板材的拆焊测试,结果比较满意,都能够顺利拆除,对于器件密度高,引脚多的IC,只要不是特大尺寸的铝基板,基本上都没有太大问题,拆除是其强项,比烙铁和热风枪都来的方便,电烙铁的局限性最大,芯片四周和底部有引脚的,都只能望洋兴叹,热风枪虽说能拆,但是对于大型铝基板和周围器件比较多的,有其局限性,铝基板散热太快,热风枪温度难以跟上,IC周围器件多的,容易吹跑,焊台正好能解决,另外其实热风枪和焊台结合使用,在一些大型的多层板场合更好,底部焊台加热,顶部热风枪吹,非常容易取下来,也不会因热风枪长时间加热把PCB吹糊或者高温损坏芯片。当然MHP30也是有缺点,加热台面太小,像内存条放上去都容易翻掉,需要扶着加热,还是希望出一个大尺寸的加热台面或者配套的支架也行,这样就能完美解决这个问题。









 /5
/5 

