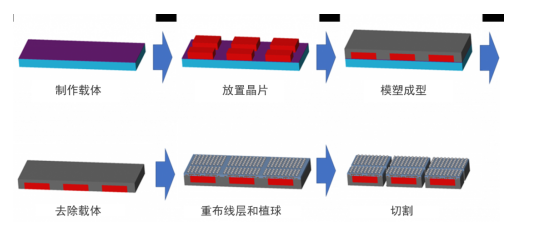
图1:eWLB封装流程
图2展示的是其他结合晶圆级封装的综合性先进封装技术。
硅通孔技术(TSV)是指完全穿透硅基底的垂直互连。图2展示的是基于硅中介层的硅通孔技术,即通过硅中介层实现高密度晶片与封装层之间的电气连接。该技术起初作为打线接合的替代方法而备受推广,能够在减小互联长度来优化电阻的同时,通过多个晶片堆叠实现3D集成。
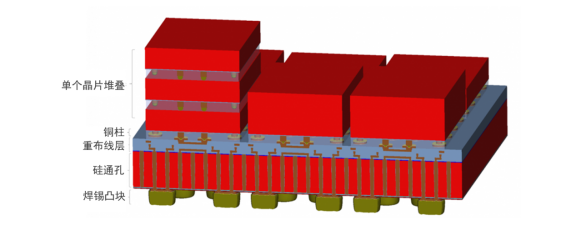
图2:器件封装示意图
作为导电互联技术的应用,重布线层的作用是重新分布连接至晶片焊盘I/O点位的电子线路,并且可以放置在单个晶片的一侧或两侧。随着对带宽和I/O点位需求的提升,重布线层的线宽和间距也需要不断缩小。为了满足这些要求,目前工艺上已采用类似后段制程的铜镶嵌技术来减小线宽,并通过铜柱代替传统焊接凸点的方法来减小晶片间连接的间距。
先进封装技术还在持续发展,以满足不断提升的器件密度和I/O连接性能要求。近几年出现的铜混合键合技术就是很好的例子,它的作用是直接将一个表面的铜凸点和电介质连接至另一个主动表面的相应区域,由此规避对凸点间距的限制。我们非常期待这些封装技术上的创新能够引领新一代电子产品的稳步发展。






 /5
/5 


