FIB系统工作原理
1.工作原理
聚焦离子束(FIB)系统是一种高精度的纳米加工与分析设备,其结构与电子束曝光系统类似,主要由发射源、离子光柱、工作台、真空与控制系统等组成,其中离子光学系统是核心部分,通常采用液态金属离子源,如镓离子源。针型液态金属离子源的尖端是直径约几微米的钨针,针尖正对着孔径,在孔径上加一外电场,同时加热金属,液态金属浸润针尖,在外加电场作用下形成离子束。
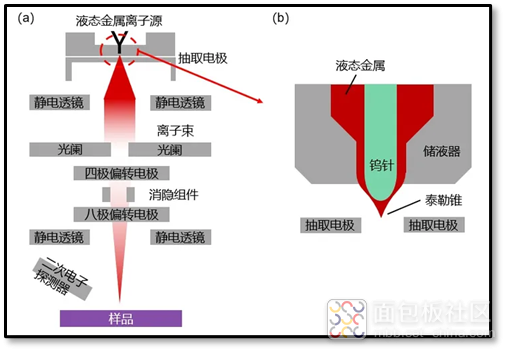
离子源发射出来的离子在通过第一级光阑之后,离子束被第一级静电透镜聚焦,四极偏转电极用于调整离子束以减小像散。然后通过不同孔径的可变光阑,灵活改变离子束束斑的大小,得到束流可控的离子束。次级八极偏转电极使离子束根据被定义的加工图形进行扫描加工,通过消隐偏转器和消隐阻挡膜孔可实现离子束的消隐。最后,通过第二级静电透镜,离子束被聚焦到非常精细的束斑,分辨率可至约5 nm。被聚焦的离子束轰击在样品表面,产生的二次电子和离子被对应的探测器收集并成像。
2.FIB - SEM双束系统
由于离子轰击衬底会产生二次电子,可通过扫描电子显微镜(SEM)监测二次电子得到样品表面的形貌图。这样同时具备FIB加工和观测的系统通常称为双束系统(离子束和电子束),例如FIB - SEM双束系统和FIB - TEM双束系统。FIB - SEM双束系统可以简单理解为单束聚焦离子束系统与普通扫描电镜的耦合。它将离子镜筒和电子镜筒以一定夹角方式集成为一体,实现在离子束进行加工的同时进行图像的实时观察。
FIB功能
1.基本功能及应用
目前,FIB - SEM双束系统已经发展成为一个可用于各类固体样品的微纳加工和原位研究的综合性样品制备和测试分析平台。最常用的是Ga离子双束电镜,通常包括透射电镜(TEM)样品制备,材料微观截面截取与观察、样品微观刻蚀与沉积以及材料三维成像,原子探针制备等等。
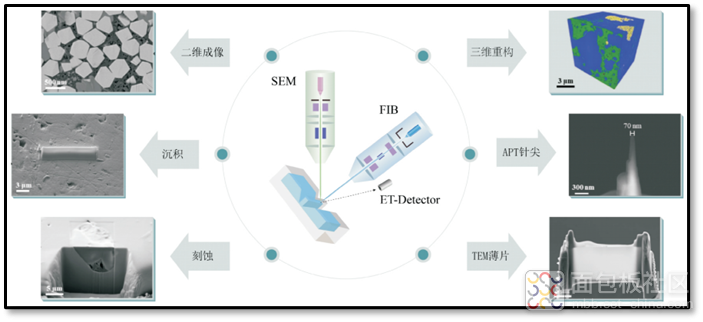
Ga离子束与样品发生相互作用会产生多种信号,这是实现各种功能的基础。其主要功能包括:首先,入射的Ga离子束轰击到样品上,会产生二次电子、背散射离子和二次离子等,这些信号主要用于对物质表面形貌和成分的空间分布进行电子束成像,用于定位样品,获取微观结构和监测加工过程。
Ga离子束可以通过透镜系统和光阑将离子束直径聚焦到5 nm以下,高能离子与样品表面原子之间的碰撞会将其表面原子溅射出来,这样就可以通过离子束的扫描轨迹来实现对样品进行精细的微纳米尺度刻蚀功能,用来进行截面观察和特殊形状加工;

离子束与气体注入系统(GIS)结合可以实现沉积或者增强刻蚀。将含有金属的有机前驱物加热成气态通过针管喷到样品表面,当离子或电子在该区域扫描时,可以将前驱物分解成易挥发性成分和不易挥发性成分,不易挥发性成分会残留在扫描区域,产生的挥发性气体随排气系统排出,这样就实现了离子束 / 电子束诱导沉积气体沉积,用于图形加工和样品制备。
目前常用的前驱物可以沉积Pt、C、W、SiO₂等;还有显微切割制备微米大小纳米厚度的超薄片试样(厚度小于100 nm),用于后续的TEM和同步辐射STXM等相关分析;显微切割制备纳米尺寸的针尖状样品,用于后续的APT分析,获取其微量元素和同位素信息;综合SEM成像,FIB切割及EDXS化学分析,对试样进行微纳尺度的三维重构分析等。
2.FIB - SEM制备TEM超薄片过程
利用SEM分析找到感兴趣的区域,表面尽量平整。选定目标微区(长×宽约为15×2 μm),并在该微区内选定一特征点置于画面中心,倾转样品台至样品表面与离子束垂直(~54°)。为了避免在此过程中离子束对样品表面的“误伤”,通常还需利用电子束及离子束沉积的方式在该目标微区表面预先沉积约~1 μm厚的Pt或C,作为保护层(配合气体注入系统,GIS)。
待样品倾转到合适角度并移动到视野中心位置后,利用离子束在保护层上下两侧紧邻区域向纵深方向挖出两个凹型槽,初步将目标样品暴露出来。这个过程通常先采用大束流进行粗切,当靠近目标样品时需要降低离子束束流进行精细切割,直到宽度约1.5 μm。然后,通过转动样品台的倾角至0~10°,并通过离子束继续切割将目标样品的底部及其一个侧边与母样断开。此时,目标样品与母样只有一个侧边相连。
移动纳米操作手,使其尖端缓慢接近样品,按针尖与样品的距离选择合适的速度(即保证移动相应距离约需5~10秒)。待针尖轻轻接触到目标样品顶部的端口位置,采用GIS系统对连接处进行Pt沉积(30 kV,20~50 pA),从而将目标样品与纳米操作手相连。之后,采用离子束将目标样品与母样从另一边完全切离,并移动纳米操作手将目标样品从母样中缓慢提出。
将FIB专用的TEM载网竖直放入到专用样品台中,并在FIB中将载网倾转和样品同样的角度,缓慢上移至优中心处。移动纳米操作手使目标样品缓慢下降,轻轻贴到载网上,利用GIS系统在目标样品与TEM载网的接触点上沉积Pt并连接,连接牢固后利用离子束切割将操作手的针尖与目标样品进行断开,撤出针尖。
对已经固定在FIB专用TEM载网上的目标样品进行二次减薄和精修。为了保护样品表面不被离子束很快刻蚀掉,样品刻蚀角度需偏转1.5°。随着样品减薄,其易受损伤程度增加,因此需要逐步降低束流,最终达到所需厚度(通常为~100 nm)(在电子束5 kV或3 kV透亮)。





 /2
/2 

