双束聚焦离子束-扫描电镜(Dual Beam Focused Ion Beam, FIB)作为一种先进的微观加工与分析技术,广泛应用于材料科学、纳米技术、半导体研究等领域。其不仅可以制作常见的截面透射电子显微镜(TEM)薄片样品,还能根据不同的研发表征需求,对材料样品的表面进行平面加工制样。
截面与平面TEM样品的区别
截面TEM样品与平面TEM样品的主要区别在于观察面的方向。
截面TEM样品的观察面是表面以下垂直的截面,主要用于研究材料内部的微观结构、界面特征以及缺陷分布等情况。
例如,在半导体材料中,通过截面TEM样品可以清晰地观察到不同层之间的晶格匹配情况、杂质分布以及可能存在的位错等缺陷。

平面TEM样品则关注水平方向的表面,主要用于研究材料表面的微观结构、表面缺陷、表面吸附物以及表面与基底之间的相互作用等。例如,在催化剂研究中,平面TEM样品可以帮助研究人员观察催化剂表面的活性位点、纳米颗粒的分布以及表面的化学反应过程。
截面与平面TEM样品的制样过程差异
1.保护层范围
在制样过程中,保护层的范围是截面与平面TEM样品的一个重要区别。
对于截面样品,表面的保护层大小约为10μm×1μm,主要用于保护样品在加工过程中不被离子束损伤。金鉴实验室在制备截面样品时,能够根据样品的尺寸和所需的观察区域,精确调整保护层的大小,确保在加工过程中能够有效保护样品不被离子束损伤。保护层的材料通常选择与样品材料相容性好、不易被离子束蚀刻的材料,如碳、钨等。
对于平面样品,表面的保护层较大,具体大小则根据所需表征的微结构和薄区的大小而定。由于平面样品的加工过程更为复杂,需要在材料表面进行大面积的加工,因此保护层的作用尤为重要。保护层不仅可以防止离子束对样品表面的损伤,还可以在加工过程中起到支撑作用,防止样品表面发生变形或塌陷。在选择保护层材料时,除了要考虑其与样品材料的相容性外,还需要考虑其在加工过程中的稳定性以及对后续观察的影响。
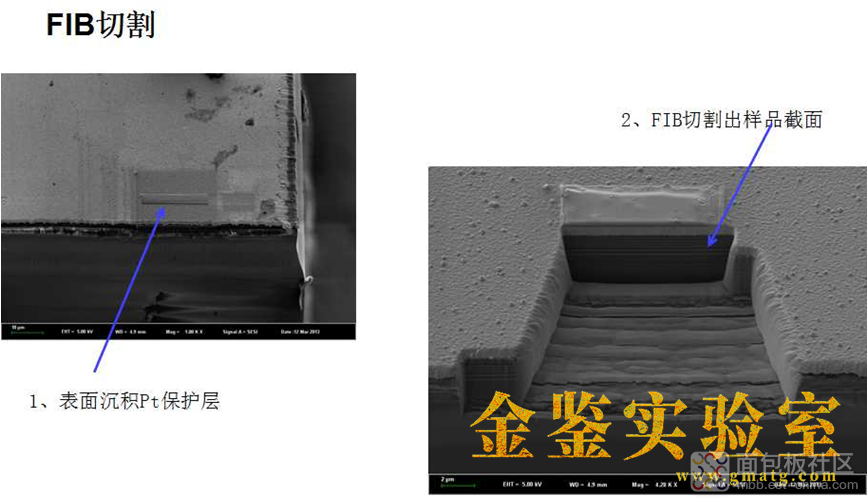
2.开槽范围
截面取样的挖坑过程相对简单,耗时较短,且容易判断三边是否已彻底切开。这是因为截面样品的尺寸较小,加工区域相对集中,离子束可以快速地将样品切割成所需的形状。在挖坑过程中,需要根据样品的尺寸和形状,精确地控制离子束的扫描路径和扫描时间,以确保样品的三边能够完全分离。同时,还需要注意避免对样品的其他部分造成损伤,以免影响后续的观察和分析。
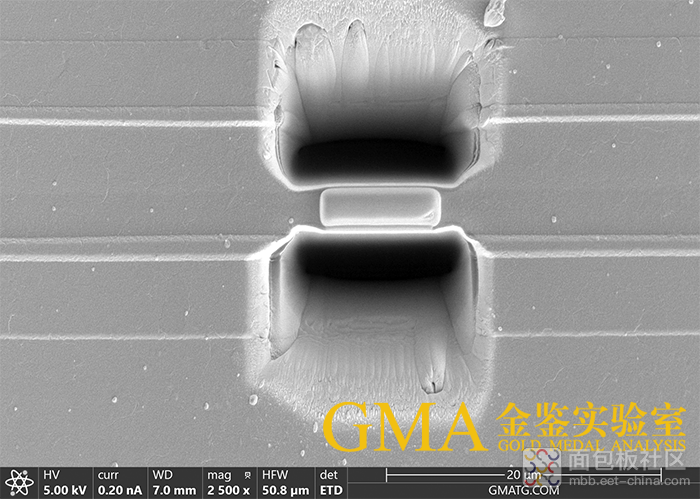
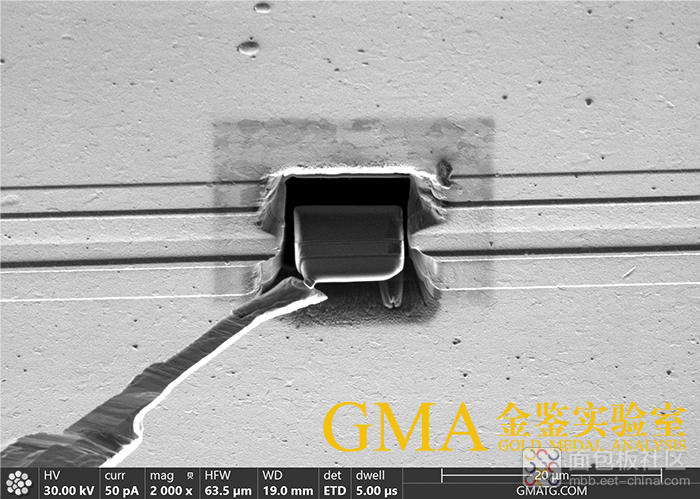
平面取样时,提取的块体体积较大,因此需要耗费更多时间,并且需要挖开更大的空间,以使取样和材料彻底切断分离。由于平面样品的加工区域较大,离子束需要在更大的范围内进行扫描,这增加了加工的难度和时间。
在挖坑过程中,需要特别注意离子束的扫描路径和扫描时间的控制,以确保样品能够完全分离,同时避免对样品表面造成不必要的损伤。此外,还需要根据样品的材料性质和加工要求,选择合适的离子束能量和束流密度,以提高加工效率和质量。
3.减薄过程
在减薄过程中,截面TEM样品和平面TEM样品也有显著的差异。对于截面TEM样品,使用沉积气体将样品焊接到载网之后,即可开始进行减薄。减薄过程主要是通过离子束的轰击,将样品的厚度逐渐减薄到TEM所需的纳米级别。在减薄过程中,金鉴实验室技术人员会特别注意样品表面的处理,以确保能够获得高质量的TEM图像和衍射信息。
在减薄过程中,需要精确地控制离子束的能量、束流密度以及扫描路径,以确保样品的厚度均匀且表面平整。同时,还需要注意避免对样品造成损伤或污染,以免影响后续的观察和分析。
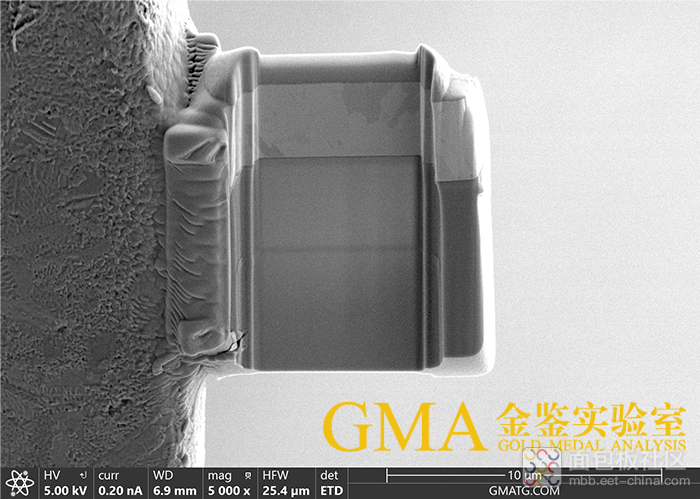
对于平面TEM样品,减薄过程则更为复杂。当平面样品焊接到载网后,还需要进行多个额外的步骤才能开始减薄。
总结
双束聚焦离子束-扫描电镜(FIB)在TEM样品制备中具有重要的应用价值。截面TEM样品和平面TEM样品虽然在观察面的方向上有所不同,但它们的制样过程都具有一定的复杂性和技术要求。
通过合理选择保护层范围、开槽范围以及优化减薄过程,可以有效地提高样品的质量和制备效率。在实际应用中,研究人员需要根据具体的材料性质和研究需求,选择合适的样品类型和制备方法,以获得准确可靠的实验结果。






 /3
/3 
