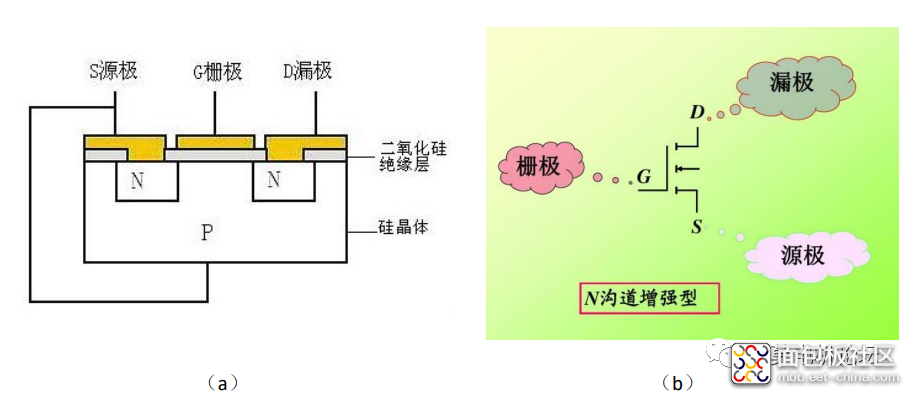
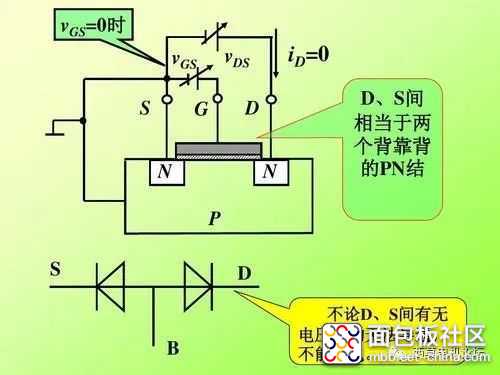
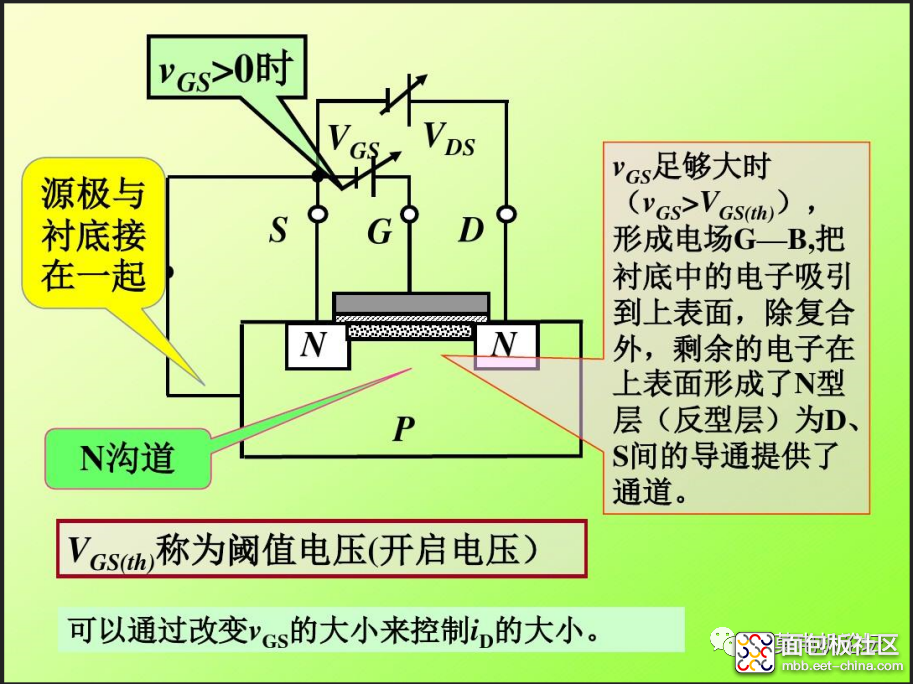
uGS对漏极电流的控制关系可用转移特性曲线描述,转移特性曲线如下图b所示,转移特性曲线的斜率的大小反映了栅源电压对漏极电流的控制作用。

上图a称为输出特性曲线,曲线中在uGS=2V的曲线下方可以成为截止区,该区域的情况是uGS还没有到达导电沟道导通电压,整个MOS管还没有开始导电。
可变电阻区又称为放大区,在uDS一定的的情况下iD的大小直接受到uGS的控制,且基本为线性关系。注意三极管中的放大区和MOS管的放大区有很大区别,不能觉得是相似的。
恒流区又称为饱和区,此时iD大小只受到uGS的控制,uDS变化过程中iD的大小不变。
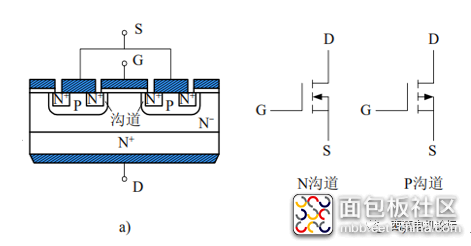

下面将以某品牌的低压MOSFET为例,对MOSFET的数据参数进行详细介绍

ID:最大漏源电流。是指场效应管正常工作时,漏源间所允许通过的最大电流。MOSFET的工作电流不应超过ID。此参数会随结温度的上升而有所减小。该参数为结与管壳之间额定热阻RthJC和管壳温度的函数。


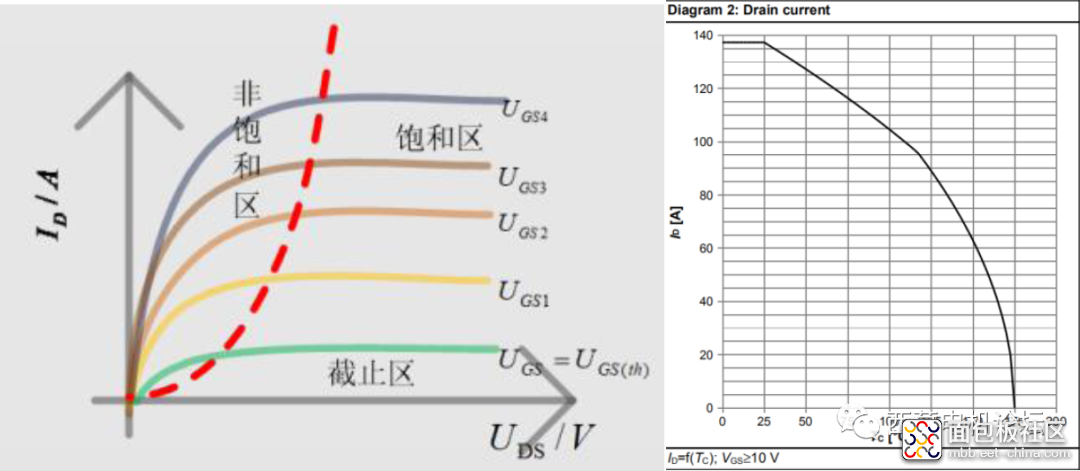
反映了器件可以处理的脉冲电流的高低 ,此参数会随结温度的上升而有所减小。定义ID,pulse的目的在于:在非饱和区,对于一定的栅-源电压,MOSFET导通后,存在最大的漏极电流。如下图所示,对于给定的一个栅-源电压,如果工作点位于非饱和区域内,漏极电流的增大会提高漏-源电压,由此增大导通损耗。长时间工作在大功率之下,将导致器件失效。因此,在典型栅极驱动电压下,需要将额定ID,pulse设定在区域之下。区域的分界点在uGS和曲线(图中红色)相交点。
规格书中会定义最大持续漏极电流和最大脉冲电流。一般规格书中最大脉冲电流会定义在最大持续电流的4倍,并且随着脉冲宽度的增加,最大脉冲电流会随之减少,主要原因就是MOSFET的温度特性。从上图(b)可以看出,最大持续漏极电流除了受到封装的限制,还与温度关系密切。需要指出得是上面提到的最大持续漏极电流ID中并不包含开关损耗,并且实际使用时表面温度也很难保持在25℃,因此,实际应用中最大的开关电流通常小于ID额定值(25℃下的值)的一半,通常在1/3~1/4。
EAS:单脉冲雪崩击穿能量:如果电压过冲值(通常由于漏电流和杂散电感造成)未超过击穿电压,则器件不会发生雪崩击穿,因此也就不需要消散雪崩击穿的能力。雪崩击穿能量标定了器件可以容忍的瞬时过冲电压的安全值,其依赖于雪崩击穿需要消散的能量。定义额定雪崩击穿能量的器件通常也会定义额定EAS。EAS标定了器件可以安全吸收反向雪崩击穿能量的高低。

EAR:重复雪崩能量。在很多MOSFET规格书上,还会注明EAR。重复雪崩能量已经成为“工业标准”,但是在没有设定频率,其它损耗以及冷却量的情况下,该参数没有任何意义。散热(冷却)状况经常制约着重复雪崩能量。对于雪崩击穿所产生的能量高低也很难预测。额定EAR的真实意义在于标定了器件所能承受的反复雪崩击穿能量。该定义的前提条件是:不对频率做任何限制,从而器件不会过热,这对于任何可能发生雪崩击穿的器件都是现实的。
VGS:最大栅源电压。是指栅源间反向电流开始急剧增加时的VGS值

Ptot:最大耗散功率(又写做PD)。在保证MOSFET性能不变坏时所允许的最大漏源耗散功率。使用时,场效应管实际功耗应小于Ptot并留有一定余量。此参数一般会随结温度的上升而有所减小。

RthJC:结到管壳的热阻。热阻是从芯片的表面到器件外部之间的电阻,功率损失的结果是使器件自身产生热量,热阻就是要将芯片产生的热量和功耗联系起来。注意ATP的热阻测试显示管壳的塑料部分与金属部分的温度相同。最大的RthJC值留有一定的裕度以应对生产工艺的变化。由于制作工艺的提高,工业上趋向于减小最大RthJC和典型值之间的裕度。通常情况下这个裕度的值不会公布。
ZthJC结到管壳瞬态热阻抗。瞬态热阻抗主要考虑的是器件的热容,所以它可以用做评估由于瞬态功率损失所产生的当前的温度。
RthJA:归算到环境温度的功率损耗热阻。
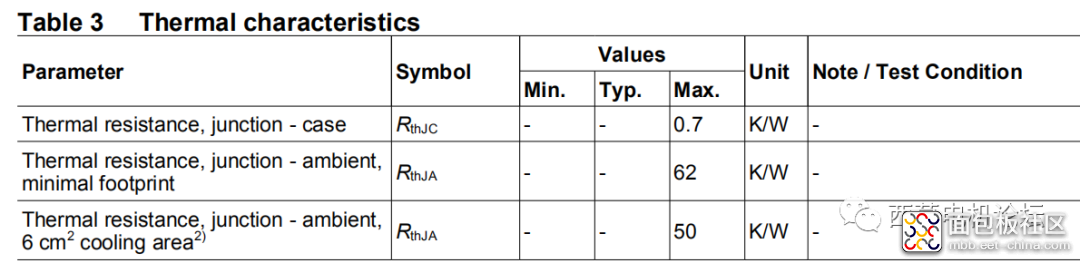
MOSFET的功率损耗主要受限于MOSFET的结温,基本原则就是任何情况下,结温不能超过规格书里定义的最高温度。而结温是由环境温度和MOSFET自身的功耗决定的。下图是典型的功率损耗与MOSFET表面结温的曲线图。
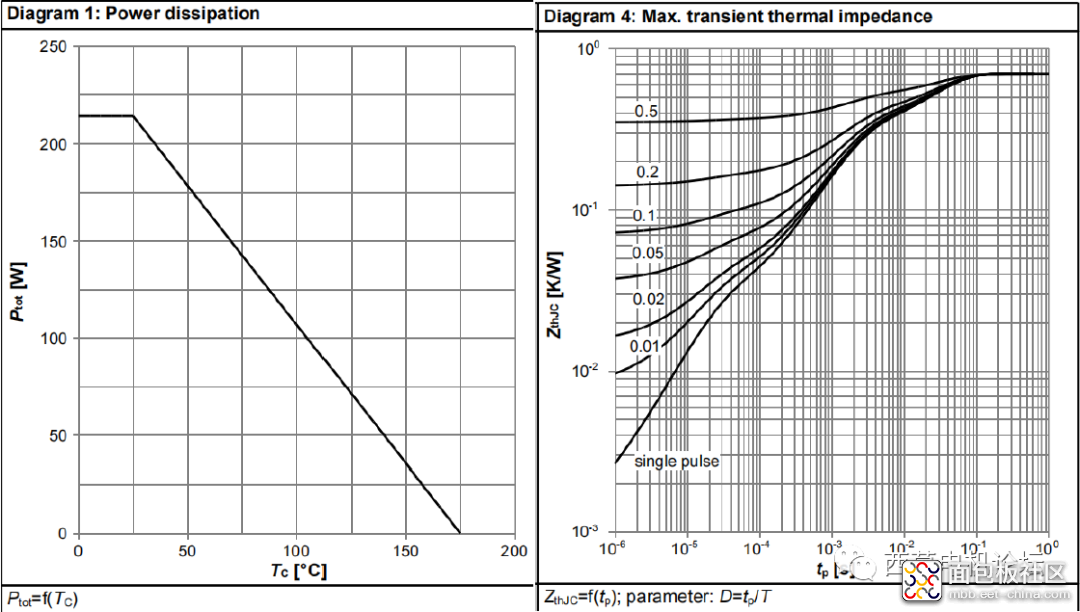
一般MOSFET的规格书里面会定义两个功率损耗参数,一个是归算到芯片表面的功率损耗RthJC,另一个是归算到环境温度的功率损耗RthJA。
重点强调一点,与功耗温度曲线密切相关的重要参数热阻,是材料和尺寸或者表面积的函数。随着结温的升高,允许的功耗会随之降低。根据最大结温和热阻,可以推算出MOSFET可以允许的最大功耗。归算到环境温度的热阻是布板,散热片和散热面积的函数,如果散热条件良好,可以极大提升MOSFET的功耗水平。特别指出,如果采用热阻RthJA的话可以估算出特定温度下的ID,这个值更有现实意义。
Tj:最大工作结温。通常为150℃或175℃,器件设计的工作条件下须确应避免超过这个温度,并留有一定裕量。
Tstg:存储温度范围。



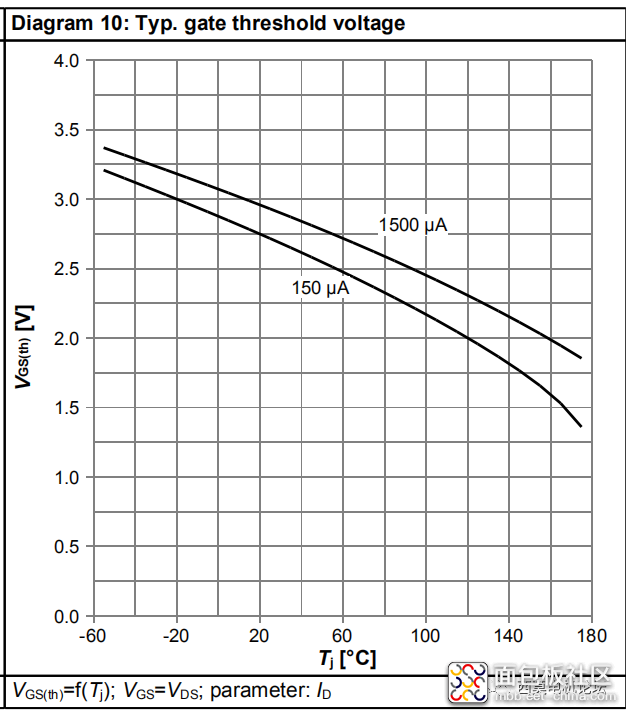

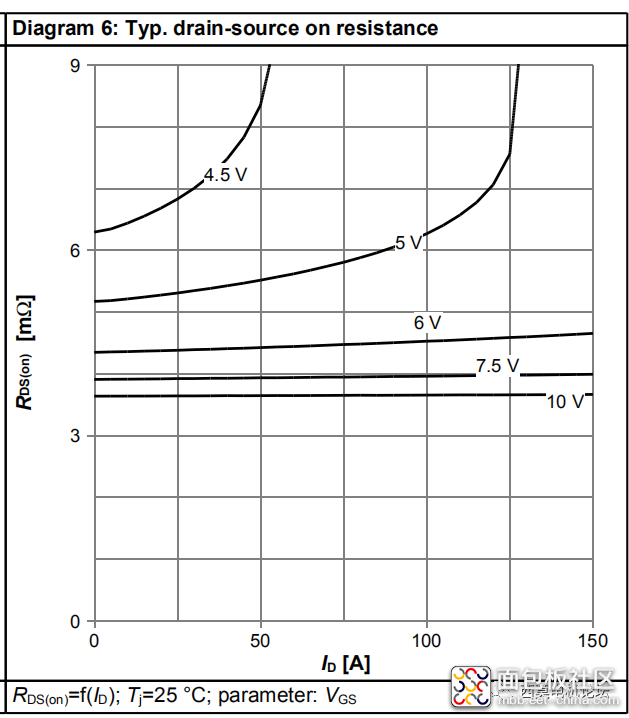




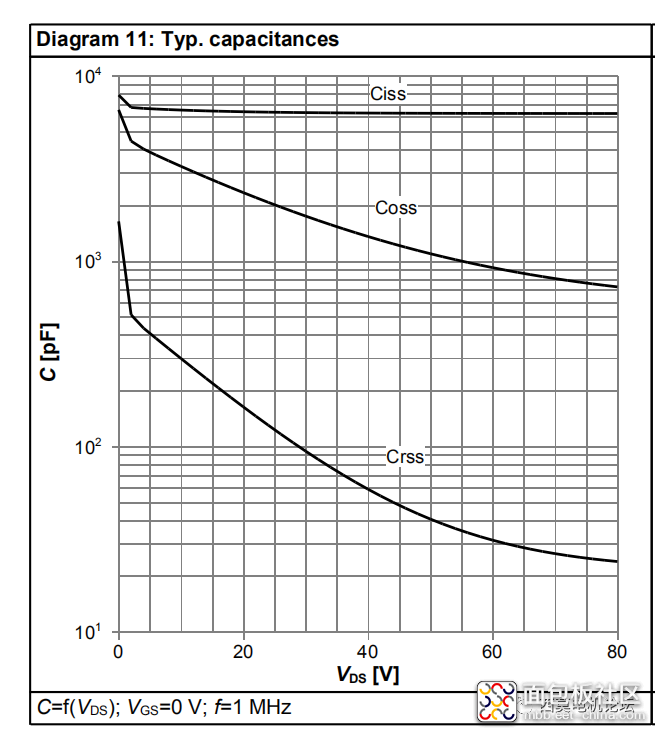

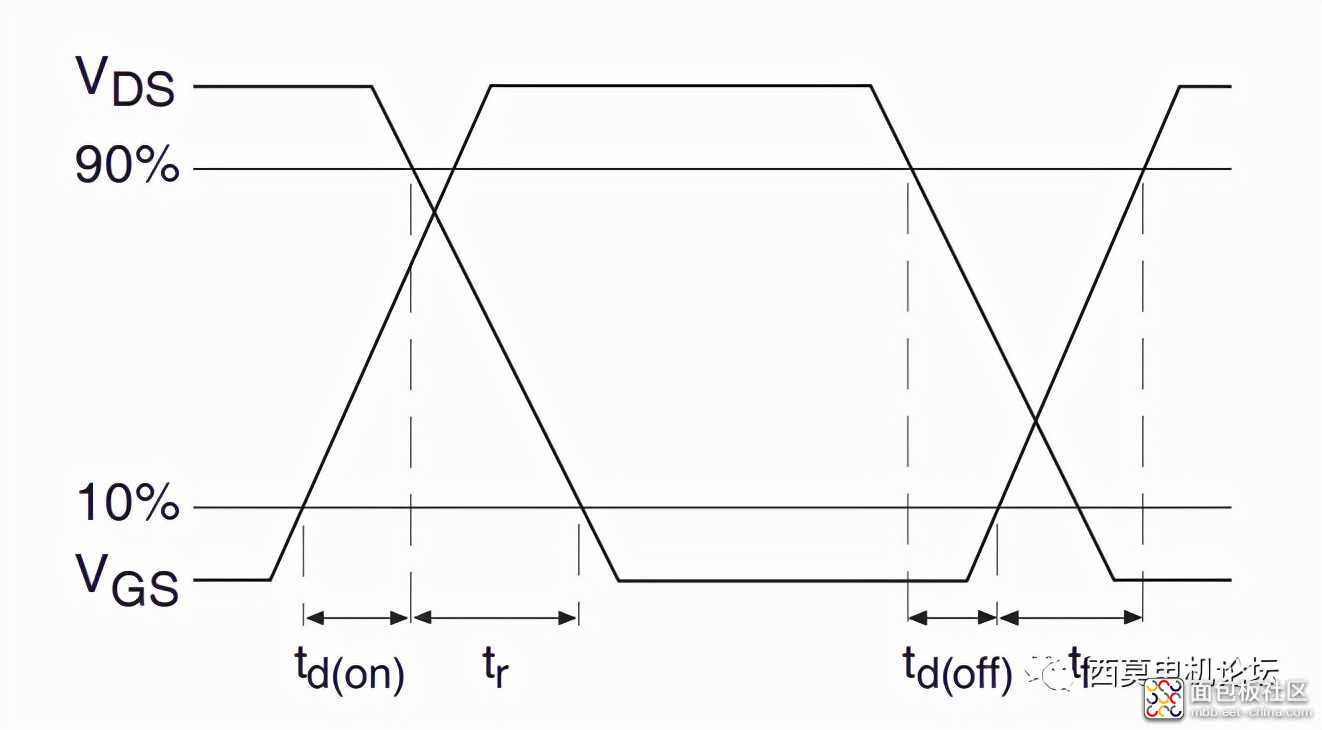

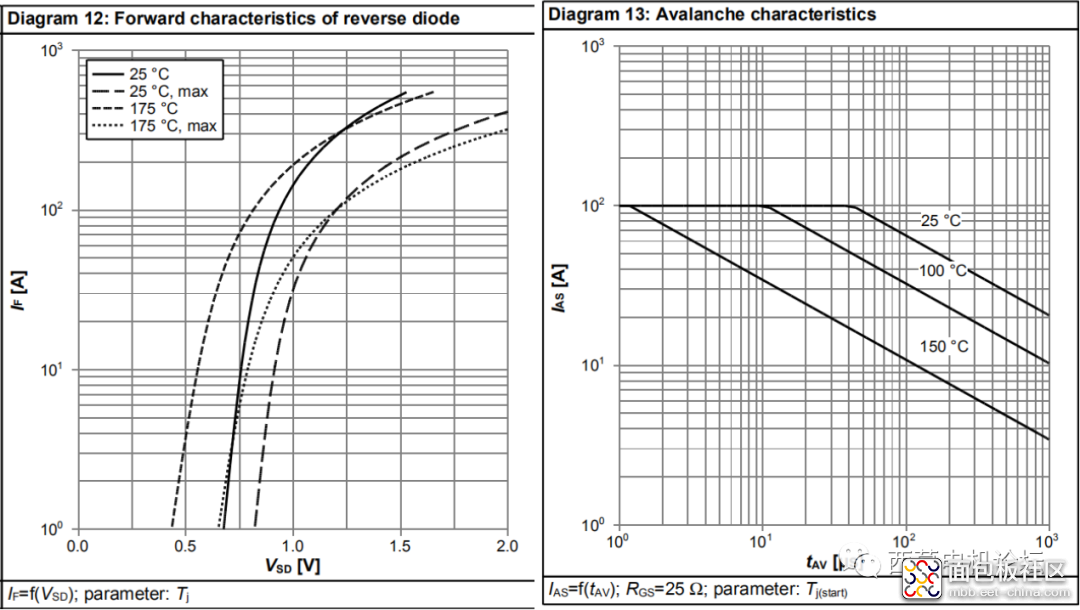
功率MOS在使用过程中是否能够安全持续的工作,是设计者必须要考虑的问题,设计者在应用MOS时,必须考虑MOS的SOA区间。SOA是由几个限制条件组成的一个漏源极电压uDS和漏极电流iD的关系图,MOSFET正常工作时的电压和电流都不应该超过该限定范围。MOSFET的安全工作区SOA曲线综合了MOSFET的耐压、耐电流、功率损耗及封装特性等限制。定义了最大的漏源极电压值、漏极电流值,以保证器件在正向偏置时安全的工作。
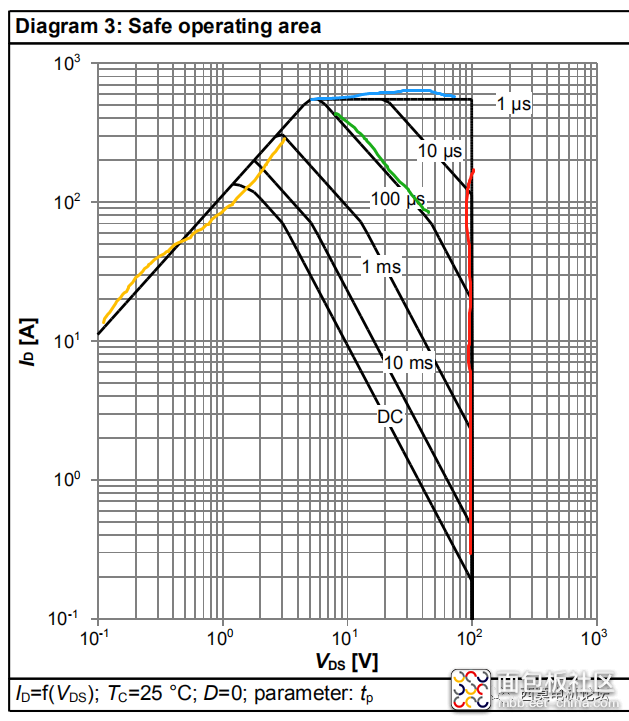
a黄色:当漏-源之间电压电压uDS比较小时,iD通过的电流大小主要由MOSFET的RDS(on)来进行限制。在该区域内,当uDS电压与环境温度条件不变时时,我们近似把RDS(on)看成一个常数,满足欧姆定律,由此得出

所以上面黄色部分线近似为一条直线。
b绿色:当uDS升高到一定的值以后,MOSFET的SOA主要由MOS的耗散功率来进行限制,而图中DC曲线则表示当流过电流为连续的直流电流时,MOSFET可以耐受的电流能力。其它标示着时间的曲线则表示MOSFET可以耐受的单个脉冲电流(宽度为标示时间)的能力。单次脉冲是指单个非重复(单个周期)脉冲,单脉冲测试的是管子瞬间耐受耗散功率(雪崩能量)的能力,从这部分曲线来看,时间越短,可以承受的瞬间耗散功率就越大。在上面最大参数耗散损耗中我们已经给出了相对应的计算公式。
c蓝色:MOSFET最大单次脉冲电流ID,pulse限制线,如本例就是548A。
d红色:MOS管所能承受的uDS最大电压,也就是上面参数中的V(BR)DSS,如果uDS电压过高,PN结会发生反偏雪崩击穿,造成MOS管损坏。
需要特别注意的是,在实际的应用中,必须确保MOS管工作在SOA区域以内,超出限制区域会造成电子元器件的损坏。而且上图中的SOA安全区域是在一定的特定条件下测得的,实际应用的时候随着环境温度的变化,SOA曲线也会随之变化。所以为了保证MOSFET工作在绝对的SOA之内,一般使用MOSFET的时候,需要对SOA区域进行降额使用。
下面详细分析MOSFET开通关断过程,以及米勒平台的形成。对于MOSFET,米勒效应(Miller Effect)指其输入输出之间的分布电容(栅漏电容)在反相放大作用下,使得等效输入电容值放大的效应。由于米勒效应,MOSFET栅极驱动过程中,会形成平台电压,引起开关时间变长,开关损耗增加,给MOS管的正常工作带来非常不利的影响。
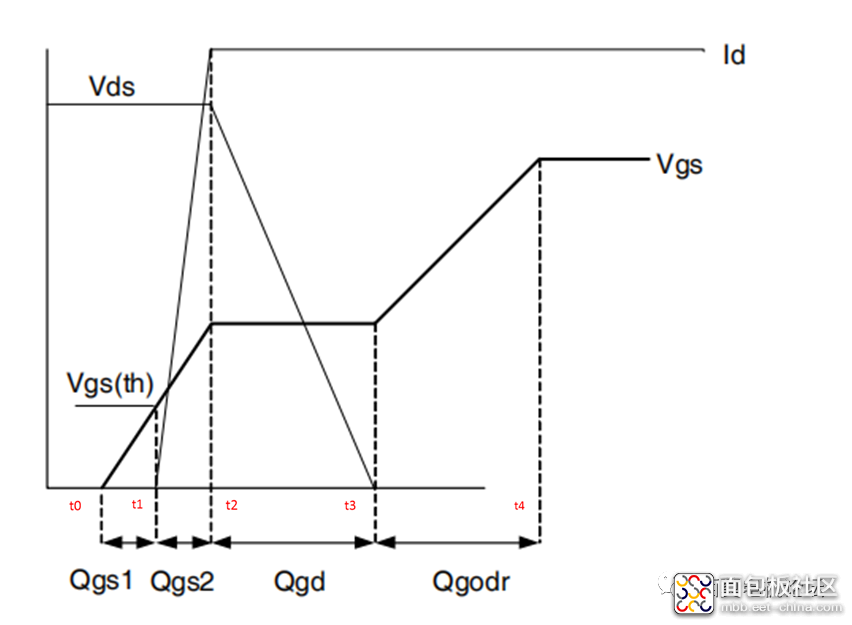
下面以上图为例,对MOSFET开通过程进行分析。
在t0到t1时刻,从t0时刻开始,uGS开始上升的时候,驱动电流Ig为CGS充电,uDS上升,这个过程中,uDS保持不变,ID为零。一直到t1时刻,uGS上升到uGS(th),也就是门极开启电压时候。在t1时刻以前,MOS处于截止区。
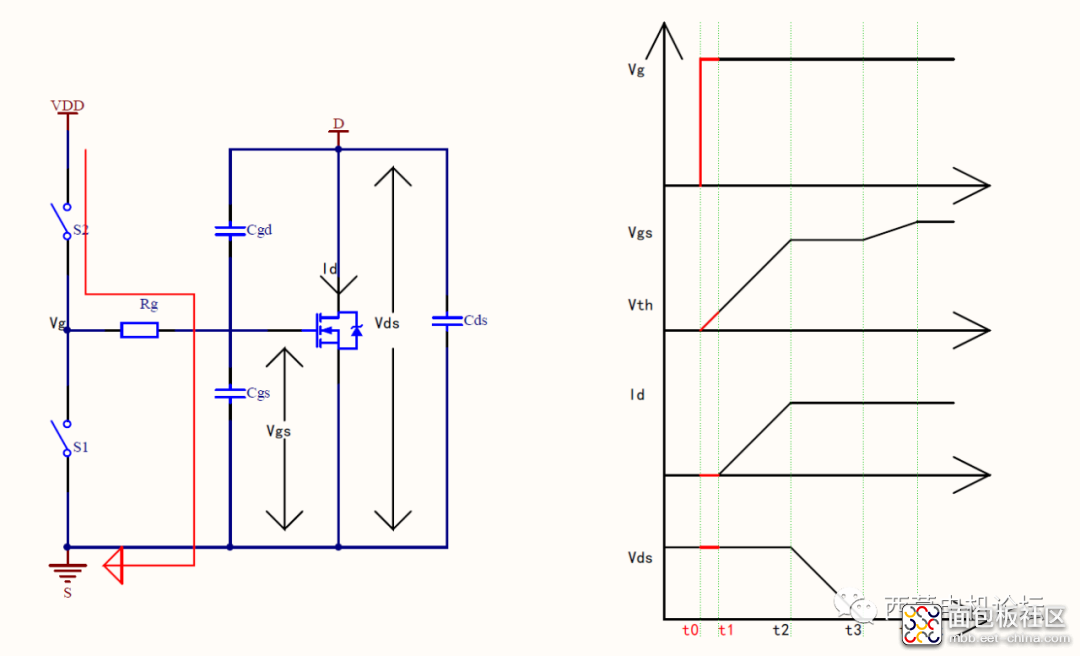
从t1时刻开始,MOS管因为uGS超过其阈值电压而开始导通。MOSFET的漏极电流ID慢慢上升,负载电流流经续流体二极管的电流一部分换向流入MOSFET,但是它俩的和始终等于负载电流,在开关开通的这个过程中可以认为负载电流是没有变化的。这个时间段内驱动电流仍然是为CGS充电。到t2时刻,ID上升到和负载电流一样,换流结束。在负载电流上升的这个过程中uDS会稍微有一些下降,这是因为下降的di/dt在杂散电感上面形成一些压降,所以侧到的uDS会有一些下降。从t1时刻开始,MOS进入了饱和区。在进入米勒平台前,漏源电压由于被二极管钳位保持不变,MOS管的导电沟道处于夹断状态。
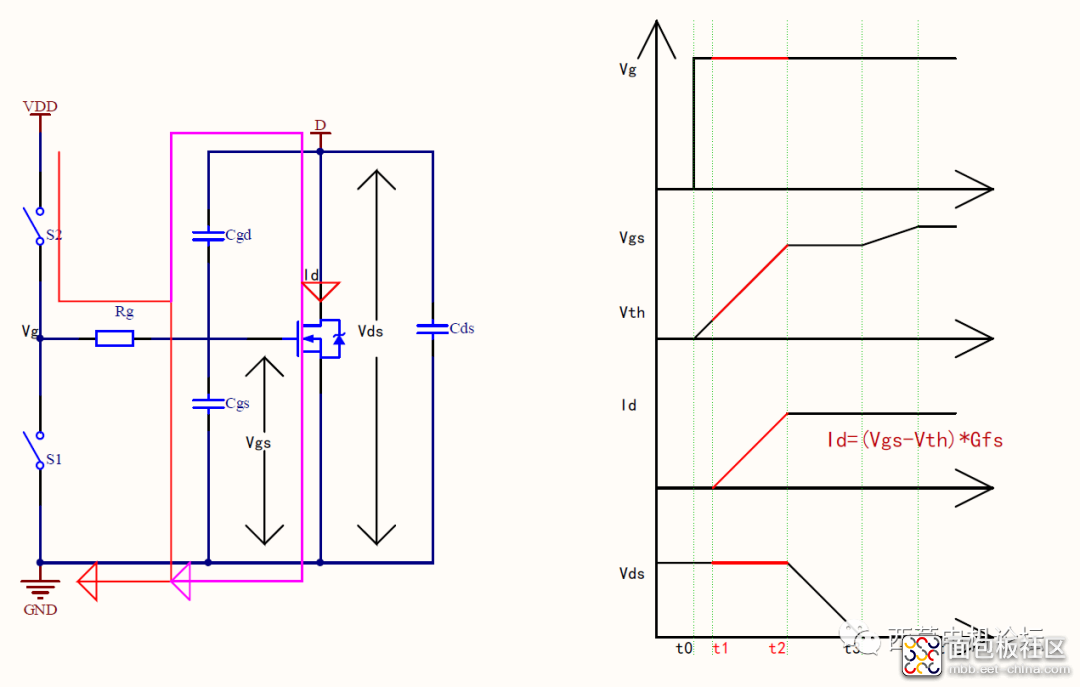
从t2时刻开始,由于MOSFET中的电流已经上升达到负载中的电流,MOSFET的漏极不再被钳位。这也就意味着,导电沟道由于被VDD钳位而导致的夹断状态被解除,导电沟道靠近漏极侧的沟道渐渐变宽,从而使沟道的导通电阻降低。在漏极电流ID不变的情况下,漏源电压uDS就开始下降。
uDS开始降低 ,栅极驱动电流开始给CGD充电。由于从t1时刻开始,MOS进入了饱和区,在饱和有转移特性:ID=uGS*Gfs。可以看出,只要ID不变uGS就不变。ID在上升到最大值以后,也就是MOSFET和体二极管换流结束后,ID就等于负载电流,而此时又处于饱和区,所以uGS就会维持不变,栅极电压uGS保持不变呈现出一段平台期就是维持米勒平台的电压,这个平台称为米勒平台。米勒平台一直维持到uDS电压降低到MOSFET进入线性区直到t3时刻。
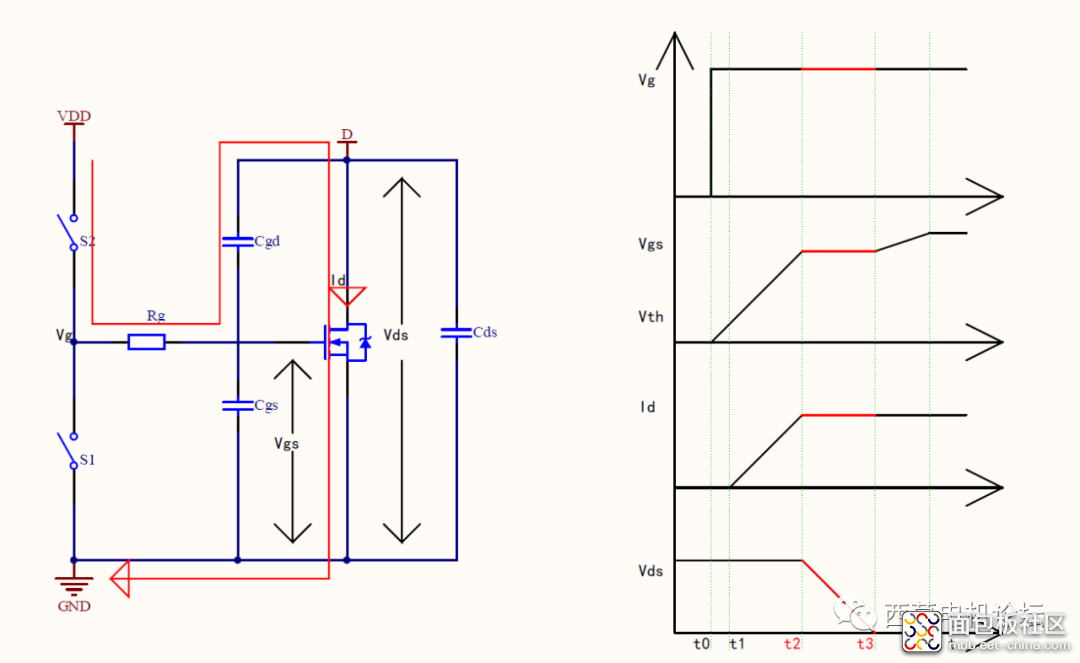
从t3时刻开始,MOSFET工作在线性电阻区。栅极驱动电流同时给CGS和CGD充电,栅极电压又开始继续上升。由于栅极电压增加,MOSFET的导电沟道也开始变宽,导通压降会进一步降低。当uGS增加到一定电压时,MOS管进入完全导通状态。
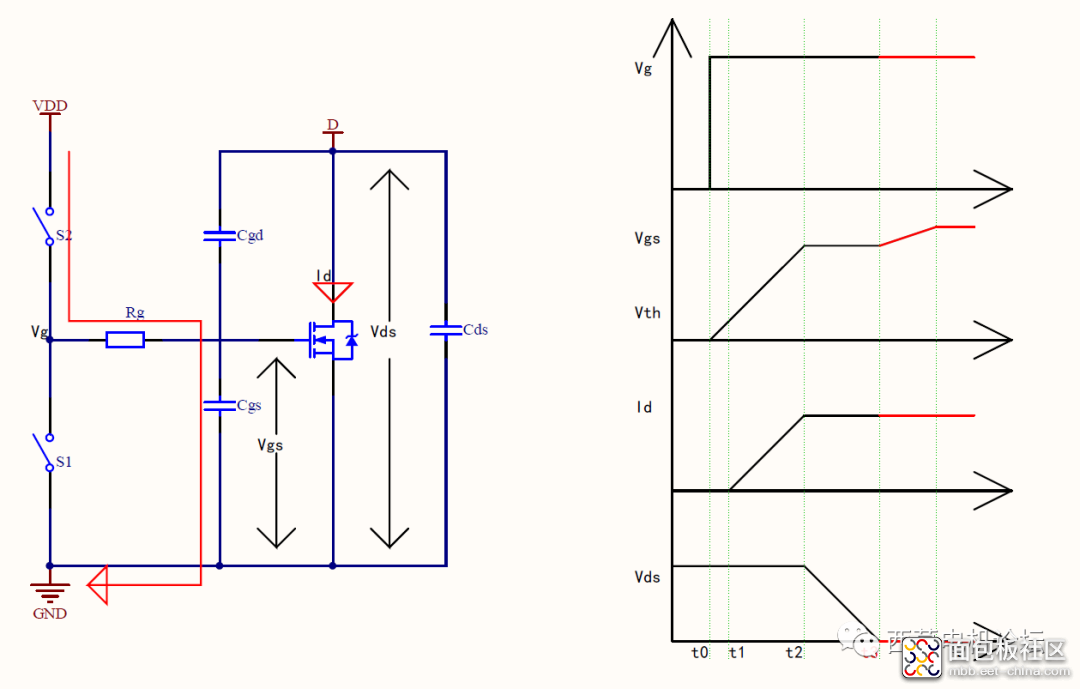

上图22标示了在开通时不同阶段对应在MOSFET输出曲线的位置。当uGS超过其阈值电压(t1)后,ID电流随着uGS的增加而上升。当ID上升到和电感电流值时,进入米勒平台期(t2-t3)。这个时候uDS不再被钳位,MOSFET夹断区变小,直到MOSFET进入线性电阻区。进入线性电阻区(t3)后,uGS继续上升,导电沟道也随之变宽,MOSFET导通压降进一步降低。MOSFET完全导通(t4)。
转载自西莫电机论坛,仅供学习交流使用,如有侵权,请联系删除。







 /4
/4 

