HAST试验的背景与重要性
在电子产品的可靠性评估体系中,环境应力是引发故障的关键因素之一。据美国Hughes航空公司的统计数据显示,温湿度应力导致的电子产品故障占比高达60%,远超其他环境因素。传统的高温高湿试验(如85℃/85%RH)虽能模拟湿热环境,但测试周期过长,难以满足快速验证产品可靠性的需求。
在此背景下,非饱和蒸汽试验(HAST)应运而生,它通过增加试验箱内的压力,实现超过100℃的高温高湿条件,显著加速材料的吸湿速率和老化进程,为电子产品可靠性验证提供了新的解决方案。
试验的原理与优势
HAST试验的核心原理在于利用高温、高湿和高压的环境条件,加速湿气对产品的侵入,从而在短时间内暴露产品的潜在缺陷。与传统高温高湿试验相比,HAST试验箱内的水蒸气压力远高于样品内部的水蒸气分压,这使得水汽能够更快速地渗入样品,加速腐蚀和绝缘劣化过程。例如,在相同的测试条件下,传统的温湿度偏压试验可能需要1000小时,而HAST试验仅需96 - 100小时即可完成,大大缩短了测试时间。
此外,HAST试验还可以快速激发PCB和芯片的特定失效模式,如分层、开裂、短路、腐蚀及爆米花效应等。这些失效模式在实际使用中可能导致产品性能下降甚至完全失效,通过HAST试验能够在研发阶段提前发现并优化设计,避免这些问题在最终用户使用中出现,为企业节省了大量的时间和成本。
应用范围与标准
HAST试验凭借其独特的优势,广泛应用于电子、汽车、航天、光伏等多个行业,尤其适用于评估非密封封装(如塑料封装)器件在潮湿环境中的可靠性。它可以用于测试印刷线路板材料的吸湿率、半导体封装的抗湿能力,以及加速老化寿命试验,帮助企业在设计阶段快速暴露产品的缺陷和薄弱环节,从而缩短试验周期、降低成本。
HAST试验的执行标准包括IEC 60068 - 2 - 66、JESD22 - A110、JESD22 - A118等。这些标准为不同类型的电子产品和材料提供了详细的测试条件和方法。
例如,JESD22 - A110标准规定了130℃、85%RH、33.3psia(230kPa)的测试条件,测试时间通常为96小时。这些标准的制定确保了HAST试验的科学性和可重复性,使其成为行业内广泛认可的可靠性测试方法,为电子产品的可靠性评估提供了统一的规范和依据。

失效机理
在HAST试验中,湿气的侵入是导致产品失效的主要原因。湿气可以通过多种途径进入封装体,如IC芯片和引线框架吸收的水分、塑封料中的水分、以及塑封工作间的高湿度环境等。一旦湿气进入封装体内部,就会引发一系列失效机理:
电化学腐蚀:湿气中的水分和杂质离子会引发IC铝线的电化学腐蚀,导致铝线开路或迁移生长,影响电路的正常连接和信号传输。
聚合物材料的解聚:湿气的侵入会降低聚合物材料的结合能力,导致材料解聚、空洞形成、分层等问题,破坏封装体的完整性和密封性。
爆米花效应:封装体内的水分在高温下汽化,产生高压,导致封装体破裂,严重影响产品的外观和结构完整性。
离子迁移:在偏压条件下,湿气会引起离子迁移,导致引脚间短路,造成电路故障。这些失效机理不仅会影响产品的电气性能,还可能导致产品的机械结构损坏,最终影响产品的使用寿命,给用户带来潜在的安全隐患。
案例分析
客户委托送测LED灯珠,要求金鉴进行高压蒸煮实验,评估灯珠试验后是否存在剥离、胶裂异常。
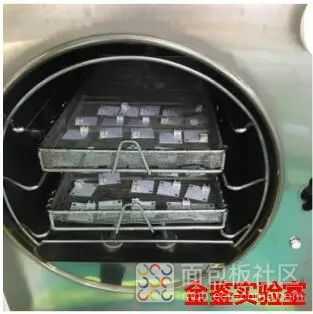
样品放入 PCT 试验箱内
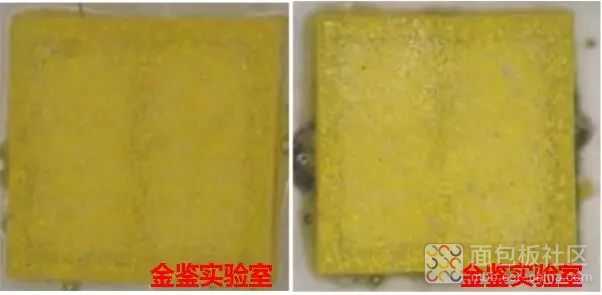
测试前 72小时高压蒸煮试验后
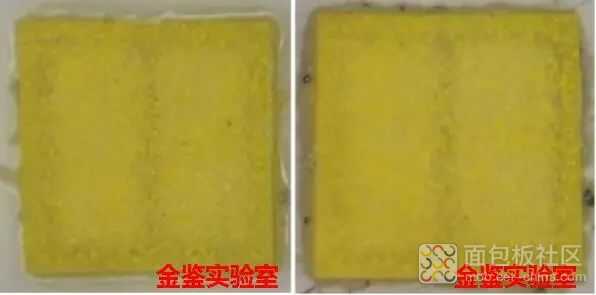
测试前 96小时高压蒸煮试验后
结语
HAST试验作为一种高效的加速老化测试方法,通过模拟极端的温湿度和压力条件,能够在短时间内评估电子产品在潮湿环境中的可靠性。它不仅能够快速激发产品的潜在失效模式,还能帮助企业优化产品设计、缩短研发周期、降低成本。






 /3
/3 
