聚焦离子束技术
聚焦离子束(Focused Ion Beam,简称 FIB)技术作为一种前沿的纳米级加工与分析手段,近年来在众多领域崭露头角。它巧妙地融合了离子束技术与扫描电子显微镜(SEM)技术的优势,凭借其独特的原理、广泛的应用场景以及显著的优势,成为现代科学研究与工业生产中不可或缺的重要工具。
聚焦离子束系统的核心
聚焦离子束系统的核心在于其独特的离子束生成与聚焦机制。该系统以镓离子源为基础,通过双透镜聚焦柱将镓离子束聚焦至极小尺寸,进而利用高能量的聚焦离子束轰击样品表面,实现对材料的精密去除、沉积以及高分辨率成像。
具体而言,镓元素首先被离子化为Ga+离子,随后在电场的作用下被加速,并借助静电透镜的聚焦作用,将高能量的Ga+离子精准地投射到样品的指定位置,从而完成对样品的加工处理。这种技术巧妙地将FIB处理样品的功能与SEM观察成像的功能相结合,实现了加工与观察的无缝衔接,为纳米尺度下的材料研究与制造提供了有力的技术支持。
FIB-SEM双束系统及其应用
聚焦离子束与扫描电子显微镜的双束系统(FIB-SEM)是聚焦离子束技术的重要应用形式之一。
该系统广泛应用于多种材料的分析与研究,包括光电材料、半导体材料、镀膜材料、金属材料、矿石、纳米材料、高分子材料、锂电材料、数据存储、生物材料以及通讯行业等众多领域。为了方便大家对材料进行深入的失效分析及研究具备Dual Beam FIB-SEM业务,包括透射电镜(TEM)样品制备,材料微观截面截取与观察、样品微观刻蚀与沉积以及材料三维成像及分析等。
FIB切片截面分析
FIB技术在截面分析方面具有显著优势,利用FIB技术能够精确地对器件的特定微区进行截面观测,并生成高分辨率的清晰图像。我们为客户提供的高精度截面分析服务,特别适用于微电子领域,能够有效帮助客户定点观测芯片的内部结构,分析光发射定位热点的截面结构缺陷等,确保材料的质量和性能。
FIB制备TEM样品过程
铂保护层沉积(Platinum deposition):采用电子束或离子束辅助沉积的方法,在待制备TEM试样的表面蒸镀一层铂保护覆层。这层保护覆层的作用在于防止最终的TEM试样在后续加工过程中受到Ga离子束的辐照损伤,从而确保样品的完整性和分析的准确性。
粗加工(Bulk-out):在待制备的TEM试样两侧,利用较大的离子束流快速挖取“V”型凹坑,为后续的薄片切割提供初步的形状基础。这一步骤的关键在于快速去除多余材料,同时尽量减少对目标区域的影响。
U型切割(U-cut):在粗加工的基础上,对TEM薄片的两端和底部进行切除,形成一个较为规则的薄片形状。这一步骤需要精确控制离子束的参数,以确保薄片的厚度和形状符合要求。
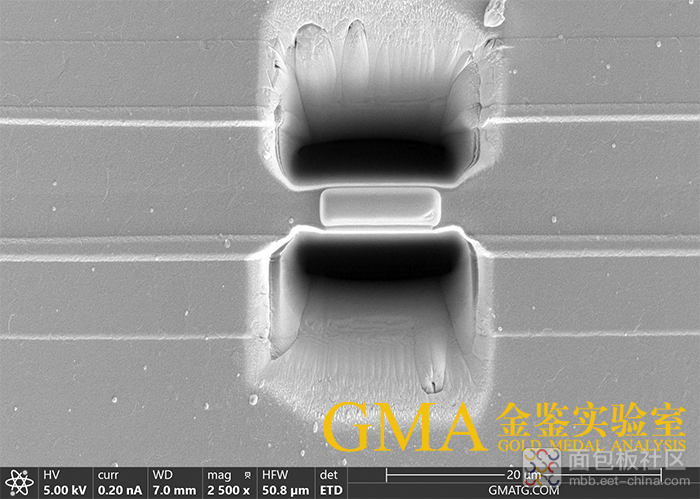
取出(Lift-out):使用显微操控针将TEM试样从块状基体中移出,并通过蒸镀铂的方式将试样与针粘结在一起。这一步骤需要极高的操作精度,以避免样品在转移过程中受损。
安装(Mount on Cu half-grid):将移出的TEM薄片转移到预先准备好的TEM支架上,并进行粘接固定。这一步骤需要确保薄片与支架之间的良好接触,以便于后续的分析工作。
最终减薄(Final milling):利用较小的离子束流对TEM薄片进行进一步减薄,直至其厚度达到约100纳米左右。这一步骤是制备TEM样品的关键环节,需要精确控制离子束的能量和束流大小,以确保薄片的厚度均匀且满足TEM分析的要求。
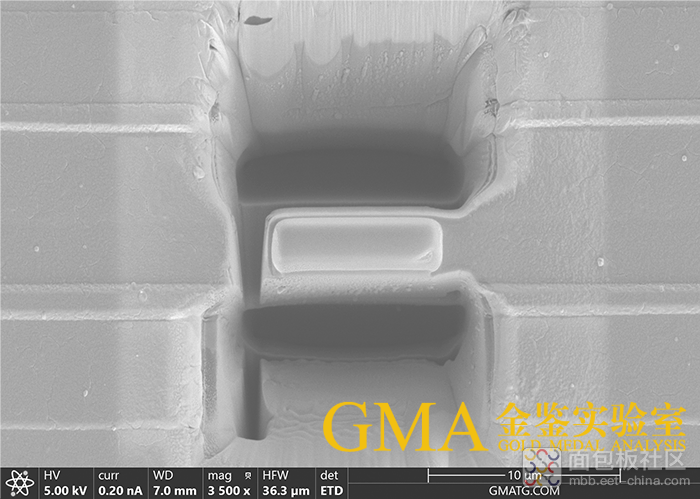
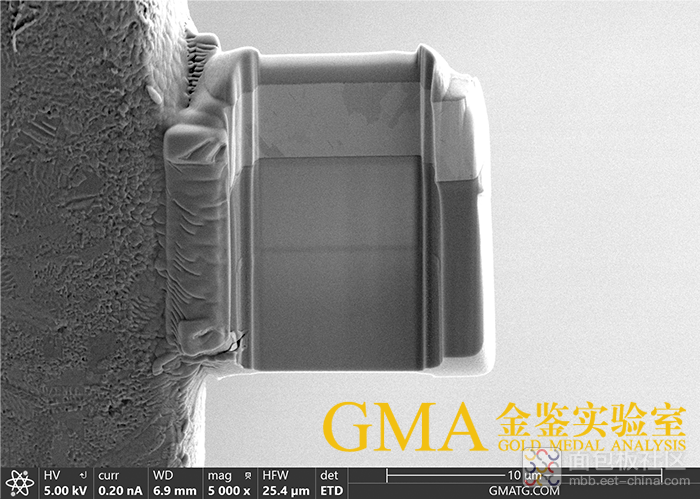
实用案例分享
1.切割支架镀层
利用FIB切割支架镀层,避免了传统切片模式导致的金属延展、碎屑填充、厚度偏差大的弊端,高分辨率的电镜下,镀层晶格形貌、内部缺陷一览无遗。
FIB-SEM扫描电镜下观察支架镀层截面形貌,镀层界限明显、结构及晶格形貌清晰,尺寸测量准确。此款支架在常规镀镍层上方镀铜,普通制样方法极其容易忽略此层结构,轻则造成判断失误,重则造成责任纠纷,经济损失!
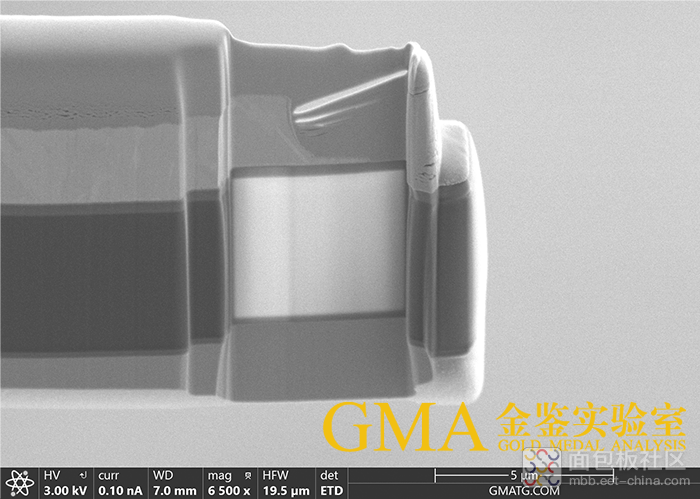
利用FIB-SEM扫描电镜下观察支架镀层截面形貌。此款支架在镀铜层下方镀有约30纳米的镍层,在FIB-SEM下依然清晰可测!内部结构、基材或镀层的晶格、镀层缺陷清晰明了,给客户和供应商解决争论焦点,减少复测次数与支出。
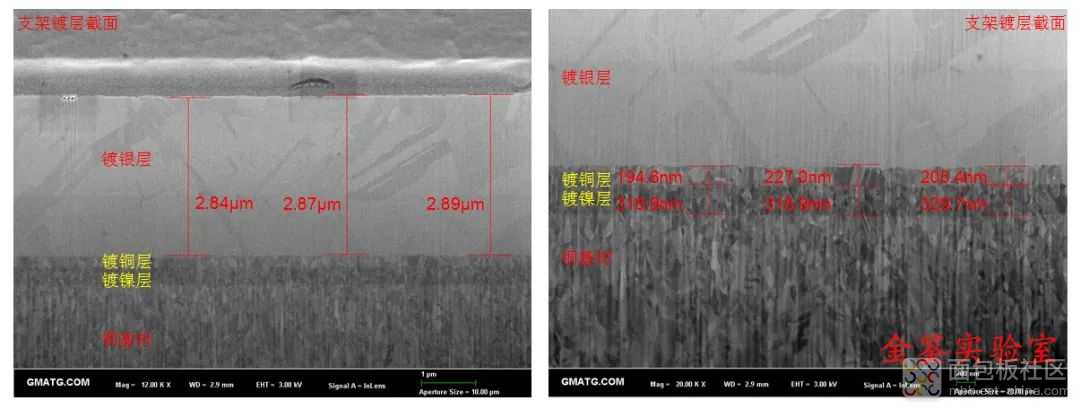
2.微米级缺陷样品FIB-SEM截面测试
对于微米级缺陷样品的分析,FIB-SEM技术同样能够发挥重要作用。通过对样品进行精确的截面切割和观察,可以清晰地展示缺陷的位置和形态,为缺陷的成因分析和改进措施的制定提供重要依据。
3.PCB电路断裂位置分析
在电子电路领域,FIB-SEM技术可用于分析PCB电路的断裂位置。通过FIB切割PCB电路的截面,并利用SEM观察铜箔的金相结构,可以精确地定位断裂位置,并分析断裂的原因。这种分析方法对于提高PCB电路的可靠性和性能具有重要意义。
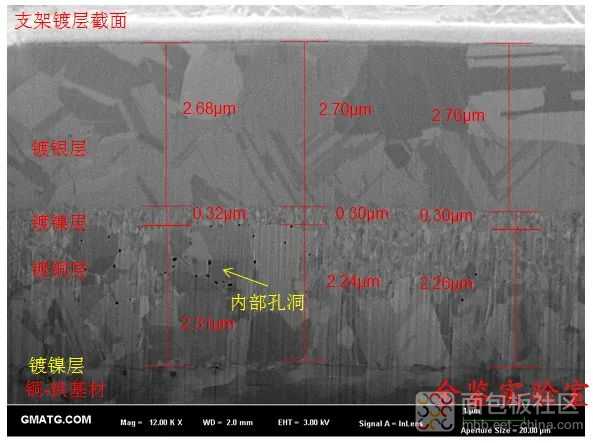
4.锡球截面分析
FIB技术还可用于切割锡球的截面,并对其进行分析。通过对锡球截面的观察,可以了解锡球的内部结构和成分分布,为锡球的质量控制和性能优化提供重要参考。
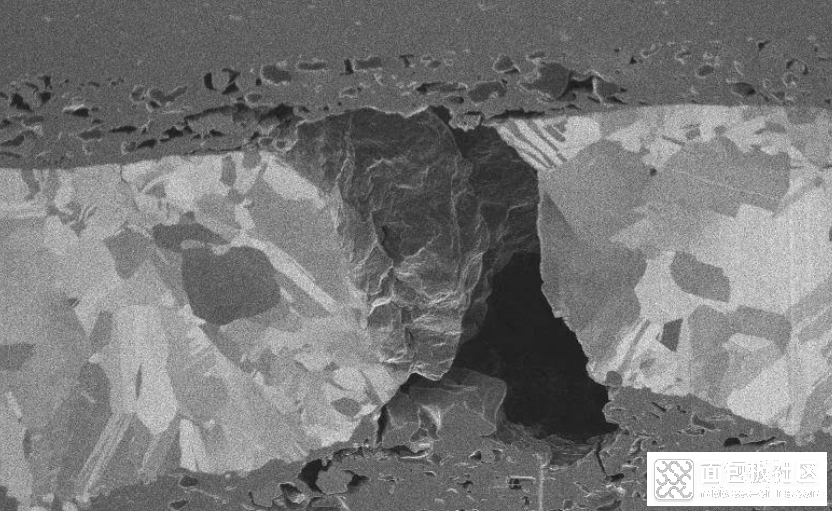
聚焦离子束技术凭借其在纳米加工与分析领域的独特优势,正在不断推动纳米科技的发展。






 /3
/3 
