技术原理与核心优势
聚焦离子束双束系统(FIB - SEM)是一种集成多种先进技术的高端设备,其核心构成包括聚焦离子束(FIB)模块、扫描电子显微镜(SEM)模块以及多轴样品台,这种独特的结构设计使得它能够实现加工与观测的一体化操作,极大地提高了工作效率和分析精度。
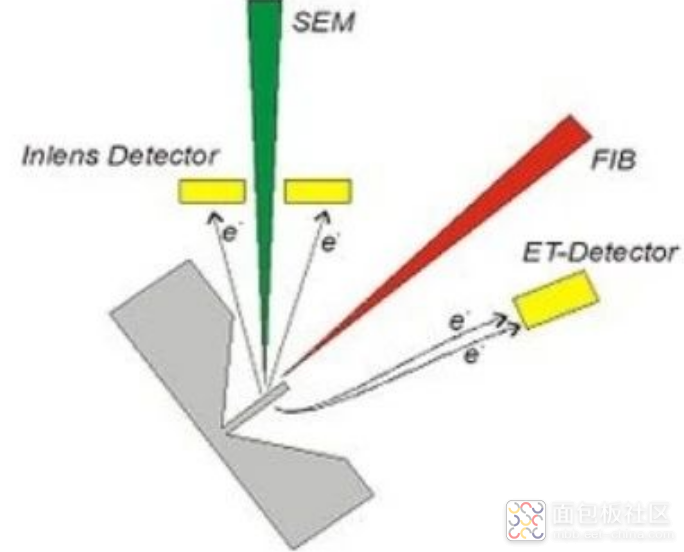
1.FIB 模块的关键作用
FIB 模块采用液态金属离子源(LMIS)产生镓离子束(Ga⁺),这种镓离子束具备极高的能量和精度,能够实现纳米级的刻蚀、沉积以及样品制备等一系列微加工操作。
在半导体芯片等微观领域的研究与制造过程中,这种纳米级的加工能力至关重要,它可以对材料的微观结构进行精准的改造和塑造,为后续的分析和应用奠定基础。
2.SEM 模块的实时监控功能
扫描电子显微镜(SEM)模块则通过二次电子成像技术,能够实时监控加工过程。它具有极高的定位精度,可达亚微米级,这意味着在进行微观加工时,操作人员可以精确地观察到加工部位的细节变化,从而及时调整加工参数,确保加工的准确性和质量。
3.双束协同的综合优势
FIB - SEM 双束系统最显著的优势在于双束能够同步工作。这种协同工作模式支持多种先进的分析和加工技术,例如三维重构、定点加工以及多模态分析等。
关键应用场景
FIB - SEM 双束系统在多个领域都有着关键的应用,尤其是在半导体芯片的研发与失效分析中,发挥着不可替代的作用。
1.高精度截面分析与三维成像
定点切割与清晰断面生成:
该系统能够对芯片内部的复杂结构,如晶体管栅极、金属互连层等进行定点切割,生成无应力损伤的清晰断面。这种高精度的截面分析对于研究芯片内部结构的完整性、材料的分布情况以及不同层次之间的连接关系等都有着极其重要的意义。
结合连续切片技术的三维重构:
通过与连续切片技术相结合,FIB - SEM 可以重构出芯片的三维电路结构。这种三维重构不仅能够更直观地展示芯片的内部布局,还能够辅助进行缺陷定位与设计验证。在芯片的研发过程中,及时发现并定位缺陷是提高产品质量和性能的关键环节,而三维重构技术能够从多个角度对芯片进行分析,更全面地发现潜在问题,从而为优化设计提供有力支持。
2.透射电镜(TEM)样品制备
超薄样品的制备:利用离子束逐层减薄的原理,FIB - SEM 可以制备出厚度小于 100 纳米的超薄样品。这种超薄样品能够保留原子级的晶格信息,为透射电镜(TEM)的高分辨率成像提供了理想的样品。
在微观材料研究中,TEM 是一种极其重要的分析手段,它能够观察到材料的原子结构和晶体缺陷等微观细节。而 FIB - SEM 制备的超薄样品能够满足 TEM 对样品厚度和质量的严格要求,使得 TEM 能够充分发挥其高分辨率的优势,为材料的微观结构研究提供更深入、更准确的信息。
先进制程中的精准分析:在 3 纳米以下的先进制程中,芯片的结构和性能对材料的微观特性要求极高。FIB - SEM 能够精准分析栅极氧化层缺陷与界面特性,这对于提高芯片的性能和可靠性至关重要。栅极氧化层是晶体管中的关键结构之一,其质量直接影响着晶体管的开关性能和稳定性。
通过 FIB - SEM 的精准分析,可以及时发现栅极氧化层中的缺陷,如厚度不均匀、杂质掺杂不均匀等,并对界面特性进行深入研究,从而为改进制程工艺、提高芯片质量提供有力的技术支持。
3.芯片线路修改
线路切断与修复:FIB - SEM 可以切断短路线路,同时也能沉积导电材料(如铂、钨)来修复断路。这种线路修改功能对于多项目晶圆(MPW)的迭代优化具有重要意义。
气体注入系统的辅助作用:气体注入系统(GIS)是 FIB - SEM 的一个重要组成部分,它能够实现局部区域的金属 / 绝缘层选择性沉积。这种选择性沉积技术可以根据需要在特定位置沉积不同材料,从而实现对芯片局部结构的精确改造。
与传统的沉积方法相比,GIS 的选择性沉积能够降低研发成本,因为它可以避免对整个芯片进行不必要的沉积操作,节省了材料和时间成本。同时,这种精确的沉积方式也能够提高芯片的性能和可靠性,为芯片的研发和制造提供了更加灵活、高效的手段。
结语
聚焦离子束双束系统 FIB - SEM 凭借其独特的技术原理和强大的功能优势,在半导体芯片研发与失效分析等领域展现出了巨大的应用潜力和价值。随着技术的不断发展和创新,FIB - SEM 系统将在更多的领域发挥重要作用,为微观材料研究和高端制造业的发展提供有力的技术支撑。






 /3
/3 
