光刻的原理:
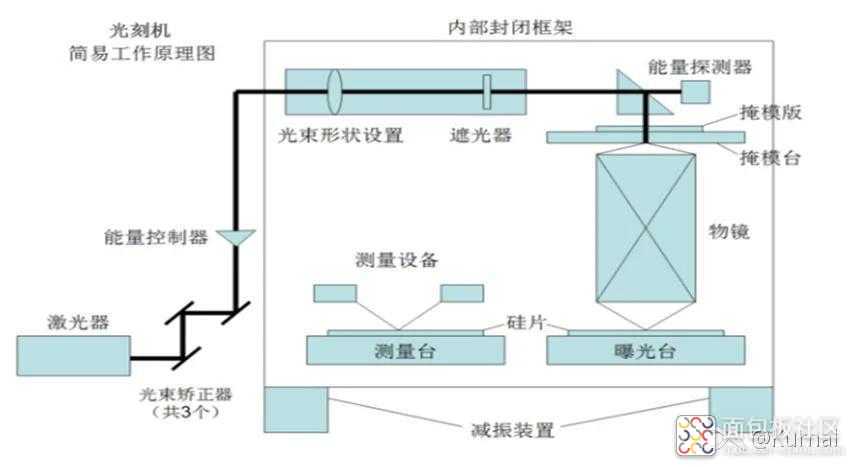
就是曝光,首先是利用光化学反应把实现制备好的mask上的图形转印到sub(一般为Si)的过程,基本分4种,接触式曝光,非接触式曝光,投影式曝光和步进式曝光。
接触式曝光是将mask与待加工基板的光胶直接接触进行的曝光,掩膜与基板紧密接触,mask与sub面积一样大,优点是成本低,分辨率高,mask与sub紧密接触,不容易产生衍射现象,缺点就是难分开,mask成本太高,l
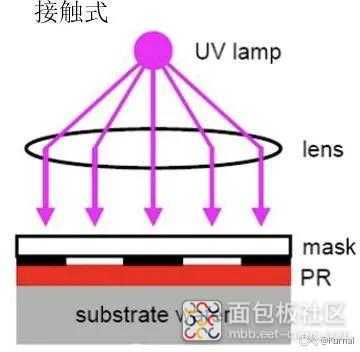
接近式曝光是非接触式曝光的一种,优点就是成本低廉,(因为一片mask可以用好久)缺点就是光的衍射现象

投影式曝光指的是mask与sub不直接接触,采用透镜成像的技术,更一步提高了mask与sub的距离,可以让mask不与sub比例为1;1,做出来的line可以更细
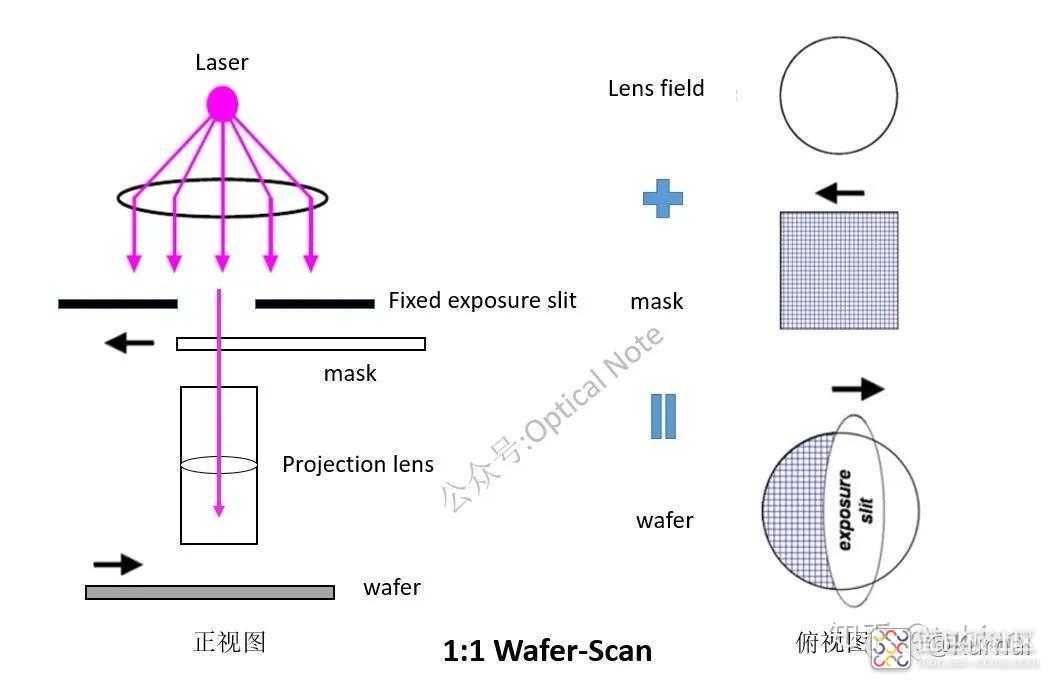
最新的就是步进式曝光
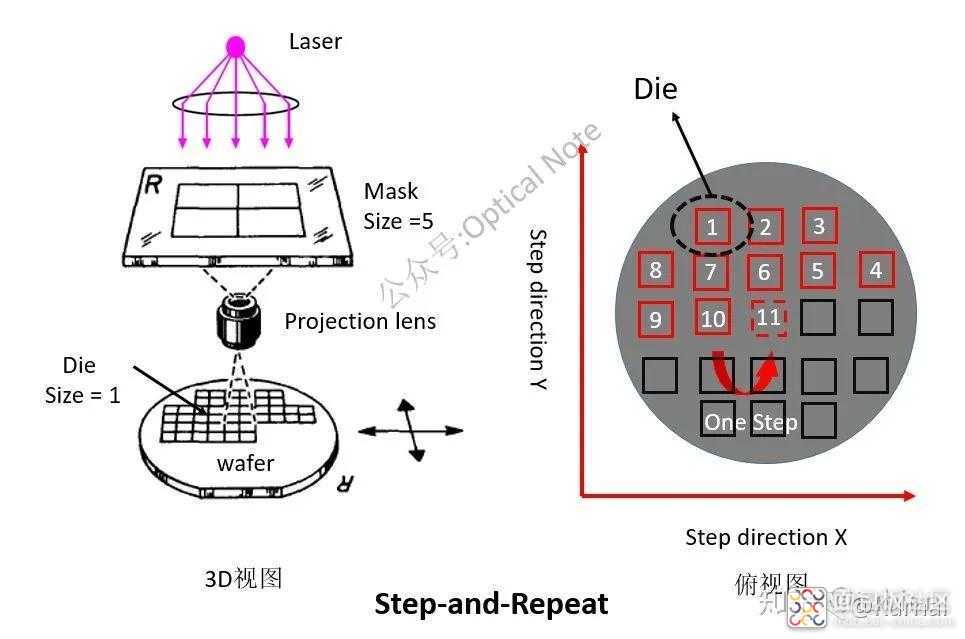
随着wafer的面积越来越大,如果仍然使用1:1比例的mask,就需要更大的NA,更大的透镜,其可以让在其透镜不变的情况下,把整片wafer分割为一些小die,一般为22mmx22mm,然后通过4;1-5:1的比例做一个die的mask,在第一个die被曝光后用步进器移动wafer让其在切分die里曝光
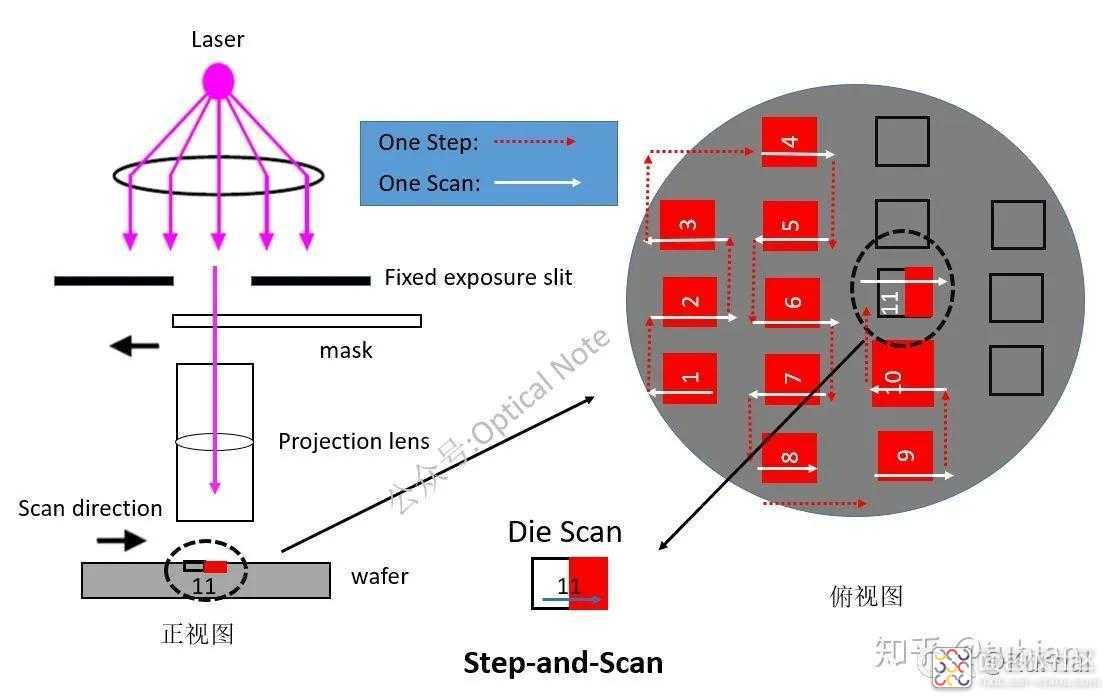
一个光刻机里面重要的几个东西,光源,镜头

为什么镜头很重要,衡量一个光刻机的指标,最重要的是分辨率(数学小知识课堂)
在投影式光刻机的曝光系统可以用koehler光学模型来描述,光源位于会聚透镜的焦平面上,通过会聚透镜后,光线照在mask上,产生衍射光束。投影透镜组的大小决定了有多少的衍射光被收集并聚焦到晶圆表面,较大的镜头将会有更大的分辨率

mask上相邻的A/B点,在wafer上形成的A1/B1那么A/B间距最小为多少,A1B1才能被清洗掉分辨出来?这就是瑞利公式,即:Resolution=(1.22λf)/d=k1( λ/NA)
d是光瞳的孔径,f是透镜的焦距,K1是一个常数,λ是光源的波长,NA是投影透镜的数值孔径定义为nsinθ,对于193nm的浸入式光刻机,n为1.44(因为水在193波中折射),其他取1.0

为了更细,可以改变光源或者数值孔径NA(由公式得)

目前光源一共迭代了4代,早期的G线435nm,再到i射线,波长365nm,然后是深紫外光DUV,Krf为248nm,ArF为193nm,最先进的极紫外光(euv)则为13.5nm,这也是为什么要选择euv的原因

然后就是刻蚀(Etch),与光刻相对应
先通过光刻将光刻胶进行光刻曝光处理,然后把硅片上已经显影的光刻胶给进行一个去除或把不显影的光刻胶进行一个去除(凹版凸版罢)
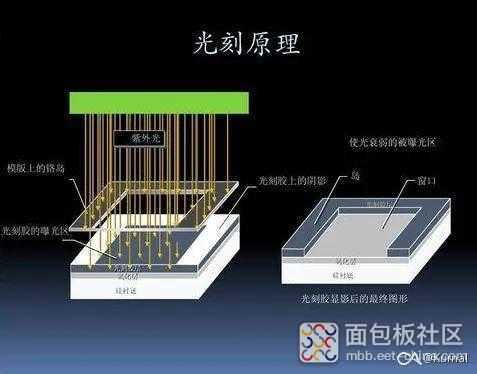
基本分两类,干法刻蚀与湿法刻蚀(说实在的不是这行的人,不是专业的,找了点资料)
湿法刻蚀是一种将刻蚀材料浸泡在腐蚀液内进腐蚀的技术,一般为酸/碱合剂一般只是用在尺寸较大的情况下(大于3微米)。在整个fab流程中,湿法腐蚀一般用来腐蚀硅片上某些层或用来去除干法刻蚀后的残留物。通过化学反应腐蚀掉硅片背面及四周的PN结,以达到正面和背面绝缘的目的,缺点是污染环境,其产生废液量很多
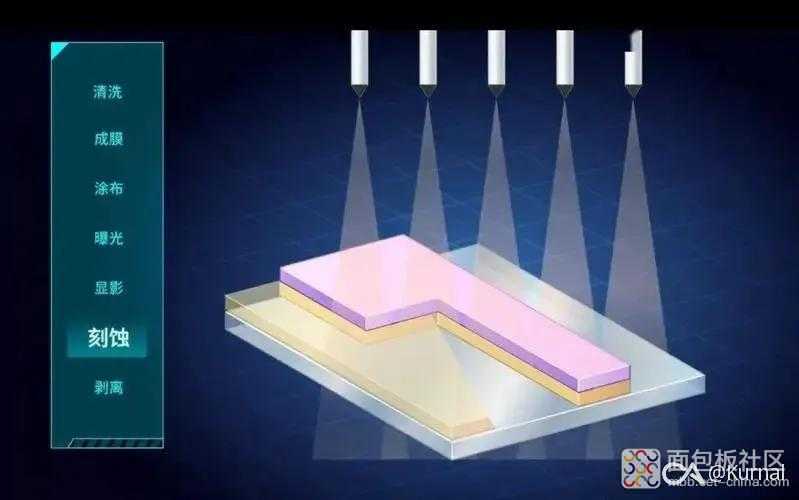
干法刻蚀是把硅片表面曝露于气态中产生的等离子体中,等离子体通过光刻胶中开出的窗口,与硅片发生物理/化学反应,从而去掉曝露的表面材料
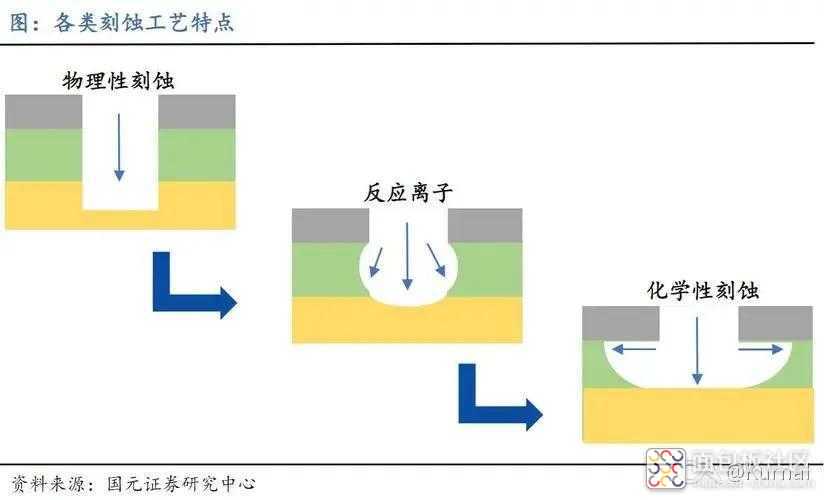
干法可以根据被刻蚀的材料类型来分类,一般分成三种:金属刻蚀、介质刻蚀、和硅刻蚀。介质刻蚀是用于介质材料的刻蚀,如SiO2。硅刻蚀一般用于需要去除硅的场合,如刻蚀多晶硅晶体管栅和硅槽电容。金属刻蚀主要是在金属层上去掉铝合金复合层,制作出互连线
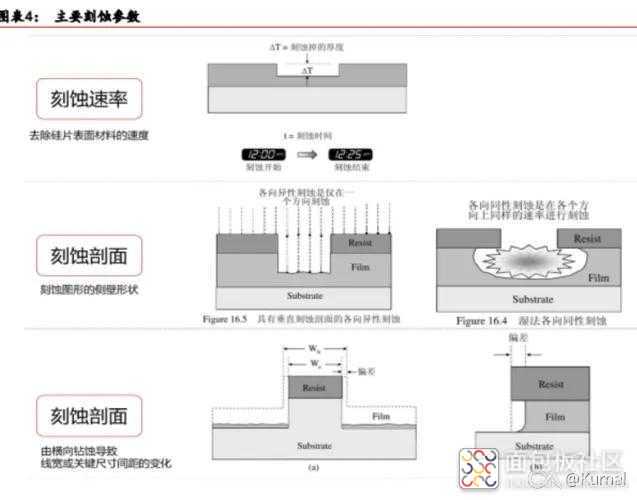
以BEOL的wafer sub为例,一个三层材料的返工工艺流程(例子):第一次等离子体过程用来去除光刻胶,并使SiARC中的Si成分转化成SiO2,使用的反应气体为O2/N2/H2,其中N2/H2为保护气体,用来控制保护速率,然后用稀释的HF清洗晶圆表面,去掉SiO2,第二次等离子体过程用来去除旋涂的碳(SOC或者叫OPL)使用O2/H2N2,最后再用等离子体冲洗。
最后就是离子注入了,原理就是可以看我上一篇图文
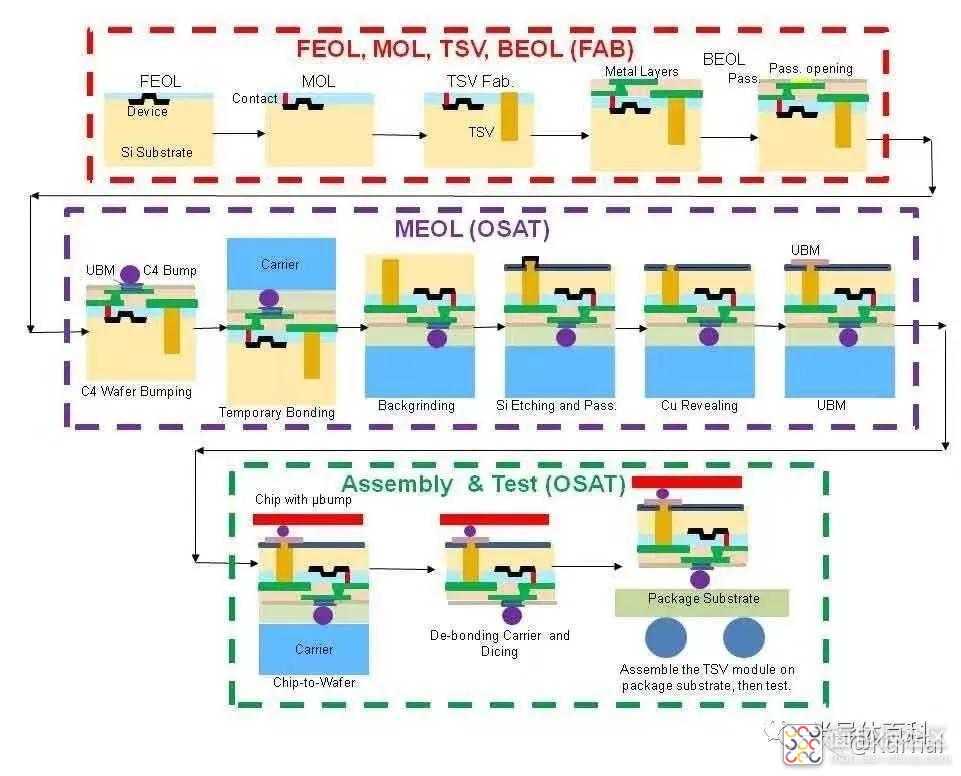
鸽子先
还有封装,可以参考我的上上上个图文,写过了先进封装
最后就是离子注入了,原理就是可以看我上一篇图文(其实真的不想写了,三天每天晚上都写。累死了,下一篇图文除非有兴趣就不写了罢
鸽子先
还有封装,可以参考我的上上上个图文,写过了先进封装。
来源:Kurnal







 /4
/4 

