聚焦离子束(FIB)技术是一种先进的纳米加工和分析工具。其基本原理是在电场和磁场作用下,将离子束聚焦到亚微米甚至纳米量级,通过偏转和加速系统控制离子束扫描运动,实现微纳图形的监测分析和微纳结构的无掩模加工。
聚焦离子束(FIB)技术的发展离不开液态金属离子源的关键突破。20世纪70年代初,来自美国阿贡国家实验室、英国Cluham实验室、美国俄勒冈研究中心等机构的科学家投身于液态金属离子源研发,并将其引入FIB系统。
1978年,美国加州休斯研究所成功搭建全球首台基于Ga+液态金属离子源的FIB加工系统,其离子束斑直径仅100纳米,束流密度达1.5安培/平方厘米,束亮度达3.3×10⁶安培/平方厘米·球面度,标志着FIB技术进入实用化阶段。
80年代和90年代,FIB技术在机理、设备和应用研究等方面取得显著进步,不同功能的商用FIB系统批量面世,广泛应用于研究实验室和半导体集成电路制造厂。如今,FIB技术已成为微电子行业提升材料分析、工艺优化、器件检测及修复精度与效率的关键技术。
FIB系统的核心技术
FIB技术的核心在于利用静电透镜将离子束聚焦至极小尺寸,实现高精度的显微切割。目前,商用FIB系统的离子束源自液态金属离子源。液态金属离子源具有高亮度、高稳定性和易于操作等优点,能够提供高质量的离子束。在FIB系统中,离子源产生的离子束经过加速、聚焦等一系列操作后,被精确地引导至样品表面。当离子束与样品相互作用时,会发生多种物理和化学过程,如离子束轰击样品表面导致的材料去除(刻蚀),或者离子束与样品表面原子相互作用后引发的二次电子发射等。
通过检测这些二次电子信号,可以获得样品表面的微观形貌信息,从而实现对样品的高分辨率成像。此外,FIB技术还可以通过控制离子束的能量、束流密度和作用时间等参数,实现对样品的精确加工和改性。
例如,在微纳加工领域,FIB技术可用于制造纳米尺度的结构和器件;在材料分析方面,FIB技术可用于制备透射电子显微镜(TEM)样品,以便对材料的微观结构进行深入研究。
总之,FIB技术凭借其高精度、多功能的特点,在众多领域展现出了广阔的应用前景。
FIB技术在芯片设计及加工中的应用
1. IC芯片电路修改
在芯片设计与制造过程中,FIB技术发挥着至关重要的作用。通过FIB对芯片电路进行物理修改,芯片设计者能够针对芯片问题区域进行针对性测试,从而更快速、更准确地验证设计方案。当芯片的某些部分出现故障或性能不佳时,FIB可以对这些区域进行隔离或功能修正,帮助工程师迅速定位问题根源。此外,FIB还能在产品量产前提供样片和工程片,加速终端产品的上市时间。
利用FIB修改芯片,可有效减少不成功的设计方案修改次数,缩短研发周期,降低研发成本。例如,在一款复杂芯片的研发过程中,工程师发现其中的一个功能模块存在性能瓶颈。通过FIB技术,他们可以对该模块进行局部修改,改变其电路结构或连接方式,从而优化性能。这种精准的修改方式不仅节省了时间和资源,还提高了芯片设计的成功率。
2.Cross-Section截面分析
FIB技术在芯片截面分析方面的应用同样不可小觑。通过对IC芯片特定位置进行截面断层切割,工程师可以清晰地观察到芯片内部的材料截面结构和材质分布情况,进而对芯片的结构缺陷进行定点分析。
这种截面分析方法为芯片制造过程中的质量控制和故障排查提供了有力支持。例如,在芯片制造过程中,可能会出现晶体管漏电、互连线短路等问题。
通过FIB截面分析,工程师可以直观地观察到这些问题的微观结构特征,从而准确判断问题产生的原因。例如,晶体管漏电可能是由于源极和漏极之间的绝缘层存在缺陷,而互连线短路可能是由于相邻互连线之间的间距过小或绝缘层被击穿。通过对这些问题的深入分析,工程师可以优化芯片制造工艺,提高芯片的可靠性和性能。
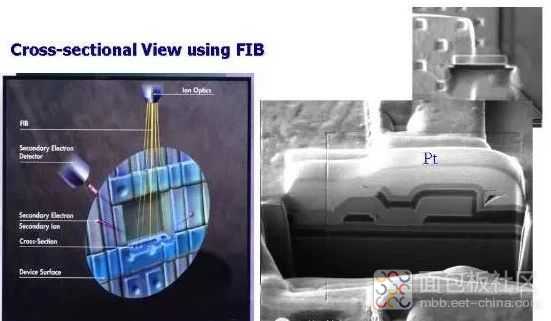
3.Probing Pad
在复杂IC线路中,FIB技术还可以用于在任意位置引出测试点。这些测试点可以与探针台(Probe-station)或电子束(E-beam)直接连接,以便对IC内部信号进行进一步观测和分析。这对于芯片的功能验证和性能测试至关重要。例如,在一款高性能处理器芯片中,其内部电路结构复杂,信号分布密集。
通过FIB技术在关键节点引出测试点,工程师可以实时监测信号的传输情况,检查是否存在信号延迟、干扰等问题。这种精确的信号检测方法有助于提高芯片的性能和稳定性,确保其在各种工作条件下都能正常运行。
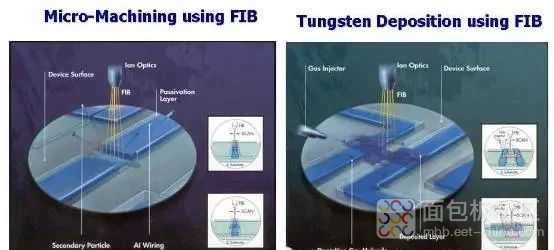
在微纳加工领域的应用
FIB技术在微纳加工和半导体集成电路制造业中具有广泛的应用前景,是当前该领域十分活跃的研究方向之一。它集材料刻蚀、沉积、注入、改性等多种功能于一身,有望成为高真空环境下实现器件制造全过程的主要加工手段。
TEM和STEM薄片试样制备
FIB技术在透射电子显微镜(TEM)和扫描透射电子显微镜(STEM)薄片试样制备方面也发挥着重要作用。
TEM和STEM是研究材料微观结构和性能的重要手段,而高质量的薄片试样是获得准确分析结果的关键。FIB技术可以精确地从样品中切取厚度仅为几十纳米的薄片,满足TEM和STEM的试样要求。
通过FIB制备的薄片试样,研究人员可以清晰地观察到材料的原子级结构,从而深入理解材料的物理和化学性质。例如,在研究新型半导体材料的晶体结构时,通过FIB制备的薄片试样可以帮助研究人员准确地分析晶体的生长方向、缺陷类型等信息,为材料的优化和应用提供理论依据。
其他应用领域的探索与开发
除了上述主要应用,FIB技术还在多个新兴领域展现出巨大的潜力。例如,扫描离子束显微镜(SIM)是一种基于FIB技术的新型显微镜,它利用离子束扫描样品表面,可以获得高分辨率的三维形貌图像。FIB直接注入技术则可用于将特定的离子注入材料内部,实现材料的改性和掺杂。FIB曝光技术,包括扫描曝光和投影曝光,可用于制造纳米尺度的图案和结构。多束技术和全真空联机技术则为FIB技术的进一步发展提供了新的思路和方向。





 /4
/4 

