按照最终外形来看,现在有无数种封装方式,这个实在是太多了,比如QFP,QFN,SOT,DIP,BGA等等,所以我们今天不以这种方式介绍。所以现在按照封装的发展历史来介绍,以封装工艺的方式来分类。
第1代封装方式:wire bond(俗称,打线)
这种封装方式是最早出现的,虽然是第一代技术,但是直到现在也有很多芯片使用这种方式来封装,就是因为技术成熟,成本低。最后封装成的模样就是这样子的。

1,在封装厂拿到wafer之后,先把wafer进行切割,得到一颗一颗的芯片,将那些CP测试(下一次我们再聊测试)通过的芯片单独拿出来。这里要说一个问题,一颗芯片从在没有做任何处理之前,那些引脚是长这个样子的,如下图左下角的方形图案(你先忽略那两个圆形的东西,后面我就知道那两个圆形是怎么来的了),这些引脚也有一个名字,叫做pad。
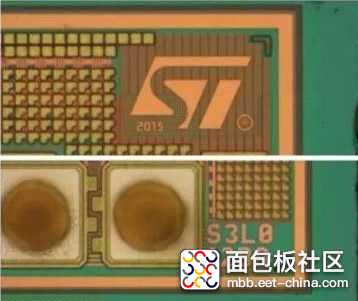
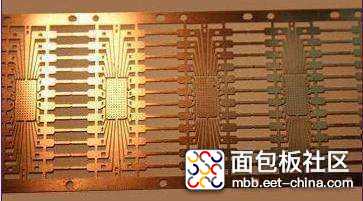

3,打线。用金线(或者是铜线,铝线)将芯片的pad和lead frame连接起来。线的种类会根据芯片的不同制程,或者是根据芯片pad的不同结构来决定使用金线或者是铜线。在打线时,先让金线在低端形成一个金球。




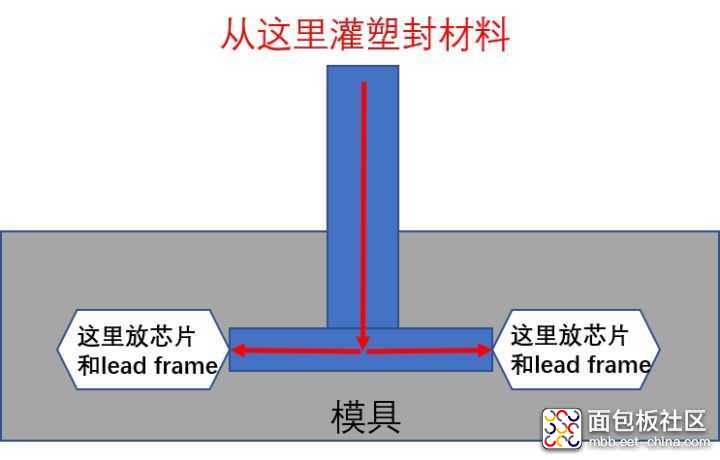
上面这五部就是wire bond封装方式最简单的流程。这一套工艺在现代封装技术中已经很成熟了,成本也低。但是里面的很多细节还是比较关键的。比如这些制程里面对温度的控制,特别是图7中,金线的弧度,高度以及拉力,金球的大小等等。这些参数直接影响芯片的质量,甚至会使芯片无法使用。
第1.5代封装:CSP(Chipe-Size Package)
在上面的wire bond中,有一个很大的问题,就是最终出来的芯片比实际的芯片要大很多,因为lead frame和芯片之间是有距离的。为了解决这个问题,人们发明了CSP封装技术。它的思想很简单,就是去掉lead frame,用一块基板代替。

所以最终出现的芯片是这样的。当然下面的芯片有可能不是用这种方式封装,但是最终的样子是一样的。

第2代封装:flip chip(倒装封装)
在聊完上面两种方式之后。我们会发现一个问题,不能批量化操作,也就是必须在晶圆切割成每个芯片之后才能封装,成本太高。为了解决这个问题,发明了flip chip这种方式。
只所以叫做倒装,是因为在前面的封装方式中,芯片是正面朝上放到基板上面的。而flip chip是正面朝下放置。

要想长金球,首先要做的就是重新布局芯片pad的的位置,利用和芯片制造中相同的后段技术(不懂得可以查看前面的文章这可能最简单的半导体工艺流程(一文看懂芯片制作流程)),将边缘部位的pad,安排到芯片中央来。这句话就是bump的核心目的。
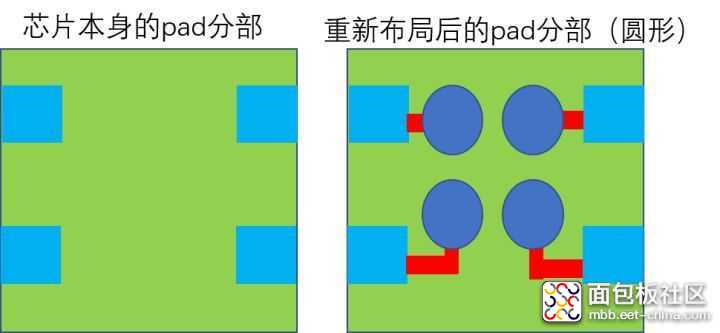
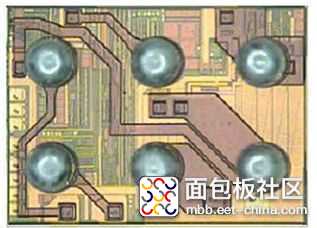
到这里之后,后面一步就是bump,也就是长金球(锡球)。长金球的过程就不再多说了,和芯片制造工艺中的曝光,刻蚀差不多。最终形成的是这个样子。
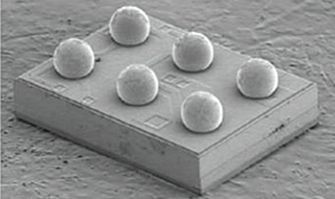
测试完成之后再切割,把好的芯片拿出来。最后倒扣到基板上面。就这样,外部电压通过焊接点以及bump产生的球与芯片交流。
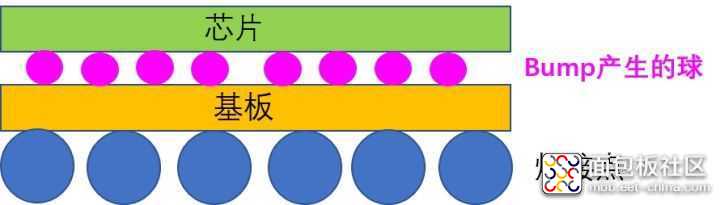
在这一套流程中,bump的过程是最为关键的,包括球的大小,导电性等等。
第3代封装技术:InFO,HBM,CoWos
通过上面两代封装技术的发展,芯片封装技术已经可以满足大部分的需求了,但市场往往是解决一个需求之后,又会产生最新的需求。通过flip chip技术,我们解决了芯片封装的大小问题。但是这种技术随着pin角增多也会出现很多麻烦,主要有下面两个方面。
1,因为芯片在尽量缩小,pin角在增多,芯片的面积已经不能装下这么多焊接点了。因为flip chip的封装方式是将所有的pin脚都集中在一颗芯片的下方,所以我们把这种方式另外取一个名字,叫做FanIn方式的封装,又叫扇入型封装方式。如下图

2,高性能芯片需要多个芯片集成封装。现在高性能的芯片对于时序(Timing)的要求特别高,所以两颗芯片不能相距太远,这样的话会更利于两颗芯片进行信息交流,提高数据处理速度,降低发热。
在这两个需求下,产生了InFO(integrated Fan-out)的封装方式。我们先看Fan-Out是什么意思。上面我们了解了FanIn,那fanout就是刚好反过来。它是把引脚的焊接点引到芯片的外部,如下图。这样的话,即使芯片的pin角增多,也不会带来上面的困扰。

我自己画了一个图来向大家稍微介绍一下吧。


很多人会问,这种封装方式不是面积增加了吗,毕竟占用了芯片以外的地方。其实从得到的好处来说,还是值的的。况且,InFo的封装面积可能比各个分别封装的面积总和要少。
现在这种封装技术只是使用在高端芯片中,比如苹果的A12等,普通芯片是享受不了这种待遇的,因为真的很贵。台积电封装业务的很大一部分盈利都是靠InFO来的。
还有一种封装方式是叫CoWos(Chip-on-Wafer-on-Substrate),是一种将芯片和硅片(基底)集成在一起的封装方式。这种封装方式只有台积电能做,而且是高度商业机密,技术不外露,所以我也知之甚少,在这里就不和大家介绍了。如果以后我了解到,再和大家更新。
当然第三代封装技术还有AMD推出的HBM技术,美光的HMC技术,其实都是大同小异。这里也不做介绍了。
来源:公众号“半导体产业园”







 /4
/4 

